半導體集成電路的發展及封裝工藝面臨的挑戰
5 焊線工藝中焊線區金屬層與ILD層的剝離
本文引用地址:http://www.104case.com/article/84972.htm由于低k材料質地相對較軟,在焊線過程中,由焊線機對焊線墊(Bonding Pad)施加的壓力和超聲波能量會使焊線墊及其下方金屬/ILD層產生杯狀變形(Cupping Deformation)(圖5),這種杯狀變形減弱了超聲波能量到焊線區的有效傳輸,從而阻止了金鋁兩種原子的相互擴散,導致斷焊(Non Stick),或弱焊(Weak Bond)。當有意識地增大超聲波能量來彌補因杯狀變形造成的超聲波能量損失時,又會因為ILD層與金屬層較弱的粘接力及低k 材料的脆性而產生焊線區下方金屬層與ILD層的剝離[8]。

初始的低k芯片的焊線評估顯示,低k芯片對焊線程序參數(焊線能量- Bonding Power,焊線力- Bondinge)十分敏感,較小的焊線參數設置會導致斷焊或弱焊,而較大的焊線參數設置又會容易產生金屬-ILD層的剝離(圖6)。而焊線區尺寸(BPO- Bond Pad Opening)及焊線區間距(BPP Bond Pad Pitch)的不斷縮小使得焊線工藝窗口變得更窄。對于 65nm技術的芯片設計,其焊線區寬度只有40um,使得低k焊線墊的結構及焊線墊下方的低k材料對焊線質量和可靠性的影響更加顯著。這些問題要求對低k 材料的焊線工藝進行進一步的開發和優化,以提高其可制造性和可靠性[9-11]。

圖6焊線過程中的NonStick和金屬層與ILD層的剝離
6 封裝工藝對低k產品可靠性的影響
實驗與數據證明,金鋁焊線界面的完整性(Integrity)在長時間的溫度應力作用下會逐漸下降,直至電性開路[10]。這種失效主要是由于金-鋁間化合物(IMC Intermetallic Compound)隨時間歷程其化和物相態逐漸發生改變,最終形成Kirkendall 空洞并出現IMC分層而造成的。在研究中發現,金屬間化合物的這種失效模式與其初始的焊線狀況有很大聯系,比如不連續的T0 IMC(如圖7所示)。初始焊線狀況包括焊線墊及其下方的材料和結構,焊線墊表面的清潔狀況,使用的焊線材料及工具以及焊線參數等.而當低k銅工藝技術與細間距焊線(Fine Pitch Wire Bonding)相結合時,金鋁金屬間化合物對封裝的可靠性的影響就更大了。對細間距焊線而言,變形后的焊球尺寸不能很大,因而形成的IMC的面積也受到了制約。在如此小面積的焊線區中,由于厚的氧化鋁薄膜或前道工序在焊線區表面遺留的化學污染都會造成焊線區域的局部非潤濕(Non Wetting),又因為超聲波能量受低k材料影響而不能有效傳輸,所有這一切都會阻礙金鋁金屬間化合物的充分形成。一個觀察到的現象是低k材料芯片的金屬間化合物占變形金球面積的比例要小于非低k材料焊線形成的金屬間化合物(圖8)。這也就意味著低k材料的焊線具有更 多的初始空洞/非潤濕區域。當焊線區內含有針測的印跡(Probe Mark)時,這種現象就更加明顯。在隨后的可靠性測試中,含有空洞的表面提供了一個供金屬間化合物擴散的途徑,結果是空洞尺寸沿空洞界面不斷增大,最終會導致金屬間化合物的分層(圖9),電路不再導通,電性失效。
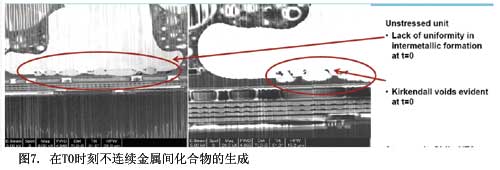
圖7在T0時刻不連續金屬間化合物的生成
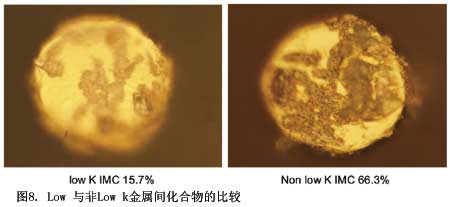
圖8Low與非Lowk金屬間化合物的比較

圖9經過504小時高溫存儲測試后金屬間化合物的分層
總結
半導體芯片結構尺寸的縮小使得RC延遲成為制約集成電路性能進一步提高的關鍵性因素。轉向低k銅工藝技術是業界給出的解決方案。雙大馬士革工藝取代了傳統的鋁“減”工藝,成為低k銅互連材料的標準制造工藝。
為了能與芯片制造工藝完美結合,不產生可靠性問題,低k絕緣材料必須具備一系列期望的材料特性,對低k材料研發本身的挑戰在于:在獲得所需要的低介電常數的同時,低k材料還必須滿足良好的熱和機械特性。但目前并沒有完全符合這些期望特性的低k材料被制造出來,因而給半導體制造工藝帶來了挑戰。
由于低k材料本身的材料特性(與金屬層較弱的粘結力,較弱的機械強度),晶片切割時在芯片的邊緣會出現嚴重的金屬層與ILD層的分層或剝離;在焊線過程中會出現斷焊,弱焊或金屬層與ILD層的剝離。金鋁兩種材料的焊接在可靠性測試中出現比非低k材料焊線嚴重的金屬間化合物的分層,導致集成電路電性失效。上述這些可制造性及可靠性的問題構成了對半導體封裝工藝的挑戰。
萬能遙控器相關文章:萬能遙控器代碼
電路相關文章:電路分析基礎
pic相關文章:pic是什么
















評論