3D封裝TSV技術仍面臨三個難題
—— TSV的發展道路或將更加漫長
Nowak還引用了一些背面晶圓加工、薄化晶圓的臨時托盤開發情況,并展示了有時用于取代過孔的連接微凸塊。EDA供應商也在架構工具和2D建構工具方面取得了進展。
本文引用地址:http://www.104case.com/article/124296.htm“你可以設計一個設備來使用這些工具,”他說。
然而,目前這些工具仍然缺乏有關機械應力、封裝和芯片水準的交換數據標準。業界仍需為在TSV應用中“大幅減少”的靜電放電水平容差定義標準,他說。
另外,業界也正在開發測試程序。“目前仍不清楚在量產時是否會使用到微探針(micro-probing)”他指出,重點是要削減成本,但“我們仍在增加測試步驟。”




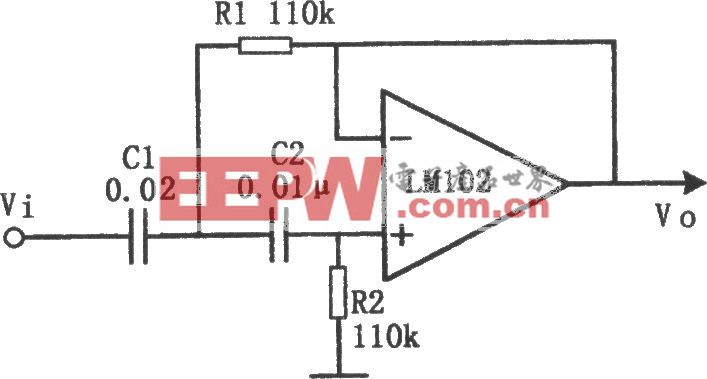
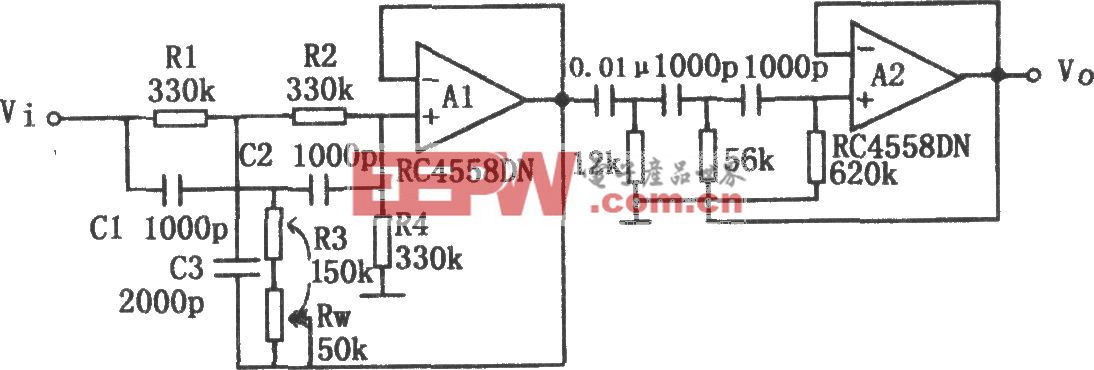



評論