國奧電機(jī):從容應(yīng)對倒裝芯片貼片,幫助提升設(shè)備精度及穩(wěn)定性
隨著集成電路封裝密度提高,芯片上的引腳由四周分布變?yōu)槿酒砻娣植迹鴮?yīng)基板上的引腳也由四周分布變?yōu)槿宸植肌?/p>
傳統(tǒng)的Die bonder和Wire Bonder設(shè)備已經(jīng)無法滿足這種新型引腳分布的封裝要求,因此倒裝芯片封裝技術(shù)應(yīng)運(yùn)而生。

倒裝芯片并不是一種特定的封裝形式(如SOIC),也不是一種封裝類型(如BGA) 。倒裝芯片是一種無引腳結(jié)構(gòu),“倒裝”指的是將晶片貼裝到封裝載體上的一種電氣連接方式。
倒裝芯片封裝流程大致為:先在I/O pad上沉積錫鉛球,然后將芯片翻轉(zhuǎn)加熱,利用熔融的錫鉛球?qū)⒃c陶瓷基板貼合。

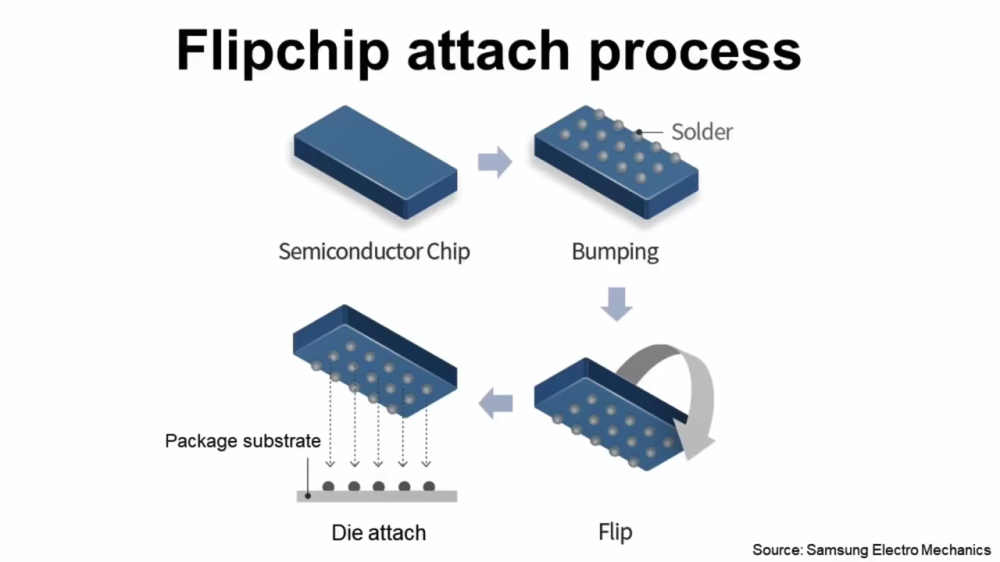
相比傳統(tǒng)打線封裝,倒裝芯片具有絕對優(yōu)勢。
1.更多的IO接口數(shù)量
2.更好的電氣性能和散熱性能
3.更小的封裝尺寸和更穩(wěn)定的結(jié)構(gòu)特性
4.不受焊盤尺寸的限制,便于批量生產(chǎn)
由于I/O引出端分布于整個(gè)芯片表面,倒裝芯片在封裝密度和處理速度上可以說已達(dá)到技術(shù)頂峰,目前已全面導(dǎo)入計(jì)算機(jī)、無線通信、電信/數(shù)據(jù)、硬盤磁頭、智能傳感器、汽車電子、消費(fèi)電子和一些醫(yī)用高精密設(shè)備等領(lǐng)域中。

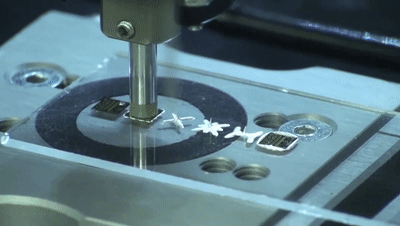
更高的封裝難度,更大的行業(yè)機(jī)遇。
由于倒裝芯片比BGA或CSP具有更小的外形尺寸、更小的球徑和球間距,這就要求組裝設(shè)備具有更高的精度。
同時(shí),由于倒裝芯片的基材是比較脆的硅,若取料過程中Flip Arm和Bond Arm交接芯片無緩沖力控,就容易發(fā)生基材壓裂的情況;另外,如果助焊劑浸蘸時(shí)使用的壓力過大,則容易造成焊凸變形等情況。


因此,如何在高速貼片的同時(shí)保證精密貼合、精準(zhǔn)力控和高穩(wěn)定性,一直是封裝企業(yè)所關(guān)注的重點(diǎn)。
國奧直線旋轉(zhuǎn)電機(jī),提升設(shè)備精度及穩(wěn)定性


高速度,提升貼片效率
一體化高度集成設(shè)計(jì),尺寸僅85mm*130mm*20mm,大大降低機(jī)身體積及重量,解決Z軸自重負(fù)載問題, 運(yùn)動(dòng)速度大幅提升,同時(shí)節(jié)省設(shè)備內(nèi)部空間,輕松實(shí)現(xiàn)矩陣排列;推力曲線平滑、穩(wěn)定、無毛刺,可在高速運(yùn)行狀態(tài)下仍保證穩(wěn)定輸出,大幅提升生產(chǎn)效率。
高精度,提升貼合良率
國奧直線旋轉(zhuǎn)電機(jī)力控精度可達(dá)±0.01N,直線重復(fù)定位精度達(dá)±2μm,旋轉(zhuǎn)重復(fù)定位精度達(dá)±0.01°,徑向偏擺小于10μm,編碼器分辨率標(biāo)準(zhǔn)1μm,精度及穩(wěn)定性優(yōu)于市面上絕大多數(shù)品牌產(chǎn)品,處于全球領(lǐng)先水平。
軟著陸,保護(hù)精密元件
對于0.3mm左右的超薄芯片,有時(shí)甚至要求設(shè)備的貼裝壓力控制在35g左右。國奧直線旋轉(zhuǎn)電機(jī)帶有軟著陸功能,可實(shí)現(xiàn)±1.5g以內(nèi)的穩(wěn)定力度控制,使輸出頭以非常輕的壓力觸碰元件,降低損耗。
隨著小型化高密度封裝的出現(xiàn),行業(yè)對高速高精度裝配的要求變得更加迫切,相關(guān)的設(shè)備和工藝只有進(jìn)一步升級才能滿足市場需求,國奧電機(jī)助力企業(yè)在新的行業(yè)趨勢下破局增效,為您的設(shè)備升級助力。
部分圖片來自網(wǎng)絡(luò),侵刪。
*博客內(nèi)容為網(wǎng)友個(gè)人發(fā)布,僅代表博主個(gè)人觀點(diǎn),如有侵權(quán)請聯(lián)系工作人員刪除。












