半導體C-V測量基礎
—— C-V測量為人們提供了有關器件和材料特征的大量信息
通用測試
本文引用地址:http://www.104case.com/article/96649.htm電容-電壓(C-V)測試廣泛用于測量半導體參數,尤其是MOSCAP和MOSFET結構。此外,利用C-V測量還可以對其他類型的半導體器件和工藝進行特征分析,包括雙極結型晶體管(BJT)、JFET、III-V族化合物器件、光伏電池、MEMS器件、有機TFT顯示器、光電二極管、碳納米管(CNT)和多種其他半導體器件。
這類測量的基本特征非常適用于各種應用和培訓。大學的研究實驗室和半導體廠商利用這類測量評測新材料、新工藝、新器件和新電路。C-V測量對于產品和良率增強工程師也是極其重要的,他們負責提高工藝和器件的性能。可靠性工程師利用這類測量評估材料供貨,監測工藝參數,分析失效機制。
采用一定的方法、儀器和軟件,可以得到多種半導體器件和材料的參數。從評測外延生長的多晶開始,這些信息在整個生產鏈中都會用到,包括諸如平均摻雜濃度、摻雜分布和載流子壽命等參數。在圓片工藝中,C-V測量可用于分析柵氧厚度、柵氧電荷、游離子(雜質)和界面阱密度。在后續的工藝步驟中也會用到這類測量,例如光刻、刻蝕、清洗、電介質和多晶硅沉積、金屬化等。當在圓片上完全制造出器件之后,在可靠性和基本器件測試過程中可以利用C-V測量對閾值電壓和其他一些參數進行特征分析,對器件性能進行建模。
半導體電容的物理特性
MOSCAP結構是在半導體制造過程中形成的一種基本器件結構(如圖1所示)。盡管這類器件可以用于真實電路中,但是人們通常將其作為一種測試結構集成在制造工藝中。由于這種結構比較簡單而且制造過程容易控制,因此它們是評測底層工藝的一種方便的方法。
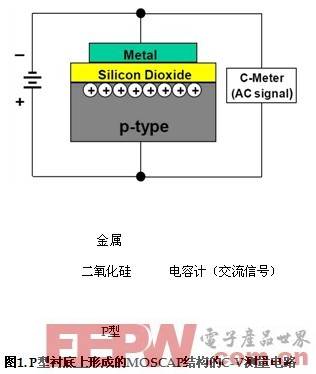

















評論