混合集成電路步入SOP階段 我國(guó)應(yīng)加快研發(fā)
現(xiàn)在,國(guó)際上混合集成電路正在步入將系統(tǒng)級(jí)芯片、微傳感器、微執(zhí)行器和外圍薄膜無(wú)源元件集成在一起,集微電子技術(shù)、光電子技術(shù)、MEMS(微電機(jī)系統(tǒng))技術(shù)和納米技術(shù)于一體的系統(tǒng)封裝(SoP)階段。
本文引用地址:http://www.104case.com/article/95586.htm電子產(chǎn)品的發(fā)展大趨勢(shì)是高集成、高性能和高可靠性,而隨著技術(shù)的提高將產(chǎn)品的“輕、薄、短,小”不斷推向新的水平。有源器件經(jīng)歷了由電子管、晶體管、小規(guī)模集成電路、中規(guī)模集成電路、大規(guī)模集成電路和超大規(guī)模集成電路階段,現(xiàn)在實(shí)現(xiàn)了系統(tǒng)級(jí)芯片(SoC),驗(yàn)證了摩爾定律“每18個(gè)月集成電路芯片上的晶體管數(shù)目增加1倍”的預(yù)言。無(wú)源元件也正在實(shí)現(xiàn)從有引線插裝元件的形式向無(wú)引線表面貼裝的小型化形式發(fā)展。
系統(tǒng)封裝實(shí)現(xiàn)真正小型化
混合集成電路是一種小型化、高性能和高可靠的互連封裝手段。我們國(guó)內(nèi)將其稱為二次集成,意指在半導(dǎo)體單片集成電路的基礎(chǔ)上,實(shí)現(xiàn)包括外圍無(wú)源元件在內(nèi)的混合集成。混合集成電路是隨著半導(dǎo)體和集成電路的發(fā)展而發(fā)展起來(lái)的。它經(jīng)歷了和半導(dǎo)體類似的發(fā)展歷程。隨著半導(dǎo)體集成電路規(guī)模的擴(kuò)大,混合集成電路經(jīng)歷集成了中小規(guī)模IC(集成電路)的混合電路、集成了大規(guī)模和超大規(guī)模集成電路的多芯片組件(MCM)、集成了系統(tǒng)級(jí)芯片實(shí)現(xiàn)3D堆疊組裝的封裝內(nèi)系統(tǒng)(SIP)等階段。現(xiàn)在,國(guó)際上混合集成電路正在步入將系統(tǒng)級(jí)芯片、微傳感器、微執(zhí)行器和外圍薄膜無(wú)源元件集成在一起,集微電子技術(shù)、光電子技術(shù)、MEMS(微機(jī)電系統(tǒng))技術(shù)和納米技術(shù)于一體的系統(tǒng)封裝(SoP)階段。
在許多情況下,遵循摩爾定律發(fā)展的IC僅占一個(gè)系統(tǒng)的10%,其余90%是組裝在一兩個(gè)印制電路板上的諸如電阻、電容、電感、天線、濾波器和開(kāi)關(guān)這類分立無(wú)源元件,它們?nèi)耘f留在那里。要實(shí)現(xiàn)真正的小型化需要再前進(jìn)一步,即用系統(tǒng)封裝(SoP)來(lái)實(shí)現(xiàn)真正意義上的小型化。SoP超越了摩爾定律,它將IC與微米量級(jí)的薄膜型分立元件結(jié)合,將各種元器件內(nèi)埋在一種非常小的新型封裝里,以至于使手持系統(tǒng)成為具有從多功能到兆功能的設(shè)備。SoP不僅被開(kāi)發(fā)用于無(wú)線通信、計(jì)算和娛樂(lè)裝置,配上傳感器,它還可以用來(lái)檢測(cè)各種物質(zhì)(有毒的和無(wú)毒的),包括周圍環(huán)境中、食物里以及人體內(nèi)的化學(xué)物質(zhì)。該技術(shù)解決了系統(tǒng)中90%沒(méi)有被集成化部分的體積問(wèn)題(即所謂的90%問(wèn)題)。
SoP技術(shù)代表了一種截然不同的系統(tǒng)構(gòu)建方法。它縮小了笨拙的印制電路板體積并節(jié)省了許多元件,使它們幾乎消失。實(shí)際上,SoP建立了系統(tǒng)集成的新定律。有人將其稱為電子學(xué)第二定律。這個(gè)新定律是:隨著元件尺寸縮小和印制電路板的消失,在一個(gè)SoP里元件密度每年大約增加1倍,而封裝內(nèi)系統(tǒng)功能的數(shù)量將以同樣的比例增加。這樣,SoP技術(shù)在系統(tǒng)小型化方面將比僅僅處理IC芯片上晶體管數(shù)目的摩爾定律產(chǎn)生更大的作用和影響。
自從1993年美國(guó)佐治亞理工學(xué)院提出SoP的概念后,他們與美國(guó)、日本、韓國(guó)和歐洲的100多家電子公司在這方面開(kāi)展合作,包括AMD、Asahi、愛(ài)立信、Ford、日立、IBM,英特爾、Matsushita、摩托羅拉、NEC、諾基亞、三星、索尼和TI等公司。此外,70多位研究人員作為訪問(wèn)工程師來(lái)到他們的封裝研究中心研究SoP及其應(yīng)用。
迄今為止,至少有50家公司參與了SoP技術(shù)研究,將其應(yīng)用到汽車、計(jì)算機(jī)、消費(fèi)電子、軍事電子和無(wú)線通信領(lǐng)域。該研究中心還為許多公司建造許多試驗(yàn)樣機(jī),將模擬、數(shù)字、射頻、光學(xué)和傳感元件做進(jìn)單一封裝,形成不同的組合。







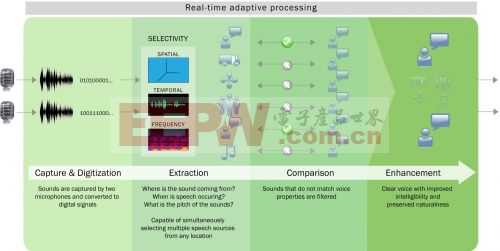


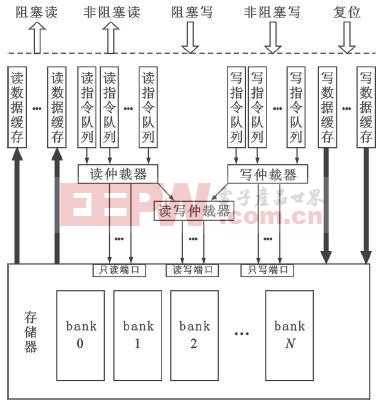



評(píng)論