熱設計連載(1)散熱處理直逼電子產品要害!
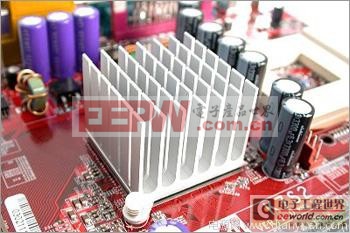
假設你是電子產品設計開發組的一員。為了在與對手的競爭中勝出,決定通過提高產品性能來取勝。雖說原則上是根據原產品進行設計,但需要采用新功能,并要實現行業最小、最輕。其中,產品的小型化需要縮小底板的面積。通過采用不斷微細化的LSI(大規模集成電路)以及集成分立器件,一般都能實現一些產品的小型化。但是,至此會有一個意外的發現。盡管隨著主要LSI的不斷微細化,性能能夠提高,但最大耗電量卻與原產品幾乎沒有變化,發熱量也與原產品基本相同。而且隨著底板面積的縮小,發熱密度反而比原產品要大。
熱對策和熱設計
對此,該如何進行設計呢?大致有兩條路可走。一是過去慣用的“熱對策”。電子產品設計人員會告訴結構設計人員自己設計的電路會產生多少熱量。結構設計人員根據拿到的設計,同時參考原產品進行包括散熱結構在內的結構設計。然后,通過試制品驗證溫度,必要時,增大散熱面積,提高散熱部件的熱傳導率,改變部件布局,降低部件周圍的溫度等。當然,在通過驗證之前,這樣的作業會反復多遍。另外,隨著設計變更及部件的追加,成本恐怕也會增加。

另一個方法是“熱設計”。主要根據設計數據進行熱流體解析,對設計進行驗證。這種方法為公司所采用的時間還很短。熱設計的散熱處理與熱對策基本相同,不過試制前便修改設計,所以部件布局變動的自由度高,即使更改設計也基本不會發生成本。據熱流體解析組介紹,試制品實測的溫度與模擬計算出的溫度之間的誤差甚至可降至幾攝氏度之內。模擬和確定對策大約需要1周左右的時間,與原來相比時間要短得多。而且容易比較多種設計方案。
筆者還記得以前曾聽說過的一句話:應該使用模擬手段,在設計階段便導入多采用模擬等進行的散熱處理。不過,當時筆者還“不過是理想值…”。這次發現,與當時相比,現在電子產品所處的環境發生了很大變化。首先,開發周期絕對變短了。另外,由于封裝密度提高,有時想設置散熱部件可能都會沒有地方。
那么,應該走哪條路呢?是認為量產前反正會出問題,而采用以往慣用的熱對策方法呢?還是走雖然以前從未用過但優點似乎很多的熱設計之路呢?答案似乎已經很明確了。(未完待續)









評論