創意2納米Tape-out 瞄準兩大CSP
創意(3443)于先進硅智財維持領先,據悉2納米先進制程技術領先業界導入,于去年第三季完成測試芯片Tape-out(設計定案),法人看好將爭取更多CSP(云端服務供應)合作機會。 供應鏈透露,創意投注資源于Meta、微軟之ASIC項目; 而搭配臺積電CoWoS-R封裝,推出3納米互聯IP,于今年首季完成硅驗證。
本文引用地址:http://www.104case.com/article/202506/471719.htm創意今年營收展望預估年增14~16%,晶圓產品(Turnkey)受惠虛擬貨幣客戶需求優于預期,有望挑戰雙位數成長; 在匯率影響部分,收入與支出多以美金為主,公司預估,臺幣每升值1%,僅影響毛利率0.023%,影響非常有限。
創意指出,去年第二季就完成2納米先進制程設計流程開發,并在9月完成測試芯片之Tape-out。 與臺積電緊密配合,創意為客戶提供大規模云端資料中心設計之AI/HPC芯片與2.5D CoWoS封裝技術,陸續進入量產。
HBM IP為創意強項,更通過臺積電N3E/N3P驗證,提供最佳電源和信號完整性; 供應鏈業者透露,創意正積極與HBM大廠合作。
法人分析,創意研發資源多數集中于Meta、Microsoft的合作,兩間公司使用到創意的IP和前段設計可能性大; 其中,原先在明年進入量產的CSP相關案件,有望提前至第四季就開始貢獻營收。
法人進一步透露,創意取得微軟ASIC項目,如Maia 200、Cobolt 100,在Meta則預計會取得第三代MTIA,憑借其在CoWoS及3納米等技術之掌握,未來AI營收貢獻將超過營收比重2成。
創意認為,ASIC效能相對于GPU、FPGA等通用型AI芯片更高,成本優勢隨規模更加凸顯; 過往投資于先進制程與先進封裝之技術陸續斬獲不,近年AI相關NRE(委托設計)項目也逐步轉化為中長期Turnkey成長動能。




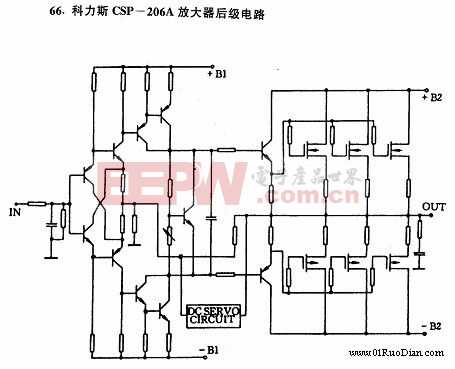
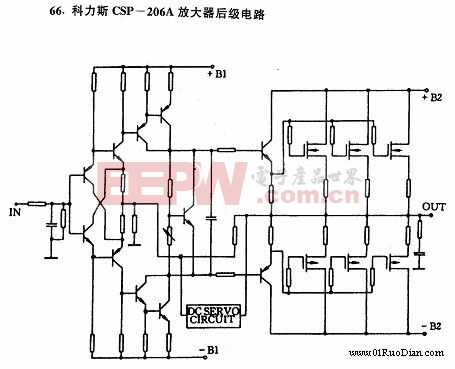

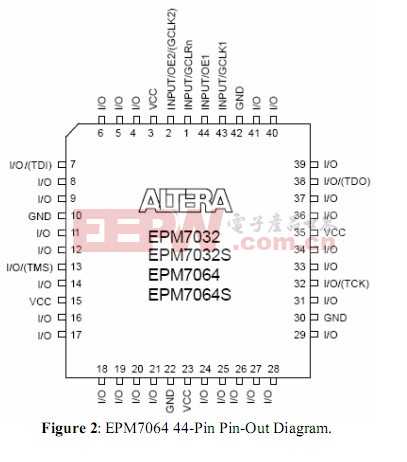
評論