消息稱蘋果繼 AMD 后成為臺積電 SoIC 半導體封裝大客戶
7 月 4 日消息,根據經濟日報報道,在 AMD 之后,蘋果公司在 SoIC 封裝方案上已經擴大和臺積電的合作,預估在2025 年使用該技術。
本文引用地址:http://www.104case.com/article/202407/460642.htm臺積電正在積極提高 CoWoS 封裝產能的同時,也在積極推動下一代 SoIC 封裝方案落地投產。
AMD 是臺積電 SoIC 的首發客戶,旗下的 MI300 加速卡就使用了 SoIC+CoWoS 封裝解決方案,可將不同尺寸、功能、節點的晶粒進行異質整合,目前在位于竹南的第五座封測廠 AP6 生產。
臺積電目前已經整合封裝工藝構建 3D Fabric 系統,其中分為 3 個部分:
· 3D 堆疊技術的 SoIC 系列
· 先進封裝 CoWoS 系列
· InFo 系列
報道稱臺積電的 CoWoS 系列產能吃緊,臺積電目前除了擴充自家工廠產能之外,也積極和其它封測廠合作提高產能。
而臺積電的 SoIC 現階段沒有遇到太大的瓶頸,處于前段封裝,且 2022 年就已經開始小量投產,而且計劃 2026 年產能擴大 20 倍以上。
蘋果對 SoIC 封裝也非常感興趣,將采取 SoIC 搭配 Hybrid molding(熱塑碳纖板復合成型技術),目前正小量試產,預計 2025~2026 年量產,計劃應用在 Mac 上。
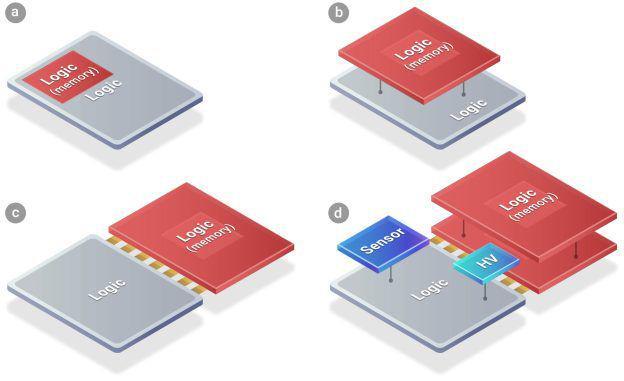
簡要介紹下CoWoS和SoIC的區別如下:
CoWoS
CoWoS(Chip On Wafer On Substrate)是一種 2.5D 的整合生產技術,由 CoW 和 oS 組合而來:先將芯片通過 Chip on Wafer(CoW)的封裝制程連接至硅晶圓,再把 CoW 芯片與基板(Substrate)連接,整合成 CoWoS。
SoIC
SoIC 于 2018 年 4 月公開,是臺積電基于 CoWoS 與多晶圓堆疊 (WoW) 封裝技術,開發的新一代創新封裝技術,這標志著臺積電已具備直接為客戶生產 3D IC 的能力。
















評論