IC封裝供不應求,這四大因素都能要了封測廠的命?
IC需求的意外爆發正在波及半導體封測供應鏈。
本文引用地址:http://www.104case.com/article/201712/373051.htm對芯片需求的不斷上升正在沖擊IC封裝供應鏈,導致某些類型的封裝、制造能力、引線框和一些設備的短缺。
IC封裝供不應求的局面今年早些時候就開始出現了,自那時起,問題愈演愈烈,到了第三季度和第四季度,供求嚴重失衡,現在看來,這種局面將持續到2018年。
出現這種局面有若干原因,最主要原因在于IC需求意外爆發,因此客戶需要更多的IC封裝產能,但是,IC封裝工廠已經滿負荷運轉,無法滿足多種封裝類型的需求。

除了IC封裝之外,電子板塊的其它產品品類也在這次所謂的“繁榮或超級周期”中面臨供應短缺局面。全球最大的半導體封裝與測試(OSAT)巨頭先進半導體工程公司(ASE)首席運營官Tien Wu表示:“這次究竟是一次超級周期,還是我們之前從未見過的內在擴展?在這個超級周期中,供應不足的情況不絕于耳,包括存儲、OLED、被動元件等等。甚至在貼片機等半導體設備方面也存在交付時間拉長的問題。之所以出現這種情形,一方面是由于產能供應有限,另一反面是需求將在很長的一段時間內維持強勁。”
大多數元件出現缺貨的原因顯而易見。比如OLED,蘋果和三星兩家智能手機巨頭幾乎吞噬了OLED屏幕的所有產能。盡管需求不斷上升,DRAM供應商卻一直不愿增加產能,導致DRAM成為今年漲價的急先鋒。NAND產品則是由于供應商生產工藝正從平面型NAND向3D NAND轉型,良率問題導致供應不足。
相比之下,集成電路封裝的問題更為復雜,而且涉及多個產品市場。
集成電路封裝行業的工廠利用率很高,但全球200毫米晶圓bumping制程的產能存在嚴重短缺。在晶圓bumping工藝中,焊球或銅柱在晶圓上形成,在晶粒與基板之間提供電互連。
200mm晶圓bumping產能不足影響了智能手機芯片級封裝(CSP)和射頻前端模塊等產品的供應。
而且,由于其他原因,四扁平無引腳(QFN)封裝和晶圓級封裝需求量大增,導致供應緊張。
對QFN的需求導致引線框(leadframes)的交付時間更長,引線框是用于QFN封裝類型的關鍵組件。而且,封裝設備需求也比預期的要強。
當然,并不是所有封裝類型都供不應求。但是總體來說,整個2017年半導體封測的需求一直很強勁,并且將一直持續到2018年。TechSearch International總裁Jan Vardaman表示:”每家封測工廠都處于滿產狀態,這段時期是封測工廠產能利用率最高的一段時間。”
不消說,供不應求會影響向客戶的交付時間。 “這也會影響那些試圖向市場推出新產品的公司,如果他們的供應受到限制,可能會損害他們的收入,”Vardaman說: “現在最大的問題是,供不應求的局面會持續多久?我想,誰都無法給出正確的答案。”
這些趨勢令客戶擔憂。提供IC封裝和測試服務的封測廠正面臨巨大壓力。這些封測廠多年來資本不足,大多數供應商沒有足夠的資源來滿足苛刻的客戶群的各種需求。
本文主要研究了IC封裝行業面臨的主要短缺問題,如bumping產能、封裝類型、引線框和設備等。
Bumping產能
2017年突然出現的繁榮周期讓整個業界大吃一驚。比如,2016年年末,世界半導體貿易統計組織(WSTS)預測,2017年集成電路行業規模將比2016年溫和增長3%。但是,這一年來,隨著DRAM和3D NAND銷售額的激增,WSTS已經多次上調IC市場銷售的預測。根據最新的預測,該組織預計2017年半導體市場規模將達到4090億美元,同比2016年大幅度增長20.6%,2018年,IC市場將繼續將增長7%。
IC封裝供應鏈的情況反映了芯片行業的需求前景。在這次超級周期中,封測廠們在2017年上半年目睹了傳統的增長模式。
但是到了第三季度和第四季度,若干個板塊的需求開始超預期增長。 STATS ChipPAC公司產品和技術營銷副總裁Vinayak Pandey說:“當然,智能手機的需求一直都在。除了移動設備,汽車和網絡的需求超出了我們的預期。”
需求大增導致封測廠商訂單的激增。目前,封測廠商的工廠利用率平均都在80%以上,當然有很多類型的封測產能正在滿負荷運轉。 “封測廠商正在全負荷運轉,”Pandey說。“如果有任何額外的需求,交貨時間就會越來越長。”
產能的緊張表現在好幾個方面,其中,最大的瓶頸是一種被稱為晶圓bumping的成熟制造工藝,尤其是在200mm晶圓上。目前,Amkor、ASE、STATS ChipPAC等公司都提供晶圓bumping服務。
作為交鑰匙服務的一部分,晶圓bumping直接在200mm或300mm晶圓上進行。bumping本身不是一種封裝類型,它是一種在晶圓上形成微小的焊球或銅柱的制造工藝。
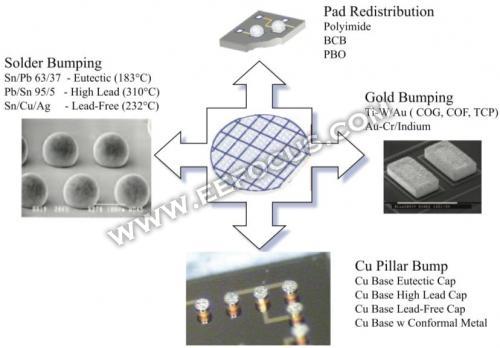
圖1. 通用bumping技術
通過bumping,封測廠商可以開發出各種封裝類型,比如CSP、扇出和Flip-chip BGA。CSP、扇入式和扇出式都屬于晶圓級封裝(WLP)。WLP是當IC還在晶圓上時就對其進行封裝的一種工藝。
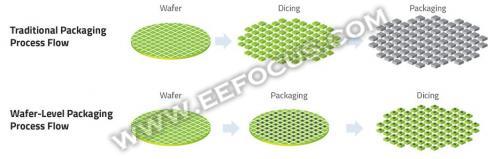
圖2. 傳統封裝與晶圓級封裝的流程對比
Flip-chip是一種互連方案,而不是一種封裝類型。它廣泛應用在應用處理器、圖形芯片和微處理器中。
在Flip-chip中,在硅片上形成微小的凸塊或銅柱。然后,將器件翻轉并安裝在一個單獨的硅片或電路板上。硅片或電路板包括一些銅焊盤。 凸塊或銅柱落在焊盤上,形成電氣連接。
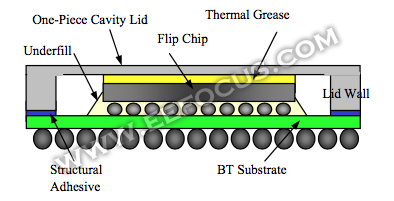
圖3. Flip-Chip BGA封裝
目前,OSAT廠商已經具備了充足的300mm bumping產能,但是令人驚訝的是,市場上200mm bumping的成熟產能嚴重短缺。











評論