什么是 IC 封裝中的倒裝芯片技術?
倒裝芯片技術是一種先進的半導體封裝和組裝方法,涉及將半導體芯片直接安裝到基板或 PCB 上,電路朝下。本常見問題解答將傳達倒裝芯片技術的基本概念以及它與傳統引線鍵合技術的不同之處。
本文引用地址:http://www.104case.com/article/202506/471178.htm倒裝芯片技術的簡單視圖
對倒裝芯片技術的簡單理解如圖 1 所示為四步過程。每個步驟如下:
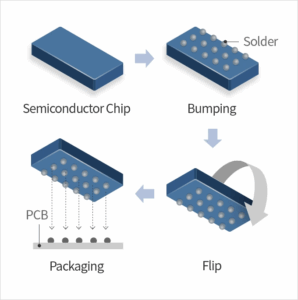
圖 1.IC 封裝中倒裝芯片技術的四步過程。(圖片:Techovedas)
半導體芯片 — 第一步涉及在制造后準備半導體芯片或 IC。
碰撞 — 小焊球(凸塊)沉積在芯片的焊盤上。這些焊料凸塊用作芯片與 PCB 或基板之間的電氣和機械連接點。
Flip — 凸塊芯片倒置(因此稱為“Flip-chip”),使焊料凸塊朝下朝向 PCB。
Packaging — 帶有焊點的倒裝芯片與 PCB 上的相應焊盤對齊。加熱以熔化焊料,在芯片和 PCB 之間形成牢固的電氣和機械連接。
倒裝芯片技術與引線鍵合技術有何不同?
倒裝芯片技術是 IC 封裝中傳統引線鍵合技術的替代方案。圖 2 說明了這兩種封裝技術的不同之處。
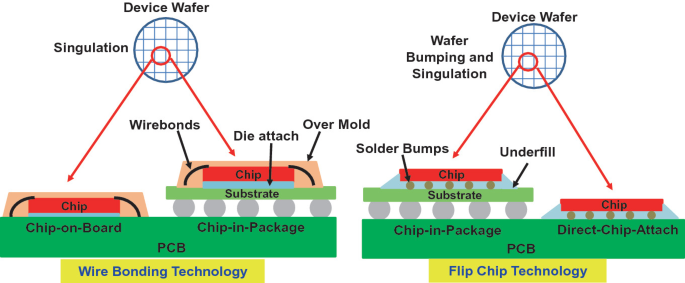
圖 2.引線鍵合和倒裝芯片技術的 IC 封裝工藝。(圖片:SpringerLink)
引線鍵合技術
在引線鍵合中,單個半導體芯片通過稱為分離的過程從晶圓上分離出來(圖 2)。芯片分離后,使用芯片粘接粘合劑將其連接到基板或 PCB 上。芯片和基板或 PCB 之間的電氣連接使用細線(引線鍵合)進行。然后涂覆模塑化合物以保護芯片和電線。圖 2 顯示了兩種引線鍵合配置:
Chip-on-Board (COB):芯片通過引線鍵合直接鍵合到 PCB。
Chip-in-Package (CIP):芯片放置在基板上,進行引線鍵合、封裝,然后安裝在 PCB 上。
倒裝芯片技術
倒裝芯片封裝涉及一種不同的方法,其中器件晶圓在分離之前經歷晶圓凸塊。在芯片表面形成焊料凸點,用作電氣和機械連接點。凸塊后,晶圓被分離成單獨的芯片,然后翻轉并直接安裝到基板或 PCB 上。芯片通過回流焊粘合,形成牢固的電氣和機械連接。在芯片下方引入底部填充材料,以加強連接并確保可靠性。這里顯示了兩種倒裝芯片配置以供說明:
Chip-in-Package (CIP):安裝在基板上的倒裝芯片,然后連接到 PCB。
直接芯片連接 (DCA):倒裝芯片直接連接到 PCB,無需中間基板。
引線鍵合更傳統、更簡單、更便宜,但具有更長的電氣路徑(線環),這會影響高頻性能。倒裝芯片技術更緊湊,可實現高效的散熱。它具有更短的電氣路徑,提供更好的電氣性能,適用于高速和高密度的電子應用,但成本較高。
3D 集成中的倒裝芯片技術
倒裝芯片方法支持 3D 集成,使量子處理器能夠克服平面架構的限制。圖 3 通過顯示標準和倒裝芯片配置來演示這種現象。
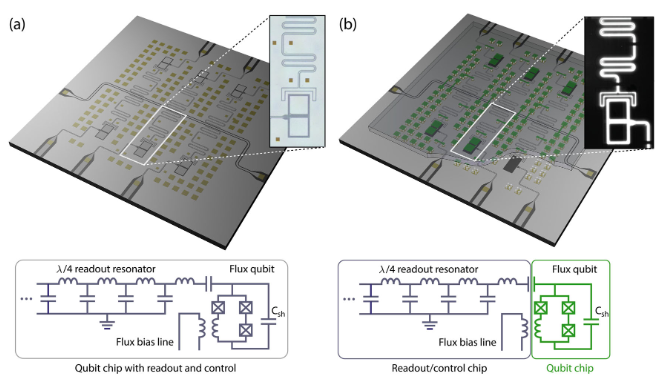
圖 3.標準和倒裝芯片量子比特配置的比較,顯示了 3D 集成架構中量子比特和控制元件的分離。(圖片:施普林格·自然))
圖 3 顯示了倒裝芯片設計如何將量子比特(在頂部芯片上)與控制和讀出元件(在底部芯片上)分開。這種分離具有以下優點,因為它允許:
每個芯片的獨立制造工藝。
優化量子比特芯片,而不會通過復雜的控制電路對其進行損害。
保護敏感量子比特免受可能的退相干源的影響。
圖 3 中的設置證明的最重要的發現之一是,盡管靠近另一個芯片,但仍能保持高量子比特相干時間(T?、T? > 20 μs)。這證明 3D 集成方法不會降低量子比特性能。
一個主要的好處是解決了互連擁擠問題。此外,當擴展到更大的量子比特數組時,從外圍橫向尋址量子比特變得不切實際。倒裝芯片方法通過利用第三維度進行布線控制和讀出線,巧妙地解決了這個問題。
倒裝芯片配置為量子比特電磁場提供了更大的模式體積,減少了可能限制量子比特相干性的表面參與效應。
案例研究 – 三星的 LED 倒裝芯片設計
LED 傳統上包含一個芯片,該芯片在特定電壓下發射單色光。傳統設計將這些芯片安裝在封裝中,通過金線鍵合將它們連接到觸點。然而,這種方法存在明顯的局限性:精致的金線在最小應力下容易斷裂,而封裝反射會降低整體效率。
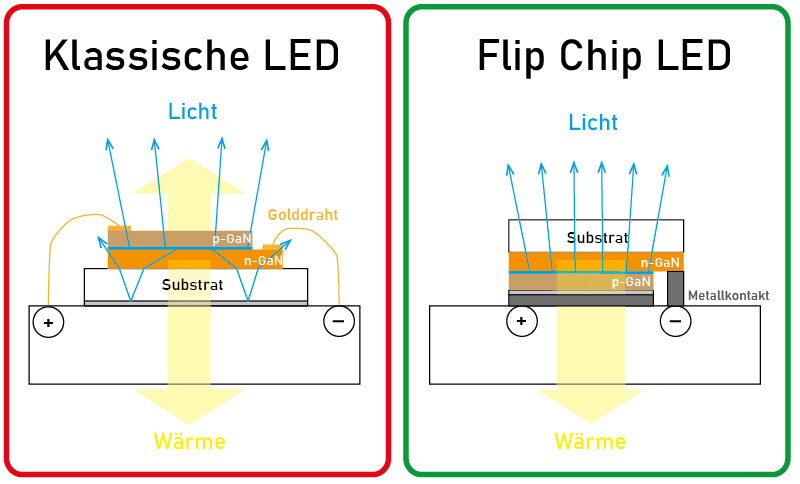
圖 4.經典 LED 與倒裝芯片 LED 展示了后者如何避免任何導線進行粘合。(圖片:Crescience)
Samsung 通過其創新的倒裝芯片 LED 封裝推進了這一概念,如圖 4 所示。他們的方法包括反轉藍色 LED 芯片并將熒光粉膜直接應用于每個單元。與需要熒光粉點膠和塑料成型的傳統封裝不同,三星的技術無需模具即可實現芯片級封裝,從而實現更緊湊的照明燈具設計。
這種實現方式實現了從結點到封裝基體的最短距離,同時消除了引線鍵合要求。這些工程改進可在 25°C 至 85°C 的最佳工作范圍內將每瓦溫度降低約 5%。
總結
倒裝芯片技術通過提供卓越的電氣性能和熱管理,徹底改變了半導體封裝。它的應用跨越多個行業,并且不斷的進步不斷增強其功能。雖然本常見問題解答中只提到了少數應用,但該技術適用于可以替代引線鍵合技術的領域。



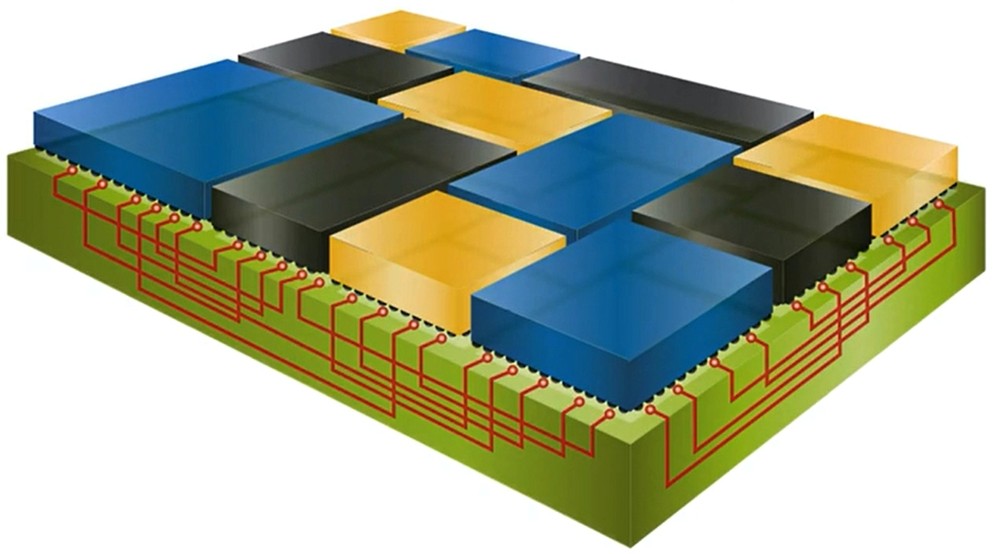


評論