- 倒裝芯片技術是一種先進的半導體封裝和組裝方法,涉及將半導體芯片直接安裝到基板或 PCB 上,電路朝下。本常見問題解答將傳達倒裝芯片技術的基本概念以及它與傳統引線鍵合技術的不同之處。倒裝芯片技術的簡單視圖對倒裝芯片技術的簡單理解如圖 1 所示為四步過程。每個步驟如下:圖 1.IC 封裝中倒裝芯片技術的四步過程。(圖片:Techovedas)半導體芯片 — 第一步涉及在制造后準備半導體芯片或 IC。碰撞 — 小焊球(凸塊)沉積在芯片的焊盤上。這些焊料凸塊用作芯片與 PCB 或基板之間的電氣
- 關鍵字:
IC封裝 倒裝芯片技術
- 目前臺積電先進封裝CoWoS的制程瓶頸在于硅穿孔(TSV)技術,TSV硅穿孔芯片堆棧并非打線接合,而是在各邏輯芯片鉆出小洞,從底部填充入金屬,使其能通過每一層芯片。再以導電材料如銅、多晶硅、鎢等物質填滿,形成連接的功能,最后將晶圓或晶粒薄化加以堆棧、結合(Bonding),作為芯片間傳輸電訊號用之立體堆棧技術。隨著IC設計業者繼續將更多的邏輯、內存和特殊功能芯片整合到先進的2.5D和3D封裝中,每個封裝中的TSV互連導線數量擴展到數千個。為整合更多的互連導線并容納更高的芯片堆棧,需將硅穿孔變得更窄、更高,
- 關鍵字:
異質整合 應用材料 IC封裝 CoWoS
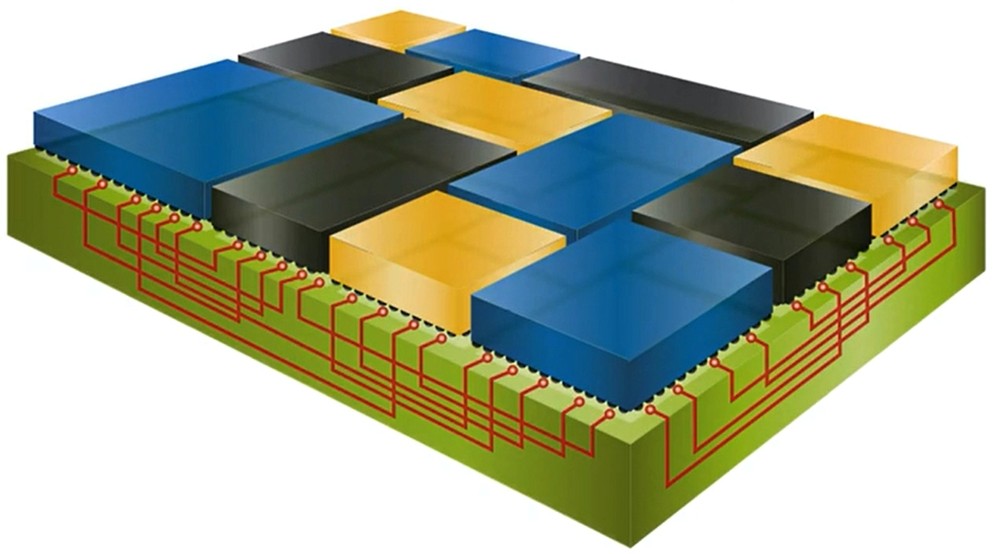
- 西門子數字化工業軟件近日宣布,無晶圓基板初創企業?Chipletz?選擇西門子?EDA 作為電子設計自動化(EDA)戰略合作伙伴,助其開發具有開創性的?Smart Substrate??產品。在對可用解決方案進行綜合技術評估之后,Chipletz?選擇了一系列西門子?EDA?工具,對其?Smart Substrate?技術進行設計和驗證。Smart Substrate?有助于將多個芯片集成在一個封
- 關鍵字:
Chipletz 西門子EDA Smart Substrate IC封裝

- 芯片封裝不僅起到芯片內鍵合點與外部進行電氣連接的作用,也為芯片提供了一個穩定可靠的工作環境,封裝是集成電路產業鏈必不可少的環節。
- 關鍵字:
IC封裝
- 將去耦電容直接放在IC封裝內可以有效控制EMI并提高信號的完整性,本文從IC內部封裝入手,分析EMI的來源、IC封裝在EMI控制中的作用,進而提出11個有效控
- 關鍵字:
PCB IC封裝
- 詳解IC芯片對EMI設計的影響-在考慮EMI控制時,設計工程師及PCB板級設計工程師首先應該考慮IC芯片的選擇。集成電路的某些特征如封裝類型、偏置電壓和芯片的:工藝技術(例如CMoS、ECI)等都對電磁干擾有很大的影響。下面將著重探討IC對EMI控制的影響。
- 關鍵字:
IC芯片 EMI IC封裝 PCB
- 資策會MIC表示,明年包括美光、三星、海力士及臺積電等半導體大廠,持續精進推出3D IC封裝技術。
資策會產業情報研究所(MIC)指出,全球首顆3D IC異質整合晶片HMC(Hybrid Memory Cube),將在明年正式量產,由記憶體大廠美光(Micron)和三星(Samsung)為首的混合記憶體立方聯盟(HMCC)推出。
資策會MIC表示,混合記憶體立方HMC,以3D IC技術堆疊多層動態隨機存取記憶體(DRAM)和一層邏輯晶片,屬于異質整合晶片。
另一方面,資策會MIC指出
- 關鍵字:
臺積電 三星 IC封裝
- 北京半導體器件研究所、北京益泰電子集團有限公司、南韓友石科技有限公司及南韓奧比思有限公司共同成立了一家IC封裝公司,名為北京友泰半導體有限公司。新公司位于北京昌平開發區內。
新公司計劃每月封裝產能達1800萬片,并旨在成為昌平開發區最規模最大的IC封裝公司。
此外,昌平開發區內的多家公司已開始運作,為了發展成為中國北部的IC封裝基地,昌平將會陸續引進約10家IC封裝公司。
- 關鍵字:
半導體 IC封裝

- 追求設計有效性是企業不變的追求,而且產品設計一直會面臨成本與質量的沖突,如何構建一個有效的設計流程,通過控制約束條件以符合設計規范,達到質量要求,是當今設計師不得不面對的挑戰。在近日Mentor Graphics公司在京舉辦的“2014 PCB技術論壇”上,Mentor Graphics(明導)公司系統設計部的業務開發經理David Wiens提出了新的設計方法。
?????? Mentor系統設計部
- 關鍵字:
Mentor Graphics PCB IC封裝
- 臺灣半導體協會(TSIA)委托工研院產經中心(IEK)進行產業調查,去年第4季臺灣整體半導體產業產值達4903億元,較第3季衰退3.4%,較去年同期成長18.1%,去年全年臺灣半導體產業產值達1.88兆元,年增15.6%,今年預估半導體產值可達2.09兆元,突破2兆元關卡,較去年成長11.1%。
IEK統計,去年第4季半導體IC設計產值為1292億元,季增0.1%,IC制造2551億元,季減5.6%,IC封裝為735億元,季減2%,IC測試325億元,季減2.1%。
IEK統計,去(201
- 關鍵字:
半導體 IC封裝
- 2013年第叁季,臺灣IC封測業遭遇到下游客戶提前庫存整理,且第二季成長率達13.4%,基期已墊高,整體IC封測產業僅成長3.4%,產值為1,082億新臺幣。
工研院IEK產業分析師陳玲君指出,電視市場和高階智慧型手機銷售動能較差,但日月光、硅品、精材等廠商營收成長率仍亮眼,主要受惠于打入蘋果iPhone新機封測供應鏈,和中國大陸低價智慧手持裝置出貨持續成長。
2013年第四季整體而言,PC需求疲弱及部分智慧型手機銷售不佳,第四季的半導體市場將出現季節性修正,也使得封測廠瀰漫保守氣氛。整體
- 關鍵字:
IC封裝 智慧手機
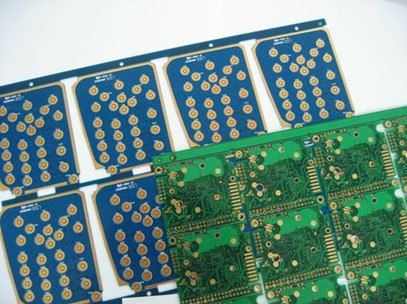
- 傳統的IC封裝是采用導線框架作為IC導通線路與支撐IC的載具,它連接引腳于導線框架的兩旁或四周。隨著IC技術的發展,引腳數量增多、布線密度增大、基板層數增多,傳統封裝形式無法滿足市場需要。近年來以BGA、CSP為代表的新型IC封裝形式興起,隨之也產生了一種半導體芯片封裝的新載體——IC封裝基板。
- 關鍵字:
IC封裝 PCB SiP
- 摘要表面貼裝IC封裝依靠印刷電路板(PCB)來散熱。一般而言,PCB是高功耗半導體器件的主要冷卻方法。一款...
- 關鍵字:
印刷電路板 冷卻技術 IC封裝
- 依工研院產業經濟與資訊服務中心(IEK)統計,今年上半年我國半導體產業海內外生產總值8,908億元,較上年同期增14.3%(第2季增14.5%),其中以積體電路(IC)制造業4,712億元及IC設計業2,228億元為大宗,兩者合占7成8,分別增18.1%及17.0%, IC封裝及測試業亦各增3.5%及3.9%。
另上半年平面顯示器產業海內外生產總值7,490億元,較上年同期增16.4%(第2季增16.0%),其中面板產業4,869億元(占65%)增16.7%,關鍵零組件2,621億元(占35%)
- 關鍵字:
IC封裝 測試
- 晶圓代工龍頭廠臺積電(2330)雖繳出改寫歷史新高的第二季財報數,但董事長張忠謀對下半年營運,卻一改先前樂觀看法而轉趨保守,是否沖擊下游封測廠營運,尤其是封測雙雄日月光(2311)、矽品(2325)業績表現,備受矚目。
以產業相關連性觀察,IC封裝測試業景氣約落后晶圓代工廠3~6個月,換言之,臺積電第三季成長幅度轉緩,第四季可能走滑,并對照臺積電7月合并營收也見到3.6%的月衰退跡象,是否會反映在封測雙雄第四季營運也跟著滑落下來,外界看法略顯分歧。
支撐對封測雙雄下半年營運仍持樂觀看法的是
- 關鍵字:
臺積電 IC封裝
ic封裝介紹
1、BGA(ball grid array)
球形觸點陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式制作出球形凸點用 以 代替引腳,在印刷基板的正面裝配LSI 芯片,然后用模壓樹脂或灌封方法進行密封。也 稱為凸 點陳列載體(PAC)。引腳可超過200,是多引腳LSI 用的一種封裝。 封裝本體也可做得比QFP(四側引腳扁平封裝)小。例如,引腳中心距為1.5mm 的360 引腳 BG [
查看詳細 ]
關于我們 -
廣告服務 -
企業會員服務 -
網站地圖 -
聯系我們 -
征稿 -
友情鏈接 -
手機EEPW
Copyright ?2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《電子產品世界》雜志社 版權所有 北京東曉國際技術信息咨詢有限公司

京ICP備12027778號-2 北京市公安局備案:1101082052 京公網安備11010802012473