芯片中的RDL(重分布層)是什么?
在芯片設計和制造中,RDL(Redistribution Layer,重分布層) 是指通過在芯片上增加金屬布線層來重新分布芯片的信號連接。RDL主要用于將芯片內部的信號引出到所需的位置,以便于后續封裝或連接其他電路。
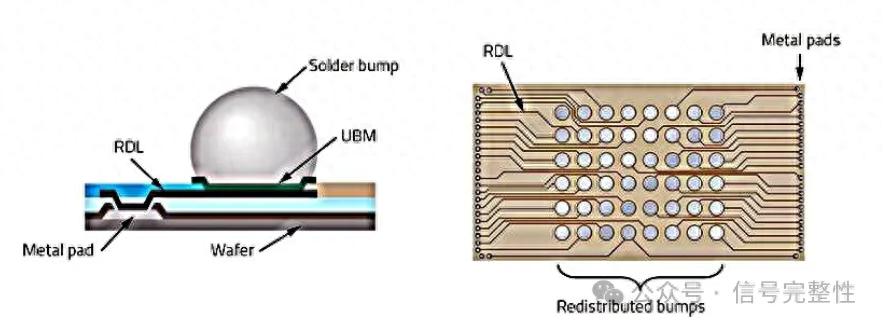
RDL 的作用
信號重分布:
芯片內部的輸入輸出(I/O)通常位于芯片的邊緣,但在某些封裝方式(如BGA或CSP)中,需要將這些信號重新布線到芯片的特定位置,便于外部引腳連接。
實現多點連接:
提供靈活的布線方案,使得信號可以從芯片的任何區域引出到封裝的目標區域。
支持高級封裝技術:
如倒裝芯片(Flip Chip)和晶圓級封裝(WLP),RDL 是實現這些技術的關鍵。
絕緣層:例如聚酰亞胺(Polyimide)或其他介電材料,作為RDL的基礎層,用于隔離下層電路。
金屬布線:常用材料為銅(Cu)或鋁(Al),用于將信號從一個點引導到另一個點。
頂層保護層:用于保護RDL布線,防止環境影響或機械損傷
倒裝芯片封裝(Flip Chip):RDL 將芯片的I/O信號從外圍重分布到中央,以便與封裝基板上的焊球對齊。
晶圓級封裝(WLP):在晶圓級封裝中,RDL用于將芯片的信號重新布線到適合外部連接的位置。
多芯片集成(SiP):在系統級封裝(System-in-Package)中,RDL有助于在多芯片模塊中實現信號互連。
絕緣層沉積:在芯片表面涂覆一層介電材料。
光刻:定義布線的圖形。
金屬沉積:通過電鍍或濺射的方法在絕緣層上沉積金屬材料。
刻蝕:移除多余的金屬,形成布線圖案。
表面處理:為后續焊接做好準備,例如添加焊盤或焊球。
提高芯片的I/O靈活性。
支持小型化和高密度封裝。
降低芯片與封裝基板之間的連接損耗。
工藝復雜度較高,增加了制造成本。
布線密度和可靠性需與先進制程相匹配。
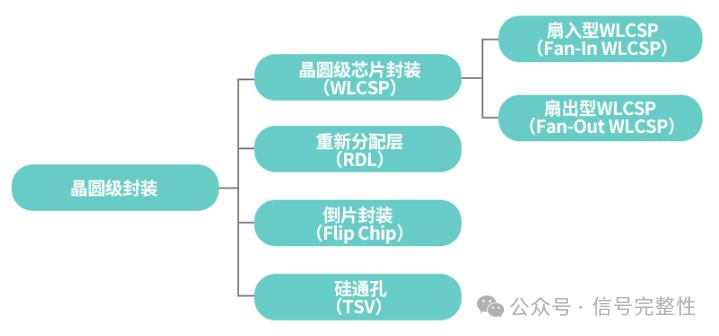
RDL 的結構
RDL 通常由以下部分組成:
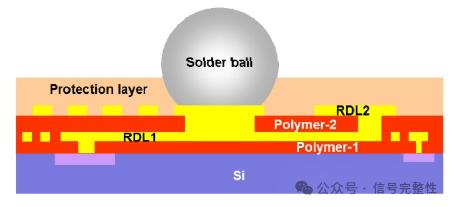
RDL 的應用場景
RDL 的制造工藝
RDL 的制造過程通常包括以下步驟:
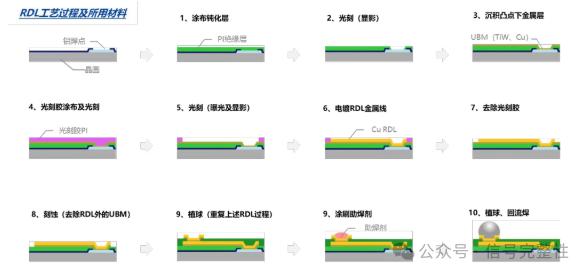
優點與挑戰
優點:
挑戰:
總結
RDL 是現代芯片封裝技術中的關鍵部分,廣泛應用于高性能、緊湊型和多功能芯片封裝中。隨著先進封裝技術的發展(如3D IC和異構集成),RDL的重要性和復雜性也在不斷增加。












評論