3D封裝技術(shù)英特爾有何獨(dú)到之處
立體種植晶體管,對不起,暫時(shí)還不能。3D封裝說得很清楚,就是在空間中而不是平面化封裝多個(gè)芯片。也許你會(huì)說,這有什么新鮮的,芯片堆疊技術(shù)不是老早之前就被廣泛使用了么,無論是DRAM還是NAND,都已廣泛采用堆疊技術(shù),特別是NAND已經(jīng)從128層甚至更多層邁進(jìn)。而智能手機(jī)所使用的SiP芯片,也是將SoC與DRAM堆疊在一起的。
本文引用地址:http://www.104case.com/article/201901/397133.htmDRAM/NAND堆疊相對簡單,由于各層半導(dǎo)體功能特性相同,無論是地址還是數(shù)據(jù),信號可以縱穿功能完全相同的不同樓層,就像是巨大的公寓樓中從底到頂穿梭的電梯。存儲具有Cell級的高度相似性,同時(shí)運(yùn)行頻率相對不高,較常采用這種結(jié)構(gòu)。

SoC和DRAM芯片的堆疊,采用了內(nèi)插器或嵌入式橋接器,芯片不僅功能有別,而且連接速度高,這樣的組合甚至可以完成整個(gè)系統(tǒng)功能,因此叫SiP(System in Package)更準(zhǔn)確。SiP封裝足夠小巧緊湊,但是其中功能模塊十分固定,難以根據(jù)用戶需要自由組合IP模塊,也就是配置彈性偏低。
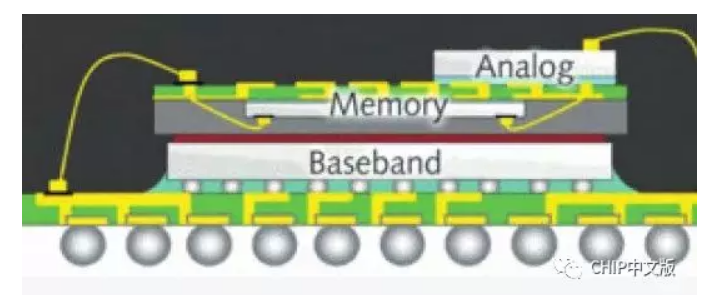
在去年年初,英特爾推出Kaby Lake-G令人眼前一亮,片上集成AMD Vega GPU和HBM2顯存的Kaby Lake-G讓EMIB(嵌入式多芯片互連橋接)封裝技術(shù)進(jìn)入人們眼簾,而該技術(shù)還只是2D封裝,也就是所有芯片在一個(gè)平面上鋪開。
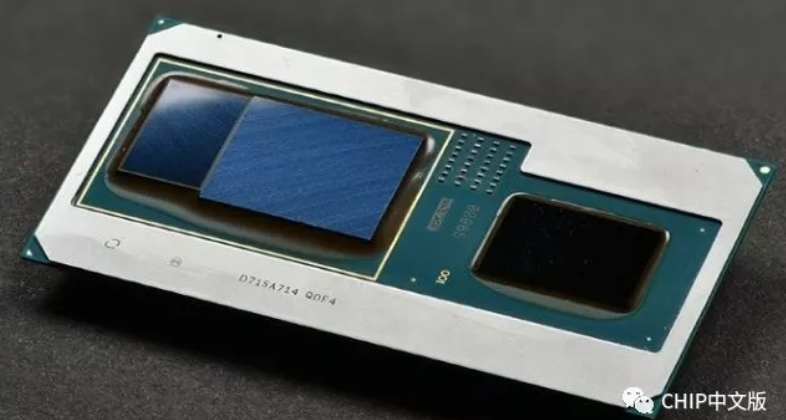
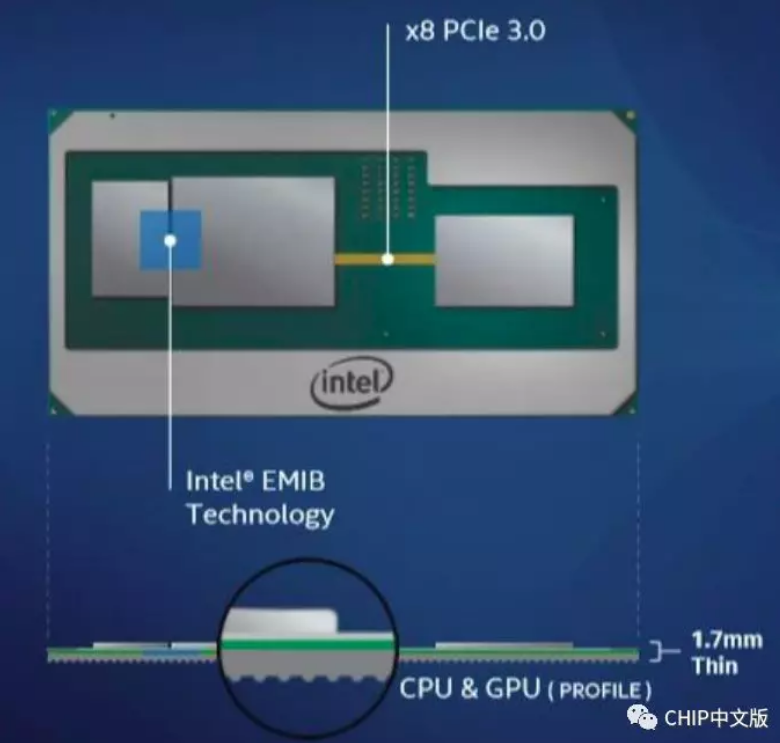
現(xiàn)在,英特爾已準(zhǔn)備好將3D封裝引入主流市場,也就是Foveros。Foveros 3D封裝將多芯片封裝從單獨(dú)一個(gè)平面,變?yōu)榱Ⅲw式組合,從而大大提高集成密度,可以更靈活地組合不同芯片或者功能模塊。







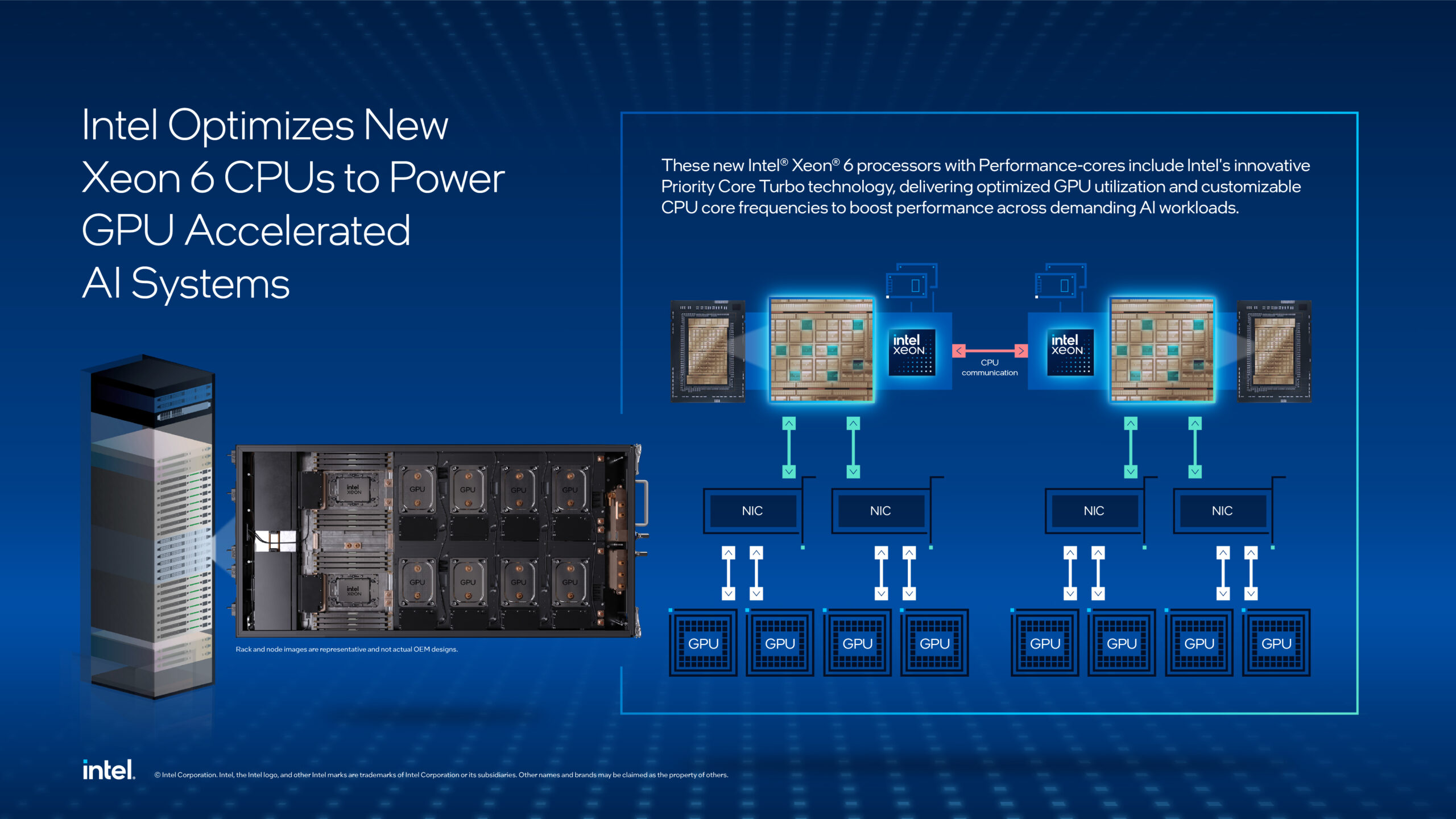






評論