DIP/BGA/SMD等常見芯片封裝類型匯總,你了解幾個?
QFP(方型扁平式)封裝
本文引用地址:http://www.104case.com/article/201811/394764.htm該技術實現的CPU芯片引腳之間距離很小,管腳很細,一般大規模或超大規模集成電路采用這種封裝形式,其引腳數一般都在100以上。

QFP封裝
特點:
1.適用于SMD表面安裝技術在PCB電路板上安裝布線。
2.適合高頻使用。
3.操作方便,可靠性高。
4.芯片面積與封裝面積之間的比值較小。
QFN封裝類型
QFN是一種無引線四方扁平封裝,是具有外設終端墊以及一個用于機械和熱量完整性暴露的芯片墊的無鉛封裝。
該封裝可為正方形或長方形。封裝四側配置有電極觸點,由于無引腳,貼裝占有面積比QFP 小,高度 比QFP 低。

QFN封裝
特點:
1.表面貼裝封裝,無引腳設計。
2.無引腳焊盤設計占有更小的PCB面積。
3.組件非常薄(<1mm),可滿足對空間有嚴格要求的應用。
4.非常低的阻抗、自感,可滿足高速或者微波的應用。
5.具有優異的熱性能,主要是因為底部有大面積散熱焊盤。
6.重量輕,適合便攜式應用。
QFN封裝的小外形特點,可用于筆記本電腦、數碼相機、個人數字助理(PDA)、移動電話和MP3等便攜式消費電子產品。從市場的角度而言,QFN封裝越來越多地受到用戶的關注,考慮到成本、體積各方面的因素,QFN封裝將會是未來幾年的一個增長點,發展前景極為樂觀。
LCC封裝
LCC封裝的形式是為了針對無針腳芯片封裝設計的,這種封裝采用貼片式封裝,它的引腳在芯片邊緣地步向內彎曲,緊貼芯片,減小了安裝體積。但是這種芯片的缺點是使用時調試和焊接都非常麻煩,一般設計時都不直接焊接到印制線路板上,而是使用PGA封裝的結構的引腳轉換座焊接到印制線路板上,再將LCC封裝的芯片安裝到引腳轉換座的LCC結構形式的安裝槽中,這樣的芯片就可隨時拆卸,便于調試。
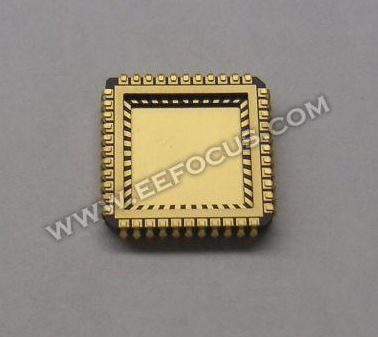
LCC封裝
COB封裝
COB封裝全稱板上芯片封裝,是為了解決LED散熱問題的一種技術。相比直插式和SMT其特點是節約空間、簡化封裝作業,具有高效的熱管理方式。
COB封裝是將裸芯片用導電或非導電膠粘附在互連基板上,然后進行引線鍵合實現其電氣連接。如果裸芯片直接暴露在空氣中,易受污染或人為損壞,影響或破壞芯片功能,于是就用膠把芯片和鍵合引線包封起來。
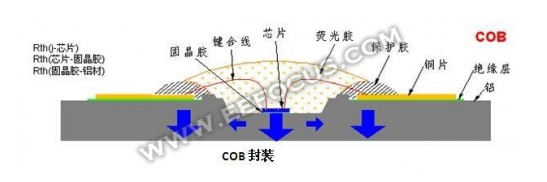
SO類型封裝
SO類型封裝包含有:SOP(小外形封裝)、TOSP(薄小外形封裝)、SSOP (縮小型SOP)、VSOP(甚小外形封裝)、SOIC(小外形集成電路封裝)等類似于QFP形式的封裝,只是只有兩邊有管腳的芯片封裝形式,該類型的封裝是表面貼裝型封裝之一,引腳從封裝兩側引出呈“ L” 字形。
該類型的封裝的典型特點就是在封裝芯片的周圍做出很多引腳,封裝操作方便,可靠性比較高,是目前的主流封裝方式之一,目前比較常見的是應用于一些存儲器類型的IC。

SOP封裝
SIP封裝
SIP封裝是將多種功能芯片,包括處理器、存儲器等功能芯片集成在一個封裝內,從而實現一個基本完整的功能。與SOC相對應。不同的是系統級封裝是采用不同芯片進行并排或疊加的封裝方式,而SOC則是高度集成的芯片產品。從封裝發展的角度來看,SIP是SOC封裝實現的基礎。
SiP的應用非常廣泛,主要包括:無線通訊、汽車電子、醫療電子、計算機、軍用電子等。

SIP封裝
3D封裝
3D晶圓級封裝,包括CIS發射器、MEMS封裝、標準器件封裝。是指在不改變封裝體尺寸的前提下,在同一個封裝體內于垂直方向疊放兩個以上芯片的封裝技術,它起源于快閃存儲器(NOR/NAND)及SDRAM的疊層封裝。
3D封裝主要特點包括:多功能、高效能;大容量高密度,單位體積上的功能及應用成倍提升以及低成本。
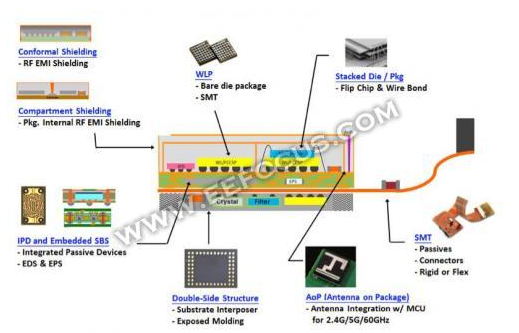
3D封裝
分類:
一:封裝趨勢是疊層封(PoP);低產率芯片似乎傾向于PoP。
二:多芯片封裝(MCP)方法,而高密度和高性能的芯片則傾向于MCP。
三:以系統級封裝(SiP)技術為主,其中邏輯器件和存儲器件都以各自的工藝制造,然后在一個SiP封裝內結合在一起。
目前的大多數閃存都采用多芯片封裝(MCP,Multichip Package),這種封裝,通常把ROM和RAM封裝在一塊兒。多芯封裝(MCP)技術是在高密度多層互連基板上,采用微焊接、封裝工藝將構成電子電路的各種微型元器件(裸芯片及片式元器件)組裝起來,形成高密度、高性能、高可靠性的微電子產品(包括組件、部件、子系統、系統)。
以上就是常見封裝類型的匯總情況,大家對于芯片封裝是否有了進一步的了解?是否還有需要補充的常見封裝類型? 歡迎大家留言討論。






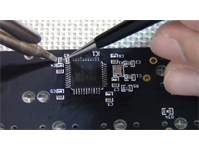








評論