對使用銅絲鍵合的功率MOSFET進行失效分析
——
圖5 對模塑料進行平行拋光。晶片(die)的高低相對于框架不是很平整,使得晶片的左上角先露了出來。
本文引用地址:http://www.104case.com/article/147852.htm
圖6和圖7顯示的是銅絲鍵合的聚離子束橫切面的照片,照片顯示殘留鋁的最薄厚度是0.125 μm。這種鍵合是必須避免的,但如果沒有很好的分析技術,就很難察覺。
采用化學刻蝕的辦法,能夠更快地測量出銅絲鍵合下面鋁層的厚度,只把銅絲和鍵合腐蝕掉,同時完整無損地保留下面的鋁層,就可以進行聚離子束的橫切面分析。這種方法的優點是能看到整個晶片表面的所有銅絲鍵合,這樣就可以選擇合適的鍵合進行分析。
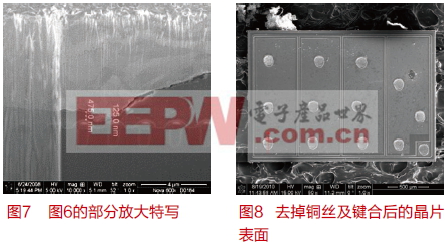
圖8顯示的是用酸刻蝕后的晶片表面。圖9顯示的是涵蓋一個鍵合區域的聚離子束橫切面。注意,從這幅圖上可以清楚地看到最上面鋁金屬層,鍵合造成周圍溢出了一些鋁,這表明最上面的金屬表面未曾受損。

采用傳統的機械研磨的方式暴露出引線鍵合的橫切面,在銅鍵合和鍵合下面金屬的交界處,經常會發生銅膠著于表面的情況。先研磨,再用聚離子束進行精細拋光,就可以解決這個問題,如圖10和圖11所示。

案例研究一
首先,我們研究一組用銅絲鍵合的MOSFET,經過1000次的溫度循環后,呈現高阻失效狀態。要找到失效原因,需要對銅線兩端進行仔細的檢查。首先,我們先用激光開封,把釘架上銅鍵合露出來,這是因為傳統的酸開封很容易損壞這些鍵合的緣故。
離子色譜儀相關文章:離子色譜儀原理













評論