對使用銅絲鍵合的功率MOSFET進行失效分析
摘要:由于銅絲鍵合可以替代金鍵合,價格又便宜,正在被越來越多地應用到微電子元器件當中。目前的情況表明銅是可行的替代品,但是證明其可靠性還需要采用針對銅絲鍵合工藝的新型失效分析(FA)技術。
本文引用地址:http://www.104case.com/article/147852.htm在本文中,我們將討論一些專門為使用銅絲技術的元器件而開發的新型失效分析技術和工序。我們會將解釋為什么銅絲的處理方式和金絲不一樣,并且以功率MOSFET器件為例,循序漸進地了解失效分析的過程,保存對失效器件進行有效分析所需要的所有證據。
開封問題
進行失效分析要先打開零件,看是什么原因引起器件失效,主要問題就出在開封方法上。傳統的酸刻蝕開封方法并不適用于銅絲鍵合的產品,因為硝酸的煙氣會導致銅絲的快速刻蝕,即如圖1和圖2所示。

保持銅絲及鍵合的完整是不可或缺的。我們嘗試使用激光開封,去掉部分模塑料,再用酸刻蝕,露出晶片表面。發現這樣對銅絲和鍵合造成的破壞最小。
使用這種方法開封的器件見圖3。圖中顯示,銅絲和鍵合均完好無損,但有時化學處理可能正好洗掉失效的根源,所以,如果可能應以離子束代替酸刻蝕。
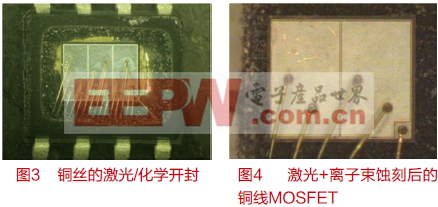
銅絲鍵合和金屬層的殘留鋁
完整露出銅線后還需要對銅絲鍵合進行研究,以便確定鍵合下金屬層的厚度。銅絲鍵合下面鋁層的最小厚度是影響銅絲鍵合產品的長期可靠性的關鍵因素。要詳細分析銅絲鍵合工藝的情況,聚離子束(FIB)是必不可少的失效分析工具。
我們開發了先平行拋光再用聚離子束橫切分析的方法,設計出一種不使用酸藥劑的失效分析工藝。圖5顯示,對模塑料進行平行拋光,露出了晶片表面。因為在原來的器件中晶片放的高低不是很平整,所以左上角已露出,但有一層薄薄的模塑料還覆蓋著晶片的右下角。
離子色譜儀相關文章:離子色譜儀原理













評論