英特爾10nm設計規則初定 EUV技術恐錯失良機
英特爾公司正在計劃將目前的193nm浸入式微影技術擴展到14nm邏輯節點,此一計劃預計在2013下半年實現。同時,這家芯片業巨頭也希望能在2015年下半年于10nm邏輯節點使用超紫外光(EUV)微影技術進行生產。
本文引用地址:http://www.104case.com/article/117543.htm但英特爾微影技術總監SamSivakumar指出,超紫外光(EUV)微影技術正面臨缺乏關鍵里程碑的危機。
盡管英特爾在距今4年前便已開始計劃10nm節點,但該公司目前正在敲定相關的制程設計規則,而EUV則遲遲未能參與此一盛晏。“EUV趕不及參與10nm節點設計規則的定義。”Sivakumar說。
Sivakumar表示,若生產工具順利在2012年下半年交貨,那么,EUV技術仍然很可能被應用在該公司的10nm節點。但即便如此,EUV技術的進度仍然落后。
英特爾正在考慮兩家公司的EUV技術工具:ASML和Nikon。據報導,ASML公司即將為英特爾推出一款“預生產”的EUV微影工具。ASML公司的這款工具名為NXE:3100,它采用Cymer公司的光源。
而Nikon日本總部和研發組織Selete則已開發了EUValpha工具。今年或明年,ASML和Nikon應該都能推出成熟的EUV工具。
盡管如此,對EUV技術而言,時間依然緊迫。EUV是下一代微影(next-generationlithography,NGL)技術,原先預計在 65nm時導入芯片生產。但該技術一直被推遲,主要原因是缺乏光源能(powersources)、無缺陷光罩、阻抗和量測等基礎技術。
先進芯片制造商們仍然指望能將EUV技術用在量產上,以努力避免可怕且昂貴的雙重曝光(doublepatterning)光學微影技術。然而,除了朝雙重曝光方向發展之外,芯片制造商們似乎別無選擇。專家認為,目前EUV主要瞄準16nm或更先進的節點。
設計規則的規則
英特爾在45nm節點使用干式193nm微影。在32納米則首次使用193nm浸入式生產工具,這部份主要使用Nikon的設備。
在22納米,英特爾將繼續使用193nm浸入式微影技術。這家芯片巨頭將在22nm節點的關鍵層同時使用ASML和Nkion的設備,預計2011下半年進入量產。
而后在14nm,這家芯片制造商將繼續使用193nm浸入式微影加上雙重曝光技術,該公司稱之為兩次間距曝光(pitchsplitting)。在一些會議上,英特爾曾提及在14nm節點使用五倍曝光(quintuplepatterning)。該公司希望為14nm節點建立一條EUV試產線,但目前尚不清楚EUV技術所需的準備時間。
英特爾已經確定其14nm節點的設計規則,有時甚至在產品量產前兩年便制訂完成。“針對14nm的設計規則目前是確定的。”Sivakumar說。
在65納米及以上制程,英特爾采用2D隨機和復雜的布局設計芯片。但在45nm時則很難再將2D隨機布局微縮。因此,在推進到45nm時,英特爾便轉移到1D的單向、柵格式(gridded)設計規則,他說。







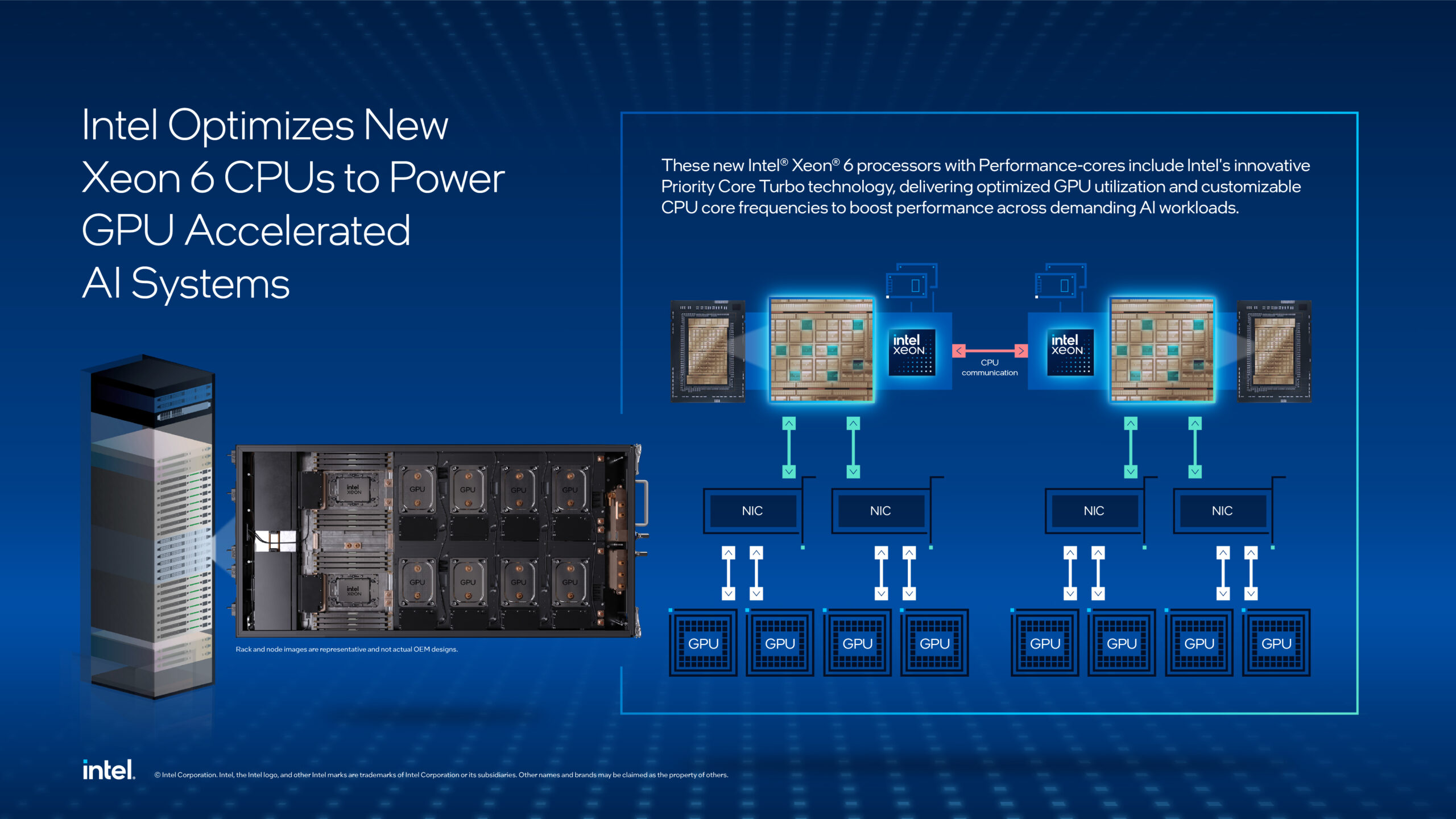






評論