臺積電探索HBM矩形面板基板!
臺積電正在開發一種新的先進芯片封裝方法,使用矩形面板基板,以滿足對先進多芯片處理器日益增長的需求。這一創新技術仍處于早期階段,預計需要數年時間才能實現商業化,但如果成功實施,將為這家全球最大的合同芯片制造商帶來重大的技術變革。
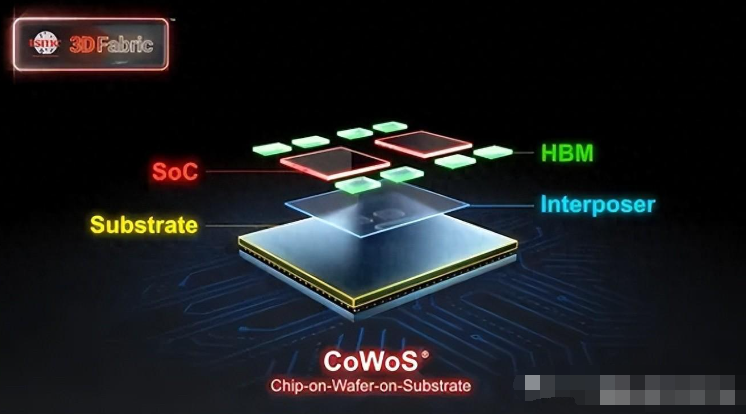
據報道,臺積電的新方法使用了510毫米×515毫米的矩形襯底,而不是傳統的300毫米直徑晶圓。這些面板的可用面積比傳統的300毫米圓晶圓大3.7倍,能夠在每個晶圓上生產更多芯片,并減少邊緣浪費。然而,這種新方法需要全新的設備,這意味著臺積電將無法使用傳統的晶圓廠工具。目前,臺積電正在與設備和材料供應商合作開發這種新的封裝技術,但具體細節尚未透露。
臺積電在日經新聞發布的一份聲明中寫道:“我們密切關注先進封裝的進展和發展,包括面板級封裝。”
該公司目前的先進芯片封裝技術,如CoWoS(
Chip-on-Wafer-on-Substrate),使用300毫米硅片,對于為英偉達、AMD、亞馬遜和谷歌等客戶生產人工智能處理器至關重要。然而,隨著人工智能芯片尺寸和復雜性的增長,現有方法的效率可能會下降,這促使了對新型矩形基板的需求。

向矩形基板的過渡在技術上具有挑戰性,需要對生產工具和材料進行重大更改。芯片生產所需的精度高于顯示器和PCB制造,使這種轉變變得復雜且耗時。
過渡到矩形基板被認為是一個長期計劃,可能需要5到10年的時間。為了適應新的基板形狀并確保這種先進封裝方法的成功,臺積電需要對設備進行重大升級,包括更新機械臂和自動化材料處理系統。
臺積電雄厚的財力和行業影響力對推動設備制造商適應新環境至關重要,但該計劃能否實現仍有待觀察。隨著臺積電在先進封裝領域的不斷創新,未來芯片生產的效率和性能有望得到顯著提升。
*博客內容為網友個人發布,僅代表博主個人觀點,如有侵權請聯系工作人員刪除。



