imec:High NA EUV光刻生態系統已做好了準備!
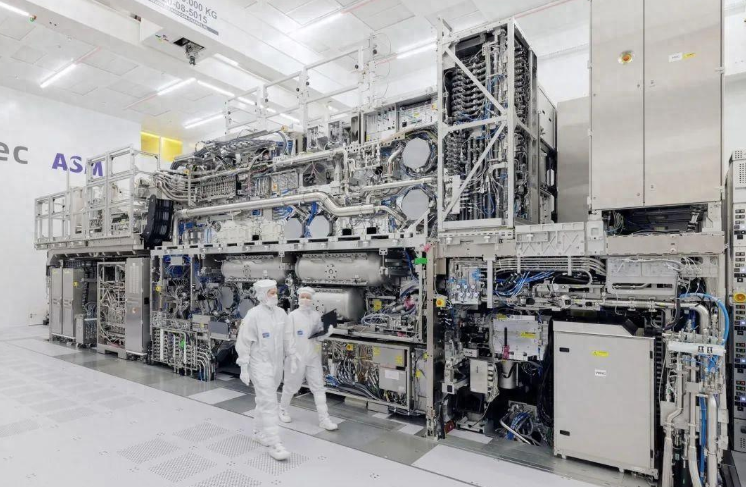
2月26日,據imec(比利時微電子研究中心)官方消息,在“2024 年先進光刻 + 圖案化會議上”,imec將展示 EUV 工藝、掩模和為實現高數值孔徑(High-NA)極紫外(EUV)光刻而準備的計量學。imec報告了抗蝕劑和底層開發、掩模增強、光學鄰近校正(OPC)開發、分辨率場拼接、減少隨機故障以及改進計量和檢測方面的主要成就。
有了這些結果,imec 就可以將 EUV 工藝轉移到imec-ASML 聯合高數值孔徑 EUV 實驗室中,該實驗室是圍繞第一臺High NA(高數值孔徑)EUV 光刻機原型構建的。
imec 高級圖案化、工藝和材料高級副總裁 Steven Scheer 表示:“ASML 已組裝第一臺High NA EUV 光刻機 (TWINSCAN EXE:5000),第一批晶圓將很快曝光。在接下來的幾個月中,imec-ASML High NA EUV 聯合實驗室將投入運營,并將向 High NA 客戶提供訪問權限。High NA EUV 實驗室配備了已安裝的設備和工藝,使客戶能夠在工具在工廠運行之前盡早開始高數值孔徑 EUV 學習。imec的職責是與 ASML 和我們擴展的供應商網絡密切合作,確保及時提供先進的抗蝕劑材料、光掩模、計量技術、(變形)成像策略和圖案化技術。2024 年 SPIE 高級光刻與圖案化會議上發表的超過 25 篇論文表明了這些工藝已為實現High NA做好了準備。”
場拼接是高數值孔徑的關鍵推動因素:由于變形鏡頭(即在 x 和 y 方向上具有不同放大倍數的鏡頭),需要進行場拼接,從而導致場尺寸為傳統掃描儀場尺寸的一半。imec將分享基于與 ASML 和我們的掩模車間合作伙伴在imec NXE:3400C 光刻機上完成的工作實現分辨率拼接的最新見解。分辨率拼接將減少為應對場尺寸減小而進行設計更改的需要。
在材料和工藝方面,很明顯金屬氧化物抗蝕劑(MOR)仍然處于金屬線/空間圖案的領先地位。imec 將展示 MOR 在 EUV 劑量產量降低方面的進展。特定底層的選擇、開發過程的優化、掩膜吸收體的選擇、掩膜偏差和掩膜色調導致線條和空間的劑量減少了 20% 以上,而沒有增加粗糙度或隨機故障。此外,尖端到尖端的尺寸并未受到這些劑量減少活動的負面影響。劑量減少工作仍在繼續,并受到我們的芯片制造商的高度贊賞,因為它由于掃描儀吞吐量更高而導致 EUV 成本降低。
通過使用 MOR 抗蝕劑和二元明場掩模進行接觸孔圖案化,獲得了意想不到的結果。與在同一疊層中轉移的正色調化學放大抗蝕劑 (CAR) 和二元暗場掩模相比,圖案轉移后劑量減少了 6%,局部 CD 均勻性 (LCDU) 提高了 30%。用于接觸孔的明場掩模的另一個問題是掩模質量和缺陷率。這需要仔細研究才能使 MOR 成為接觸孔的選擇。在此之前,帶有暗場掩模的正色調 CAR 抗蝕劑將成為高數值孔徑 EUV 中接觸和通孔圖案化的主要候選者。
High NA還需要改進計量和檢測,提供更高的分辨率(通過高數值孔徑)和更薄的薄膜(通過減小焦深 (DOF))。Imec 將展示電子束和深紫外 (DUV) 檢測的新結果,表明新的最知名方法 (BKM) 已到位,可以發現高 NA 相關的隨機圖案故障,例如六邊形接觸孔。此外,還將提出幾種機器學習技術(基于去噪 SEM 顯微照片)來促進小缺陷的檢查和分類。
最后,imec 和合作伙伴將介紹通過源掩模優化和變形掩模 OPC(考慮拼接的需要)實現的成像改進。
編輯:芯智訊-林子
*博客內容為網友個人發布,僅代表博主個人觀點,如有侵權請聯系工作人員刪除。


