一文了解半導體環氧塑封料
來源:艾邦半導體網

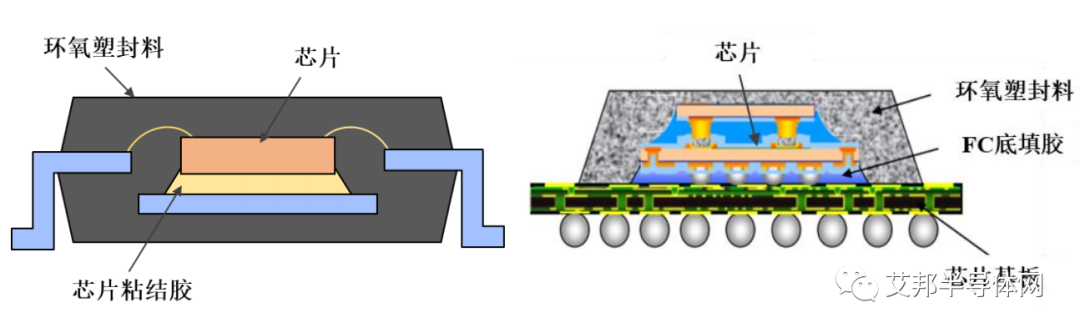
封裝技術發展階段 | 對應封裝形式 | 環氧塑封料性能要求 |
第一階段 | TO、DIP 等 | 重點考察環氧塑封料的熱性能與電性能,要求在配方設計中關注固化時間、Tg、CTE、導熱系數、離子含量、氣孔率等因素 |
第二階段 | SOT、SOP 等 | 重點考察環氧塑封料的可靠性、連續模塑性等性能,要求在配方設計中關注沖絲率、固化時間、流動性、離子含量、吸水率、粘接力、彎曲強度、彎曲模量等因素 |
第三階段 | QFN、BGA 等 | 重點考察環氧塑封料的翹曲、可靠性、氣孔等性能,要求在配方設計中關注流動性、粘度、彎曲強度、彎曲模量、Tg、CTE、應力、吸水率、粘接力等因素 |
第四、第五階段 | SiP、FOWLP 等 | 對環氧塑封料的翹曲、可靠性、氣孔提出了更高的要求,部分產品以顆粒狀或液態形式呈現,要求在配方設計中關注粘度、粘接力、吸水率、彎曲強度、彎曲模量、Tg、CTE、離子含量、顆粒狀材料的大小等因素 |
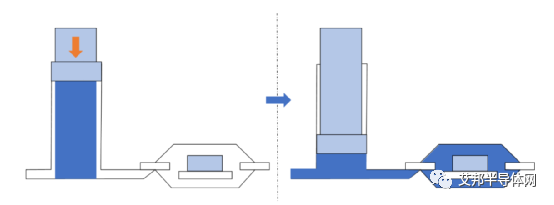 圖 環氧塑封料模塑成型的簡要工藝流程圖
圖 環氧塑封料模塑成型的簡要工藝流程圖 環氧塑封料生產的主要環節包括預處理、配料、高攪、磁選、擠出、粉碎、后混合、打餅等生產工藝環節。環氧塑封料的技術難度主要體現在:
(1)配方體系復雜
環氧塑封料的配方體系較為復雜。在配方開發過程中,需在眾多化合物中篩選出數十種原材料(包括主料及添加劑)進行復配,確定合適的添加比例,并充分考慮成本等因素以滿足量產的需求。由于配方中任一原材料的種類或比例變動都可能導致在優化某一性能指標時,對其它性能指標產生不利影響(例如,通過添加填料提升填充性的同時會使流動性下降),因此,產品配方需要充分考慮各原材料由于種類或比例不同對各項性能造成的相互影響,并在多項性能需求間實現有效平衡,以保證產品的可靠性。
(2)定制化需求
由于不同客戶或同一客戶不同產品的封裝形式、生產設備選型、工藝控制、前道材料選用、可靠性考核要求及終端應用場景等方面存在差異,對環氧塑封料的各項性能指標都有獨特的要求,下游封裝廠商對環氧塑封料的需求呈現定制化特征。
(3)匹配封裝技術
由于歷代封裝技術及不同的應用領域對環氧塑封料的性能要求均存在差異,環氧塑封料廠商需以下游技術的發展為導向,持續開發在理化性能、工藝性能以及應用性能等方面與歷代封裝技術相匹配的新產品,故而業內呈現出“一代封裝,一代材料”的特點。
封裝技術的持續演進對環氧塑封料提出了更多、更嚴苛的性能要求。其中,先進封裝中的QFN/BGA、FOWLP/FOPLP等因其不對稱封裝形式而增加了對環氧塑封料的翹曲控制要求,同時要求環氧塑封料在經過更嚴苛的可靠性考核后仍不出現任何分層且保持芯片的電性能良好。

*博客內容為網友個人發布,僅代表博主個人觀點,如有侵權請聯系工作人員刪除。











