N2 Purge在LPCVD爐管氮化硅工藝中的應用
根據對氮化硅薄膜的沉積過程分析,認為這是由于在LPCVD的爐管在生產過程反應中,氮化硅薄膜會逐漸沉積在反應腔的內壁上。這些沉積的氮化硅薄膜必然會受到應力的影響,這里的應力包括外應力和內應力。外應力指環境對薄膜本身施加的應力,如生產使用的氣體的氣流變化導致的干擾。內應力是薄膜沉積過程中,內部產生的應力。內應力包含熱應力和本質應力兩部分。氮化硅薄膜的熱應力來源于薄膜和反應腔體內壁材料的熱膨脹系數以及溫度的影響。本質應力是氮化硅薄膜的本征張應力。隨著氮化硅薄膜厚度的逐漸增加,應力必然逐漸增大。薄膜在內外應力的作用下必然會從反應壁上剝落下來,這些剝落的氮化硅薄膜就是氮化硅工藝中主要的particle來源(如圖4所示)。
實際的生產經驗也可以證明上面的理論:觀察了一臺生產機臺氮化硅薄膜的厚度從0μm累計到8μm之間的particle的情況。當氮化硅的薄膜厚度累積大于4μm的時候,生產機臺的particle就明顯的增加。這說明氮化硅LPCVD爐管工藝的particle數量和氮化硅薄膜的累積厚度相關(圖5)。

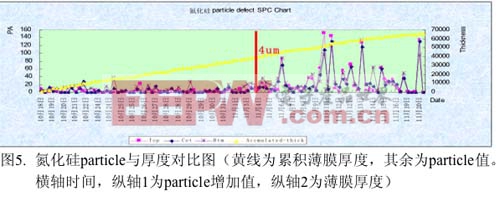
根據以上的氮化硅工藝中particle的分析中可以得知:為了解決氮化硅生產過程中的particle問題,必須要解決的是如何避免腔體內壁上的氮化硅薄膜的剝落的問題。而為了避免氮化硅薄膜的剝落,不但要減少腔體內壁上的薄膜沉積厚度,也要降低氮化硅薄膜所受到應力作用。
反應腔內壁上沉積的氮化硅薄膜必須及時的清除,常規的做法就是通過周期性的維護來去除反應腔體上的氮化硅薄膜。但經常性的清理會導致機臺的生產效率降低,維護成本增加。應力方面,由于無法改變氮化硅薄膜的本質應力,所以只能降低氮化硅薄膜內在應力中的熱應力和外在應力。根據上面的分析,對于熱應力,需要考慮薄膜和反應腔體內壁材料的熱膨脹系數以及溫度等因素的影響。對于外在應力,就要優化在生產過程中的一些工藝參數來改善,如溫度,壓力和流量等方面的優化。






評論