晶圓級CSP封裝技術趨勢與展望
當隔離層更厚(>5um)、線路圖形更厚(>5um)、線路阻抗更低(鋁的60%)時,電感通常比SoC中使用鋁線路的電感更優越。WLCSP技術中制作銅電感可以實現芯片更低的功耗,使應用擴張到移動產品中。線寬和空間分布L/S是實現高性能電路的重要指標,因此光刻和電鍍也成為整個工藝流程中最重要的技術。
未來的線路再分布技術
生成電路圖形是上文提到的基本技術的重復。它生成UBM層,涂上光刻膠并生成所需的圖形,然后進行電鍍,最后再去除不再需要的光刻膠和UBM層。可以說,這個工藝還是所謂的“浪費材料的技術”。
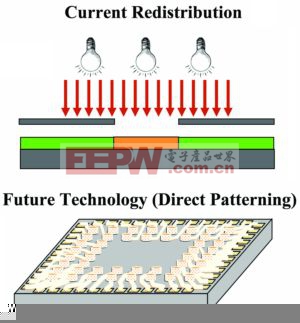
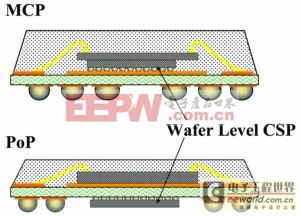
目前業界已經開發出了一種不會“浪費材料”的技術,它可以直接實現圖形制作(圖4),以替代現有的“浪費材料的技術”。該技術采用納米膠(nano-paste)和刻印噴?SPANlang=EN-US>(inkjetprinting)技術。這種技術的L/S指標目前還不能達到現在采用光刻、電鍍技術實現的精細間距水平,然而,它是有益生態的技術,通過進一步的開發,這種技術可能會使用在更多的應用中。
WLCSP技術的展望
WLCSP在2000年應用在電子手表中之后,已經應用在手機、存儲卡、汽車導航儀、數碼設備中。未來幾年中,在手機這樣的高性能移動市場中,會更多采用WLCSP技術的芯片。
電子終端產品市場需要各種不同的系統級封裝(SiP,SystemInPackage),已有的形式包括在一個多芯片模塊(MCP,MultiChipPackage)封裝,以及封裝體堆疊(PoP,PackageOnPackage)等SiP的不同形式。手機設備中“SRAM+Flash”的封裝是推動SiP技術實現高性能電子設備的重要動力。
WLCSP技術為實現生產輕薄和小巧電子設備帶來了更多的可能性。WLCSP已經應用在電路板組裝上,近來它也成為SiP的重要組成部分,結合WLCSP和常規引線鍵合技術的MCP也已經進入量產(圖5)。
集成電路通常通過回流焊貼裝在PCB板上。使用常規的表面貼裝技術,PCB的組裝密度將接近極限。將芯片嵌入到PCB板中的技術可以實現更高的功能,并已經有量產。將WLCSP技術和芯片嵌入PCB工藝結合,可以確保PCB組裝質量的穩定,這是因為WLCSP不僅易于進行PCB板貼裝,而且具有“已知優良芯片(KGD,KnownGoodDie)”的特性。
結論
WLCSP不僅是實現高密度、高性能封裝和SiP的重要技術,同時也將在器件嵌入PCB技術中起關鍵作用。盡管引線鍵合技術非常靈活和成熟,但是WLCSP技術的多層電路、精細線路圖形、以及能與引線鍵合結合的特點,表明它將具有更廣泛的應用和新的機遇。
回流焊相關文章:回流焊原理






評論