2.5D/3D 芯片技術將推動半導體封裝技術的進步
來自日本東京科學研究所(Science Tokyo)的一組研究人員 conceptualised 一種創新的 2.5D/3D 芯片集成方法,稱為 BBCube。
本文引用地址:http://www.104case.com/article/202506/471595.htm傳統的系統級封裝(SiP)方法,其中半導體芯片使用焊點排列在二維平面(2D)上,存在尺寸相關的限制,需要開發新的芯片集成技術。為了高性能計算,研究人員通過采用 3D 堆疊計算架構開發了一種新型電源技術,該架構由直接堆疊的動態隨機存取存儲器上放置的處理單元組成,這是 3D 芯片封裝的重大進步。
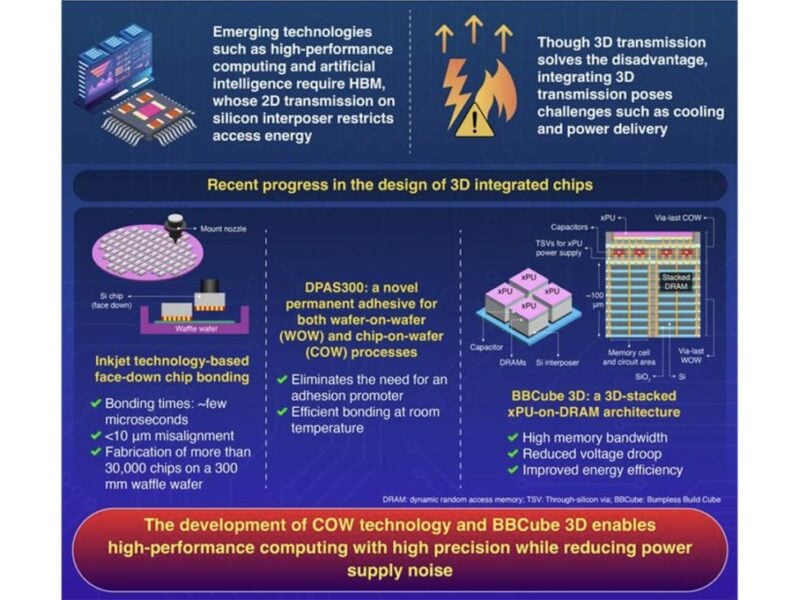
為了實現 BBCube,研究人員開發了涉及精確和高速鍵合技術和粘合劑技術的關鍵技術。這些新技術可以幫助滿足高性能計算應用的需求,這些應用需要高內存帶寬和低功耗,并減少電源噪聲。
該研究團隊由小橋典雄教授、大庭隆之教授以及來自日本東京科學研究所(Science Tokyo)綜合研究所的 WOW 聯盟異構和功能集成部門的其他科學家組成,最初開發了一種倒裝芯片-晶圓(COW)工藝,以規避使用焊料互連的限制。利用噴墨技術和選擇性粘合涂層方法,他們成功地將不同尺寸的芯片依次粘合到晶圓間距為 10 微米、最小安裝負載時間小于 10 毫秒的 300 毫米蛋撻狀晶圓上。解釋精確的 COW 工藝,小橋評論道:“在蛋撻狀晶圓上制造了超過 30,000 個不同尺寸的芯片,實現了更高的粘合速度,且沒有任何芯片脫落故障。”
為了實現精確高速的 COW 工藝,研究人員專注于解決影響超薄晶圓多層堆疊的熱穩定性問題。通過精心設計化學特性,他們開發了一種新型粘合材料,稱為“DPAS300”,該材料可用于 COW 和晶圓對晶圓工藝。這種新型粘合劑由有機-無機雜化結構組成,在實驗研究中表現出良好的粘附性和耐熱性。
最后,為了實現高內存帶寬并提高 BBCube 的電源完整性,科學家們采用了一種由新型電源分配高速公路強化的 3D xPU-on-DRAM 架構。這包括在 xPU 和 DRAM 之間嵌入電容器,在晶圓上實施重分布層,以及在晶圓通道和 DRAM 刻線中放置硅通孔。喬指出:“這些創新將數據傳輸所需的能量減少到傳統系統所需能量的五分之一到二十分之一,同時還將電源噪聲抑制到 50 毫伏以下”,突出了 3D 堆疊計算架構的優勢。
科研人員開發的東京科學 3D 芯片集成技術有可能改變下一代計算架構。





評論