英特爾展示封裝創新路徑:提高良率、穩定供電、高效散熱
為了推動AI等創新應用落地,使其惠及更廣大的用戶,需要指數級增長的算力。為此,半導體行業正在不斷拓展芯片制造的邊界,探索提高性能、降低功耗的創新路徑。
本文引用地址:http://www.104case.com/article/202506/471242.htm在這樣的背景下,傳統上僅用于散熱和保護設備的封裝技術正在從幕后走向臺前,成為行業熱門趨勢。與傳統的封裝技術不同,先進封裝技術可以在單個設備內集成不同廠商、不同制程、不同大小、不同功能的芯片,從而為打造功能更強大、能效比更高的系統級芯片(SoC),帶來了全新的可能性。

英特爾一直致力于將處理器、加速器和存儲器等各種各樣的芯片堆疊起來,組合到更大規模的封裝中,幫助客戶讓產品性能“更上一層樓”。在2025 IEEE電子器件技術大會(ECTC)上,英特爾分享了其封裝技術的最新進展,這一大會由IEEE(電氣電子工程師學會)電子封裝協會主辦,聚焦于封裝、器件和微電子系統的科研、技術與教育,是封裝領域的國際頂會。
具體而言,英特爾在封裝領域的三大關鍵技術路徑包括:提高封裝的良率,確保供電穩定可靠,以及通過有效的熱管理技術實現散熱。
EMIB-T:穩定供電

英特爾的EMIB(嵌入式多芯片互連橋接)技術已經投入生產,突破了光罩尺寸的限制,實現了多芯片之間的高速互聯。此外,通過硅通孔(TSV)技術,EMIB-T 優化了供電效率,并為集成高速HBM4,以及基于UCIe標準的芯粒提供了簡便的解決方案。
熱壓鍵合:提高良率
隨著封裝尺寸越來越大,集成多芯片的復雜程度也在同步提升。英特爾計劃通過探索高精度、大光罩熱壓鍵合(TCB)的先進工藝來提高良率和可靠性。

分解式散熱器:高效散熱
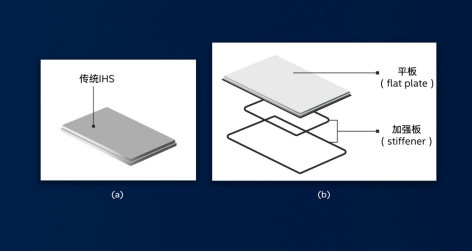
隨著封裝變得越來越復雜,尺寸也越來愈大,熱設計功耗(TDP)也在不斷增加。為應對散熱層面的挑戰,英特爾正在研發全新的分解式散熱器技術,以及新一代熱界面材料。這些創新可以更有效地將熱量從熱源傳遞到散熱器的各個部分,進而提升整體的散熱效率。









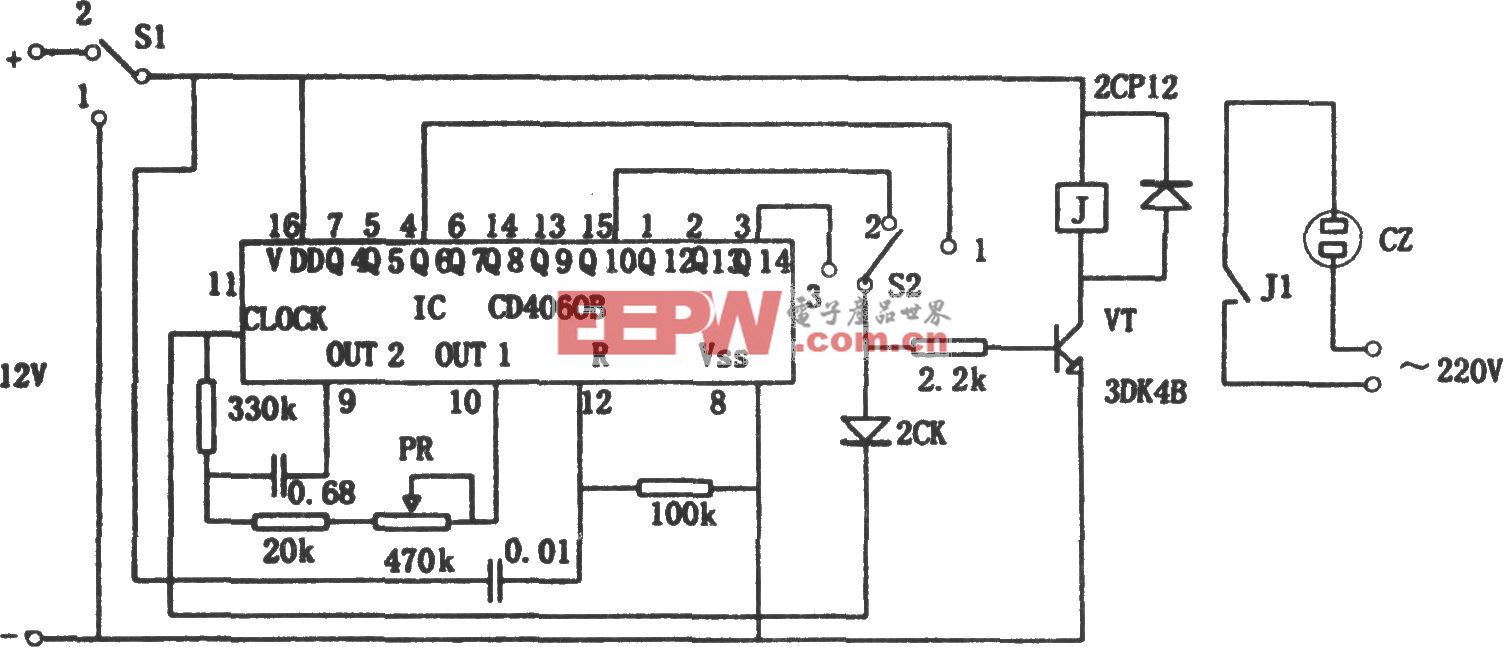



評論