用新型極紫外光刻膠材料推進(jìn)半導(dǎo)體工藝
更快、更小、更高效的電子設(shè)備的需求不斷增長(zhǎng),推動(dòng)了半導(dǎo)體行業(yè)對(duì)創(chuàng)新的不懈追求。半導(dǎo)體制造的核心技術(shù)之一是極紫外光刻 (EUVL),它可以以更高的分辨率實(shí)現(xiàn)更小的特征尺寸,從而實(shí)現(xiàn)器件的小型化。全球的研究人員和公司正在專注于開(kāi)發(fā)新型極紫外 (EUV) 光刻膠材料,以支持納米級(jí)分辨率的 EUVL 圖案化并提高半導(dǎo)體器件的性能。
本文引用地址:http://www.104case.com/article/202310/451172.htm光刻是半導(dǎo)體制造中的關(guān)鍵步驟,其中圖案被轉(zhuǎn)移到晶圓上以創(chuàng)建集成電路和其他微結(jié)構(gòu)。傳統(tǒng)光刻依賴于深紫外光,但隨著集成電路達(dá)到個(gè)位數(shù)納米尺度,EUV 光刻變得勢(shì)在必行。EUV 光的工作波長(zhǎng)約為 13.5 納米,能夠以高精度打印更小的特征。EUV 光刻膠是半導(dǎo)體制造工藝中使用的光敏材料,特別是先進(jìn)的光刻技術(shù)。這些材料必須能夠承受高能 EUV 光子并提供高分辨率圖案化能力。開(kāi)發(fā) EUV 光刻膠材料的一些挑戰(zhàn)是它們需要對(duì)短波長(zhǎng)高度敏感。
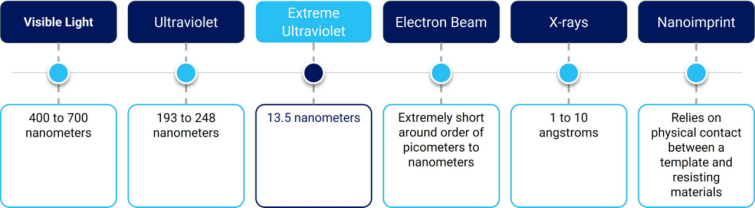
這些創(chuàng)新材料通常根據(jù)其配方或成分分為化學(xué)放大光刻膠 (CAR)、非化學(xué)放大光刻膠、無(wú)機(jī) EUV 光刻膠和混合 EUV 光刻膠。當(dāng)暴露在 EUV 光下時(shí),它們會(huì)發(fā)生化學(xué)或物理變化,從而能夠?qū)D案準(zhǔn)確轉(zhuǎn)移到表面上。
了解極紫外光刻膠材料
EUV 光刻膠材料是光敏物質(zhì),當(dāng)暴露于高能 EUV 光子時(shí)會(huì)發(fā)生化學(xué)變化。EUV 光子從光敏化合物產(chǎn)生光酸。這種酸催化抗蝕劑聚合物中的脫保護(hù)反應(yīng),使其更易溶于顯影劑溶液。放大的反應(yīng)提高了靈敏度并實(shí)現(xiàn)高分辨率圖案化。隨著半導(dǎo)體節(jié)點(diǎn)的尺寸越來(lái)越小,保持分辨率、靈敏度和圖案保真度變得更加復(fù)雜和具有挑戰(zhàn)性。目前正在進(jìn)行研究開(kāi)發(fā)新材料、機(jī)制和加工技術(shù),以應(yīng)對(duì)這些挑戰(zhàn)并實(shí)現(xiàn)進(jìn)一步的小型化。
極紫外光刻膠材料種類

化學(xué)放大光刻膠:化學(xué)放大光刻膠是最常用的 EUV 光刻膠。他們采用光致產(chǎn)酸劑 (PAG),在暴露于 EUV 光子時(shí)產(chǎn)生酸。這種酸會(huì)催化抗蝕劑中的化學(xué)反應(yīng),導(dǎo)致曝光區(qū)域在顯影過(guò)程中溶解。CAR 以其高靈敏度而聞名,使其適合低劑量 EUV 曝光并提高半導(dǎo)體制造過(guò)程中的產(chǎn)量。它們可能會(huì)在光學(xué)設(shè)備、顯示器和先進(jìn)封裝中找到應(yīng)用。
無(wú)機(jī) EUV 光刻膠:具有不同 EUV 吸收系數(shù)和高蝕刻能力的無(wú)機(jī)光刻膠材料對(duì)于解決一些現(xiàn)有問(wèn)題具有重要意義。因此,許多研究人員開(kāi)始研究無(wú)機(jī)材料在光刻膠領(lǐng)域的使用。這些材料與有機(jī) CAR 不同,因?yàn)樗鼈冇蔁o(wú)機(jī)材料組成,例如金屬氧化物或含金屬化合物。他們的工作原理是將丙烯酸作為有機(jī)配體的金屬氧化物系統(tǒng)應(yīng)用于 EUV 光刻。與有機(jī)光刻膠相比,無(wú)機(jī)光刻膠有望提供更高的熱穩(wěn)定性并減少釋氣。他們可能會(huì)在極端環(huán)境或?qū)iT的半導(dǎo)體工藝中找到應(yīng)用。
非化學(xué)放大光刻膠:與 CAR 不同,非化學(xué)放大光刻膠不依賴于酸催化反應(yīng)。相反,它們?cè)?EUV 曝光后直接發(fā)生光解反應(yīng),導(dǎo)致溶解度發(fā)生變化。這些材料通常需要更高劑量的 EUV 光來(lái)進(jìn)行圖案化,并且正在針對(duì)特定應(yīng)用和工藝要求進(jìn)行探索。
混合 EUV 光刻膠:混合 EUV 光刻膠結(jié)合了有機(jī)和無(wú)機(jī)元素,充分利用了兩種材料類型的優(yōu)勢(shì)。這些材料通過(guò)在配體交換反應(yīng)后選擇用于純化步驟的樹(shù)脂作為用叔胺、哌啶和二甲胺官能化的聚苯乙烯樹(shù)脂來(lái)發(fā)揮作用。這些材料旨在提供增強(qiáng)的靈敏度、分辨率和熱穩(wěn)定性,解決純有機(jī)或無(wú)機(jī)光刻膠的一些局限性。
極紫外光刻膠材料:過(guò)去 5 年發(fā)展趨勢(shì)

EUV 光刻膠開(kāi)發(fā)的主要挑戰(zhàn)
EUV 靈敏度:靈敏度是 EUV 光刻的關(guān)鍵挑戰(zhàn)之一;開(kāi)發(fā)和優(yōu)化能夠有效吸收 EUV 光并與之反應(yīng)以在半導(dǎo)體晶圓上產(chǎn)生精確圖案的光刻膠材料非常困難。EUV 光子稀缺且昂貴,需要具有高靈敏度的光刻膠材料,以在制造過(guò)程中實(shí)現(xiàn)每小時(shí) 100 至 120 片晶圓的足夠吞吐量。
分辨率和 LER:隨著特征尺寸的減小,保持高分辨率而不產(chǎn)生過(guò)大的線邊緣粗糙度 (LER) 就成為問(wèn)題。EUV 光刻膠 LER 的一個(gè)重要潛在來(lái)源是由于高光子能量而產(chǎn)生的光子散粒噪聲。LER 挑戰(zhàn)涉及最大限度地減少形成晶體管特征的已開(kāi)發(fā)光刻膠線邊緣的不規(guī)則性或粗糙度。過(guò)多的 LER 會(huì)導(dǎo)致晶體管性能變化并降低芯片產(chǎn)量。制造商需要優(yōu)化光刻膠配方和工藝條件,以實(shí)現(xiàn) 2 nm 的 LER,但靈敏度僅為 70 mJ/cm,并且晶體管特征的邊緣更平滑、更精確。
脫氣:EUV 光刻中的脫氣問(wèn)題是指在 EUV 光曝光期間從光刻膠中釋放揮發(fā)性有機(jī)化合物 (VOC) 或其他材料。這些脫氣材料可能會(huì)污染周圍環(huán)境,包括 EUV 光刻設(shè)備中使用的光學(xué)器件。污染會(huì)降低設(shè)備性能和產(chǎn)量,同時(shí)增加維護(hù)要求。控制和最大限度地減少排氣對(duì)于維持整個(gè) EUV 光刻工藝的可靠性和效率至關(guān)重要。
熱穩(wěn)定性:EUV 曝光會(huì)產(chǎn)生大量熱量,需要在高能條件下保持穩(wěn)定的光刻膠材料。許多應(yīng)用需要具有優(yōu)異熱穩(wěn)定性的涂層。大多數(shù)市售去除劑在熱負(fù)荷高達(dá) 130°C 后會(huì)迅速溶解抗蝕劑層。
新型 EUV 光刻膠材料的進(jìn)步前景廣闊
高靈敏度、低劑量材料:研究人員正在探索創(chuàng)新的化學(xué)放大光刻膠,即使在較低劑量下也能對(duì) EUV 光子產(chǎn)生強(qiáng)烈反應(yīng),從而將吞吐量提高到每小時(shí) 100 片晶圓并降低制造成本。
改進(jìn)的分辨率和 LER 控制:化學(xué)放大和無(wú)機(jī)抗蝕劑等新型材料旨在減輕 LER,同時(shí)保持高分辨率圖案化能力。先進(jìn)的化學(xué)原子抗蝕劑成分和獨(dú)特的聚合物結(jié)構(gòu)在實(shí)現(xiàn)更高的 EUV 光靈敏度、提高對(duì)比度以及將 LER 降低到 2nm 以下方面發(fā)揮著至關(guān)重要的作用。
減少釋氣:低釋氣光刻膠的開(kāi)發(fā)可確保更清潔的 EUV 曝光,從而提高產(chǎn)量并提高半導(dǎo)體器件的可靠性。減少排氣對(duì)于保持 EUV 光刻工藝的清潔度和完整性至關(guān)重要,因?yàn)?EUV 光刻工藝對(duì)污染物高度敏感。半導(dǎo)體制造商與材料供應(yīng)商和設(shè)備制造商密切合作,確保 EUV 光刻工藝中使用的光刻膠和其他材料滿足嚴(yán)格的除氣要求,并有助于生產(chǎn)高質(zhì)量的半導(dǎo)體器件。
熱穩(wěn)定性解決方案:為了解決 EUV 光刻的熱挑戰(zhàn),研究人員正在開(kāi)發(fā)具有增強(qiáng)熱穩(wěn)定性的工程材料,從而在不影響性能的情況下延長(zhǎng)曝光時(shí)間。

合作與未來(lái)展望
開(kāi)發(fā)和優(yōu)化新型 EUV 光刻膠材料需要半導(dǎo)體制造商、材料供應(yīng)商和研究機(jī)構(gòu)之間的合作。半導(dǎo)體行業(yè)對(duì)下一代器件的追求依賴于 EUV 光刻技術(shù)的不斷進(jìn)步和完善。
新型 EUV 光刻膠材料的成功應(yīng)用將為半導(dǎo)體技術(shù)帶來(lái)無(wú)數(shù)的可能性。更小、更強(qiáng)大的設(shè)備將徹底改變各個(gè)領(lǐng)域,包括數(shù)據(jù)中心、醫(yī)療保健、汽車和人工智能。影響不僅限于傳統(tǒng)計(jì)算,使半導(dǎo)體制造商能夠生產(chǎn)具有更小特征尺寸的芯片。這使得電子設(shè)備的晶體管密度更高、性能更高、功耗更低。它還增強(qiáng)了半導(dǎo)體器件的功能,從而能夠生產(chǎn)先進(jìn)的處理器、存儲(chǔ)器件和傳感器,從而推動(dòng)各個(gè)行業(yè)的技術(shù)創(chuàng)新。
結(jié)論
新型極紫外光刻膠材料是不斷增強(qiáng)半導(dǎo)體技術(shù)的重要基石。在半導(dǎo)體晶圓上打印更小、更精確的特征的能力對(duì)于滿足數(shù)字時(shí)代的需求至關(guān)重要。該領(lǐng)域的協(xié)作研發(fā)為半導(dǎo)體行業(yè)帶來(lái)了光明的未來(lái),確保電子設(shè)備的不斷發(fā)展,為我們的生活賦能和豐富。
開(kāi)發(fā)新型 EUV 光刻膠材料需要材料科學(xué)家、化學(xué)家、物理學(xué)家和工程師之間的合作。材料供應(yīng)商、半導(dǎo)體制造商和研究機(jī)構(gòu)攜手合作,在嚴(yán)苛的 EUV 曝光條件下設(shè)計(jì)、表征和測(cè)試這些材料。
EUV 光刻和光刻膠開(kāi)發(fā)領(lǐng)域正在不斷發(fā)展。研究人員正在探索廣泛的材料創(chuàng)新,包括無(wú)機(jī)抗蝕劑、納米結(jié)構(gòu)材料和混合聚合物。隨著半導(dǎo)體行業(yè)追求更高水平的小型化和性能,對(duì)新型 EUV 光刻膠材料的追求仍然是一個(gè)活躍的研究和創(chuàng)新領(lǐng)域。




評(píng)論