基于電力網(wǎng)通信芯片的量產(chǎn)測試研究
摘要:討論了數(shù)模混合芯片的典型測試方法,并按測試方法進(jìn)行了測試開發(fā);討論了測試調(diào)試中的問題以及降低測試成本的方法。該設(shè)計(jì)可滿足芯片大規(guī)模量產(chǎn)的測試需求,并能夠達(dá)到預(yù)期設(shè)計(jì)目標(biāo)。
關(guān)鍵詞:電力網(wǎng);通信芯片;量產(chǎn)測試;數(shù)模混合
0 引言
集成電路測試是對集成電路或模塊進(jìn)行檢測,通過測量對于集成電路的輸出響應(yīng)和預(yù)期輸出進(jìn)行比較,以確定或評估集成電路元器件功能和性能的過程。它是驗(yàn)證設(shè)計(jì)、監(jiān)控生產(chǎn)、保證質(zhì)量、分析失效以及指導(dǎo)應(yīng)用的重要手段。按測試的目的不同,可將測試分為三類:驗(yàn)證測試、生產(chǎn)測試和使用測試。本文主要討論的內(nèi)容是生產(chǎn)測試。生產(chǎn)測試的基本目的是識別有缺陷的芯片,并防止它們流出制造片進(jìn)入下一級生產(chǎn)過程,以節(jié)約整體成本。
由于集成電路的集成度不斷提高,測試的難度和復(fù)雜度也越來越高,當(dāng)前大規(guī)模集成電路生產(chǎn)測試已經(jīng)完全依賴于自動測試設(shè)備(Auto matic Test Equipment,ATE)。測試工程師的任務(wù)就是根據(jù)被測器件(Device Under Test,DUT)的產(chǎn)品規(guī)范(Specification)要求制定測試方案(Test Plan),并利用ATE的軟、硬件資源對DUT施加激勵信號、收集響應(yīng),最后將輸出響應(yīng)與預(yù)期要得到的信號進(jìn)行對比或計(jì)算得出測試結(jié)果,最終判斷芯片能否符合最初設(shè)計(jì)要求以決定出廠或丟棄。測試失效的芯片可收集返回給生產(chǎn)廠家,分析失效原因以提高良率。按照測試方案,將芯片測試分為晶圓測試(中測,也叫CP測試)和封裝測試(成測,也叫FT測試)。其中FT測試也是就芯片成品的最后一次測試,用來保證芯片的出廠品質(zhì);而CP測試主要是在芯片量產(chǎn)初期,晶圓良率不高時(shí),為了減少對失效芯片進(jìn)行封裝的費(fèi)用而進(jìn)行的測試,同時(shí)CP測試的結(jié)果還可以反饋給晶圓廠家進(jìn)行工藝調(diào)整,以提高良率。其ATE的測試程序流程圖如圖1所示。
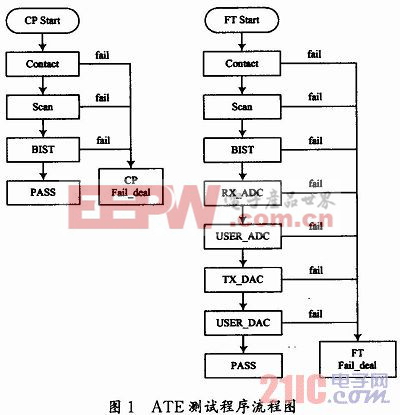
圖中CP測試程序的三部分Contact、Sean、BIST都與FT測試程序中此三部分一致,不同的是錯(cuò)誤處理(Fail deal)部分的處理不同。CP測試中DUT是整個(gè)晶圓,未通過測試的芯片可以通過打墨點(diǎn)或是機(jī)器記錄位置的方式標(biāo)記出,待晶圓劃片時(shí),把錯(cuò)誤芯片分類挑出,稱為分BIN。在FT測試中,因?yàn)槭且呀?jīng)封裝完成的芯片,所以當(dāng)芯片未通過測試時(shí),直接通過機(jī)械手(Handler)將錯(cuò)誤芯片丟棄或分類。FT測試為了充分利用ATE測試資源,采用了四同測的方式;而CP測試是量產(chǎn)初期過渡項(xiàng)目,為了節(jié)約探針卡制作成本,采用單測方式。
1 項(xiàng)目測試描述
1.1 Contact測試
利用被測管腳與地之間的二極管進(jìn)行連接性測試。施加電流使二極管導(dǎo)通,正常連接時(shí)管腳上的電壓值應(yīng)為二極管管壓降。如圖2所示。其管腳與電源之間的連接性測試原理與此相同。
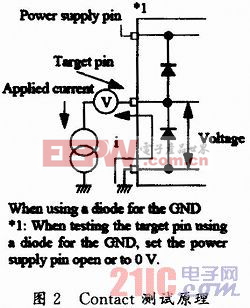
為了防止二極管電壓偏差和電壓測量時(shí)的誤差等影響引入不必要的量產(chǎn)損失,在實(shí)際測試中的判決電壓值為:對地連接性-1~0.1 V,對電源連接性0.1~1V。
1.2 BIST,Scan測試
BIST與Scan的測試方式基本相同,都是對芯片輸入一測試向量然后比對輸出向量的檢測。測試向量(pattern)由后端仿真得出的波形產(chǎn)生(WGL,Wave Generation Language)文件轉(zhuǎn)換而來。BIST作為普通功能測試,施加激勵,對輸出進(jìn)行判斷。雖然Sean測試是結(jié)構(gòu)性測試,但對于ATE而言,其測試方法與功能測試并無區(qū)別,只是Scan測試可以較少的測試向量達(dá)到較高的測試覆蓋率。ATE功能測試原理如圖3所示。
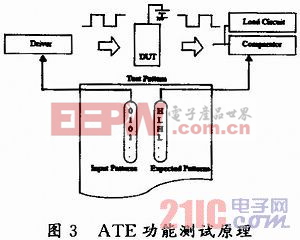









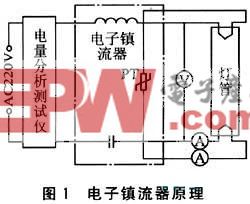


評論