AMD與英偉達需求推動FOPLP發展,預估量產時間落在2027-2028年
TrendForce集邦咨詢指出,自臺積電于2016年開發命名為整合扇出型封裝(InFO)的扇出型晶圓級封裝(FOWLP)技術,并應用于iPhone7 手機所使用的A10處理器后,專業封測代工廠(OSAT)業者競相發展FOWLP及扇出型面板級封裝(Fan-out Panel Level Package, FOPLP)技術,以提供單位成本更低的封裝解決方案。
本文引用地址:http://www.104case.com/article/202407/460653.htm自第二季起,超威半導體(AMD)等芯片業者積極接洽臺積電及OSAT業者以FOPLP技術進行芯片封裝,帶動業界對FOPLP技術的關注。根據全球市場研究機構TrendForce集邦咨詢調查,在FOPLP封裝技術導入上,三種主要模式包括「OSAT業者將消費性IC封裝方式自傳統封裝轉換至FOPLP」;「專業晶圓代工廠(foundry)、OSAT業者封裝AI GPU,將2.5D封裝模式自晶圓級(wafer level)轉換至面板級(panel level)」;「面板業者封裝消費性IC」等三大方向。
從OSAT業者封裝消費性IC,自傳統封裝轉換至FOPLP發展的合作案例來看,以AMD與PTI (力成)、ASE (日月光)洽談PC CPU產品,高通公司(Qualcomm)與ASE洽談電源管理芯片 (PMIC)產品為主。以目前發展來看,由于FOPLP線寬及線距尚無法達到FOWLP的水平,FOPLP的應用暫時止步于PMIC等成熟制程、成本較敏感的產品,待技術成熟后才會導入到主流消費性IC產品。
若是觀察foundry、OSAT業者封裝AI GPU,將2.5D封裝模式自wafer level轉換至panel level合作模式,則是以AMD及英偉達與臺積電、SPIL (矽品科技)洽談AI GPU產品,在既有的2.5D模式下自wafer level轉換至panel level,并放大芯片封裝尺寸最受到矚目,只是由于技術的挑戰,foundry、OSAT業者對此轉換尚處評估階段。
以面板業者封裝消費性IC為發展方向的則以恩智浦半導體(NXP)及意法半導體(STMicroelectronics)與Innolux (群創光電)洽談PMIC產品為代表。
從FOPLP技術對封測產業發展的影響面來看,第一,OSAT業者可提供低成本的封裝解決方案,提升在既有消費性IC的市占,甚至跨入多芯片封裝、異質整合的業務;第二,面板業者跨入半導體封裝業務;第三,foundry及OSAT業者可壓低2.5D封裝模式的成本結構,甚至借此進一步將2.5D封裝服務自既有的AI GPU市場推廣至消費性IC市場;第四,GPU業者可擴大AI GPU的封裝尺寸。
TrendForce集邦咨詢認為,FOPLP技術的優勢及劣勢、發展機會及挑戰并存。主要優勢為低單位成本及大封裝尺寸,只是技術及設備體系尚待發展,技術商業化的進程存在高度不確定性,預估目前FOPLP封裝技術發展在消費性IC及AI GPU應用的量產時間點,可能分別落于2024年下半年至2026年,以及2027-2028年。
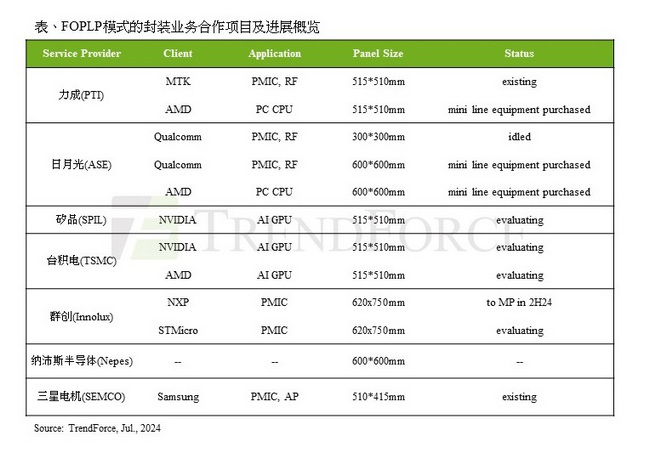



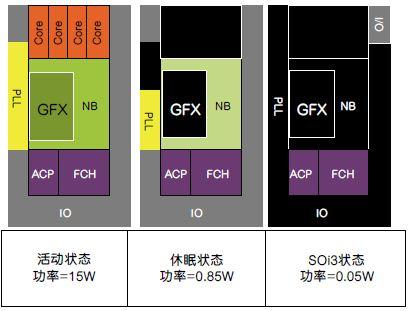





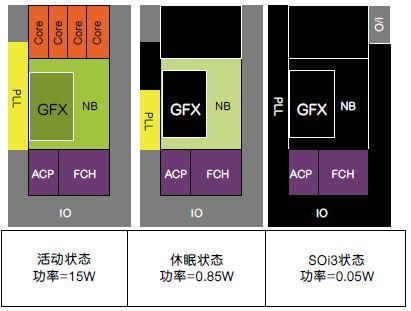




評論