SoC用低電壓SRAM技術(shù)
(1)作為控制NBTI發(fā)生的技術(shù),該公司向多晶硅柵極及SiON柵極絕緣膜的界面附近添加了Hf(鉿)。Hf可作為使SiON柵極絕緣膜與硅底板界面上存在的氧原子懸空鍵(DanglingBond)相互結(jié)合的催化劑發(fā)揮作用。由此可控制懸空鍵引起的NBTI現(xiàn)象。該技術(shù)以東芝與NEC電子(現(xiàn)在的瑞薩電子)的CMOS工藝技術(shù)共同開發(fā)成果為基礎(chǔ),于08年開發(fā)而成。
(2)為了降低NBTI等導(dǎo)致的閾值電壓變動給晶體管工作造成的影響,該公司使鎳發(fā)生了硅化反應(yīng),并對其周邊工藝進(jìn)行了改進(jìn)。這樣,鎳便會在硅底板中異常擴(kuò)散,形成結(jié)漏電流源,從而控制晶體管的閾值電壓隨著NBTI等發(fā)生大幅變動的現(xiàn)象。
東芝采用這些方法在SoC上混載了50M~60Mbit左右的SRAM,而關(guān)于DRAM,則采用通過40μm引腳的微焊點(Microbump)使其與SoC芯片層積的方法。東芝已通過部分65nm工藝導(dǎo)入了該方法,今后還打算在40nm工藝上沿用。東芝的親松表示“從DRAM的容量、數(shù)據(jù)傳輸速度及工藝成本等方面來判斷,尖端工藝最好不要在SoC上混載DRAM”.東芝的目標(biāo)是“向客戶提供結(jié)合最尖端的SoC技術(shù)與SiP技術(shù)的模塊”.目前DRAM的最大容量約為512Mbit,東芝計劃今后使1Gbit以上的DRAM與SoC實現(xiàn)芯片層積。






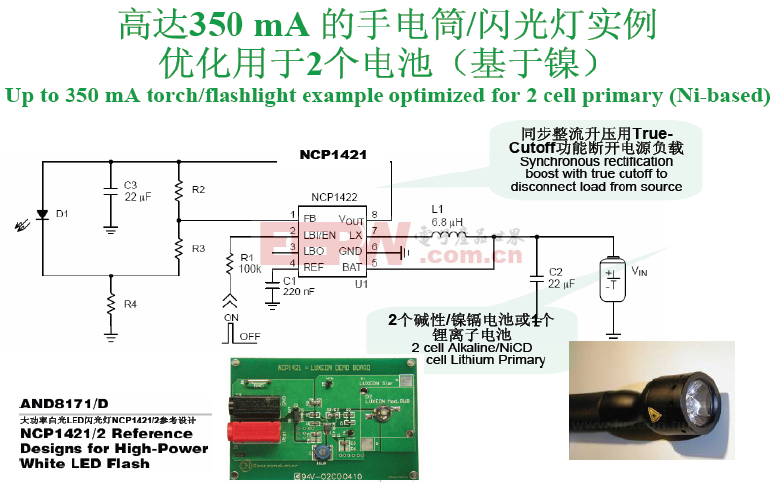
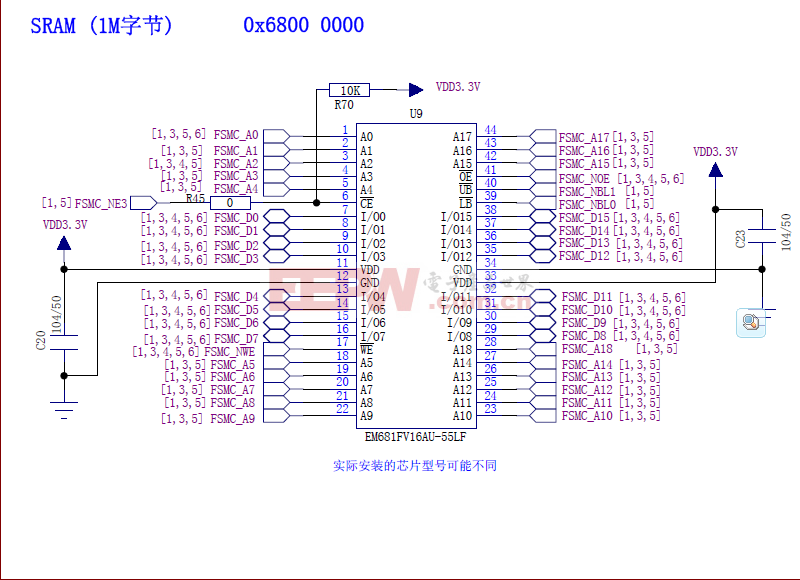


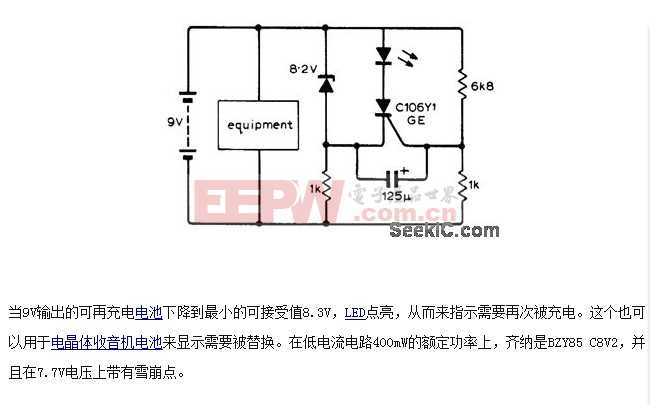


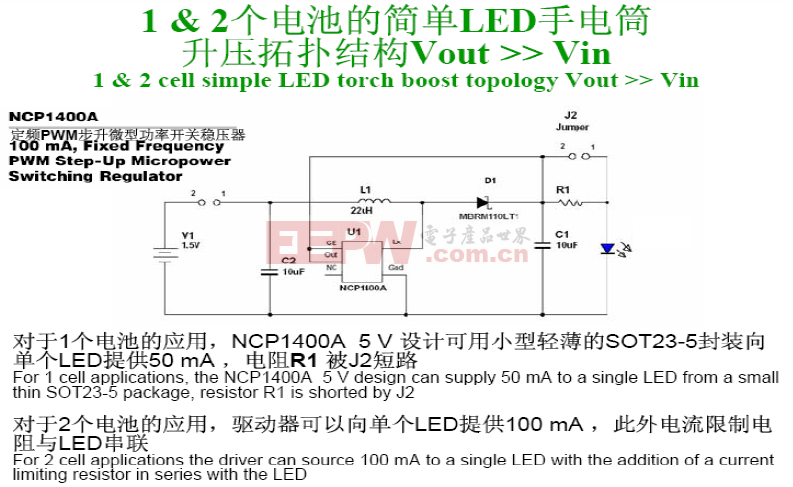

評論