3D IC技術漸到位 業務模式磨合中
采用矽穿孔(TSV)的2.5D或3D IC技術,由于具備更佳的帶寬與功耗優勢,并能以更高整合度突破制程微縮已趨近極限的挑戰,是近年來半導體產業的重要發展方向。在產業界的積極推動下,3D IC已從概念逐漸成為事實,預計將于二至三年后進入量產階段,必將成為未來市場的重要游戲改變者。
本文引用地址:http://www.104case.com/article/142862.htm在日前舉行的Cadence使用者會議(CDN Live)與Semicon Taiwan活動上,包括臺積電、聯電、日月光、Xilinx等大廠都釋出了表示3D IC即將邁入量產的訊息。
其中,積極以自有CoWoS技術搶市的臺積電預計在今年十月就將發布1.0版的設計套件與PDK,試產時程訂于今年第四季,明年第四季可望開始正式投產。臺積電更以今年將是臺積電3D IC制造元年,來宣告此技術已獲得重大進展。
日月光集團總經理暨研發長唐和明則表示,高階產品朝2.5D/3D IC移轉已勢在必行,過去幾年來,此技術在IC設計、晶圓、封測等各領域均有顯著進展,預計量產時程為2014~2015年,應用將逐步興起。
聯電是以Via-middle制程為基礎,從今年初開始進行TSV制程最佳化,預計今年底便可進行產品級的封裝與測試以及可靠性評估。
而已經率先發表2.5D FPGA技術的Xilinx,該公司資深副總湯立人也表示,這款在單一封裝中整合4顆28納米FPGA、總晶體管數高達68億個的元件,預計明年上半年就可正式量產。
從這些一線大廠的動態,我們可以看出,3D IC時代的確即將來臨!
3D IC在行動市場深具潛力
根據市場研究機構Yole Development發布的數據,全球3D TSV芯片市場規模將從2011年的27億美元,到2017年成長至380億美元(不包含2.5D),占整體市場的9%。目前的產值主要是來自低階的CMOS傳感器、MEMS等應用,仍以8寸3D晶圓封裝為主,尚未移轉至12寸。
Yole Development估計,2017年全球3D TSV半導體的封裝和測試市場將達到80億美元,其中約有38億美元是與TSV蝕刻、填充、接線、凸塊、測試等中段制程業務相關。而后段的3DIC模塊測試業務也將會達到46億美元,是封測廠商未來重要的成長契機。
目前,采用2.5D技術的FPGA元件已經朝向商業化,而在美光、三星、海力士等各家廠商的積極推動下,異質存儲器堆疊可望將于服務器和高效能運算(HPC)市場率先導入,Yole Development認為明年將會是3DIC真正大量應用起飛的開始。
3D IC的真正重點在于將存儲器與邏輯IC堆疊在一起,以取得更佳的效能、尺寸、以及功率優勢,這塊領域將是未來五年3DIC市場最重要的推動力量。不過,業界矚目的TSV 28納米行動應用處理器,可能要到2014至2015年才會在wide I/O接口廣泛采用后,而開始有大量應用。
有鑒于行動市場的強勁成長動能,這也是臺積電和三星積極搶奪市場的首要戰場,希望透過整合從前端制造到后端封測的垂直式整合作業方式,以滿足高通、NVIDIA、Broadcom等一線芯片設計業者的需求。
在Semicon Taiwan的3D IC論壇中,有與會來賓透露,三星明年的智能型手機就將搭載采用TSV技術的3D IC,能以其集團的垂直整合優勢,帶來更佳的系統效能表現。
不過,即使技術陸續到位,但目前整體供應鏈還是非常分散,需進一步的整合,同時到底未來何種3DIC的業務模式會勝出,態勢也尚未明朗。產業生態系統還需要一段時間的發展,才會更臻成熟。
業務模式之爭 仍未明朗
看好3DIC市場的發展前景,晶圓廠和封測業者均加碼投入,同時依via-first/via-middle/via-last不同的TSV制程技術,出現了多種不同的業務模式。
像臺積電的CoWoS技術,強調一條龍式的制程,提供從前端到后端的完整服務,而聯電的via-middle技術,則是藉由與封測廠的伙伴關系,共同提供服務。
這兩種模式,就技術、服務效率來看,各有其優缺點。站在無晶圓設計業者的立場,via-last能帶來更佳的供應鏈管理靈活性,不會被單一業者綁住,也能有更多元的方案可選擇。但另一方面,在芯片品管、責任歸屬方面,有可能會造成更多的困擾。
Yole Development則認為,采用「via-middle」模式的存儲器和邏輯IC堆疊將成長最快。
日月光研發中心副總經理洪志斌也指出,以目前的2.5D中間插件(interposer)供應為例,就有晶圓代工、封測廠、結合兩者,以及獨立供應商的不同業務模式。芯片客戶也會在不同的業務模式間移轉,并沒有明確的主流態勢出現。
這些都是產業鏈在朝成熟發展過程中,尚待克服的問題,包括生態系統、合作關系、競爭模式都還在摸索階段。此外,目前3D IC的成本仍高,有賴共通標準、代工廠間互通性的建立,才有可能以更佳的成本效益與效能,推動更廣泛的采用。而在技術成熟度方面,眾所矚目的3D IC異質堆疊在微凸塊/TSV、熱傳、TSV元件應力、3D制程開發套件、芯片間接口、測試等各個領域也都還待解決。
盡管挑戰仍在,但我們看到了3D IC技術的顯著進展,已經從概念成為可行的商業化產品。未來,隨著3D異質堆疊技術的成熟,將能使半導體產業完全打破摩爾定律的制約,反而可以開創出更寬廣的創新應用與技術,這樣的前景的確令人期待。





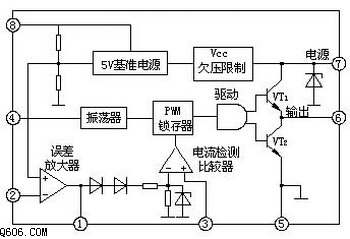


評論