DIGITIMES Research:TSV 3D IC面臨諸多挑戰(zhàn)
2016年將完成多種半導(dǎo)體異質(zhì)整合水平
本文引用地址:http://www.104case.com/article/129295.htmTSV3DIC技術(shù)雖早于2002年由IBM所提出,然而,在前后段IC制造技術(shù)水準(zhǔn)皆尚未成熟情況下,TSV3DIC技術(shù)發(fā)展速度可說是相當(dāng)緩慢,DIGITIMESResearch分析師柴煥欣分析,直至2007年東芝(Toshiba)將鏡頭與CMOSImageSensor以TSV3DIC技術(shù)加以堆棧推出體積更小的鏡頭模塊后,才正式揭開TSV3DIC實(shí)用化的序幕。
于此同時(shí),全球主要芯片制造商制程技術(shù)先后跨入奈米級(jí)制程后,各廠商亦警覺到除微縮制程技術(shù)將面臨物理極限的挑戰(zhàn)外,研發(fā)時(shí)間與研發(fā)成本亦將隨制程技術(shù)的進(jìn)步而上揚(yáng),因此,包括IBM、三星電子(SamsungElectronics)、臺(tái)積電(TSMC)、英特爾(Intel)、爾必達(dá)(Elpida)等芯片制造商皆先后投入TSV3DIC技術(shù)研發(fā)。
至2011年第4季,三星與爾必達(dá)分別推出采TSV3DIC同質(zhì)整合技術(shù)高容量DRAM模塊產(chǎn)品,并已進(jìn)入送樣階段,臺(tái)積電則以28奈米制程采半導(dǎo)體中介層(Interposer)2.5D技術(shù)為賽靈思(Xilinx)制作出新一代現(xiàn)場(chǎng)可程序邏輯門陣列(FieldProgrammableGateArray;FBGA)產(chǎn)品。
然而,柴煥欣說明,各主要投入TSV3DIC半導(dǎo)體大廠除面對(duì)晶圓薄型化、芯片堆棧、散熱處理等相關(guān)技術(shù)層面的問題外,隨TSV3DIC技術(shù)持續(xù)演進(jìn)并逐漸導(dǎo)入實(shí)際制造過程中,前段與后段IC制程皆出現(xiàn)更多隱藏于制造細(xì)節(jié)上的問題。
加上就整體產(chǎn)業(yè)鏈亦存在從材料、設(shè)計(jì),乃至生產(chǎn)程序都尚未訂出共通標(biāo)準(zhǔn),而晶圓代工業(yè)者與封裝測(cè)試業(yè)者亦無法于制程上成功銜接與匯整,都將是造成延誤TSV3DIC技術(shù)發(fā)展與市場(chǎng)快速起飛重要原因。
綜合各主要芯片制造商技術(shù)藍(lán)圖規(guī)畫,2011年TSV3DIC是以同質(zhì)整合的高容量DRAM產(chǎn)品為主,至2014年,除將以多顆DRAM堆棧外,尚會(huì)整合一顆中央處理器或應(yīng)用處理器的異質(zhì)整合產(chǎn)品。柴煥欣也預(yù)估,要至2016年,才有機(jī)會(huì)達(dá)到將DRAM、RF、NANDFlash、CPU等各種不同的半導(dǎo)體組件以TSV3DIC技術(shù)整合于同1顆IC之中異質(zhì)整合水平。







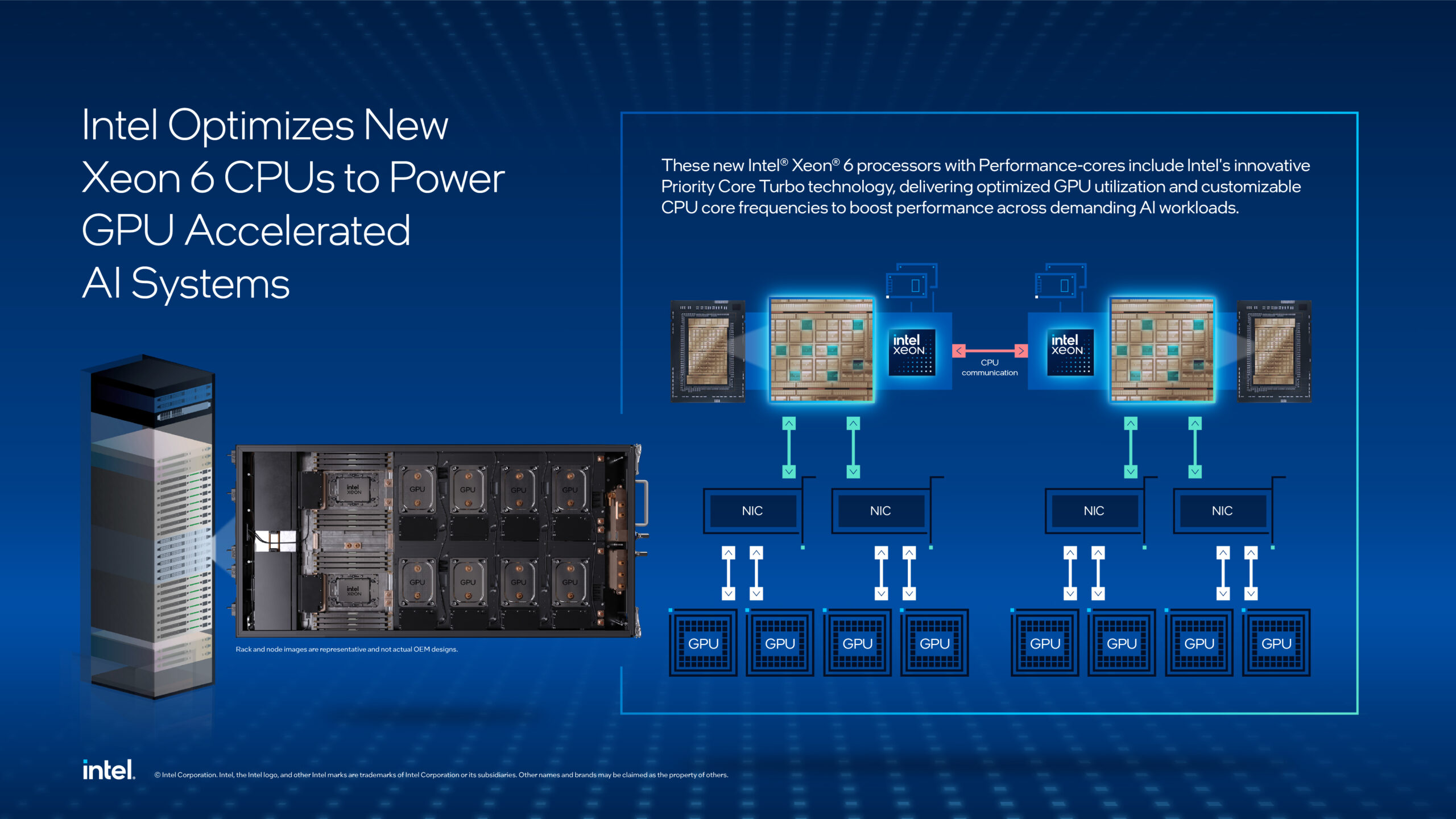









評(píng)論