為與臺積電競爭,三星將推出SANIT 3D先進(jìn)封裝技術(shù)
11月15日消息,隨著半導(dǎo)體制程微縮越來越逼近物理極限,成本也越來越高昂,越來越多的廠商開始轉(zhuǎn)向采用Chiplet的方式,將多個(gè)小芯片通過先進(jìn)封裝技術(shù)整合在一起,形成類似SoC的效果,以提升整體性能,并降低成本。
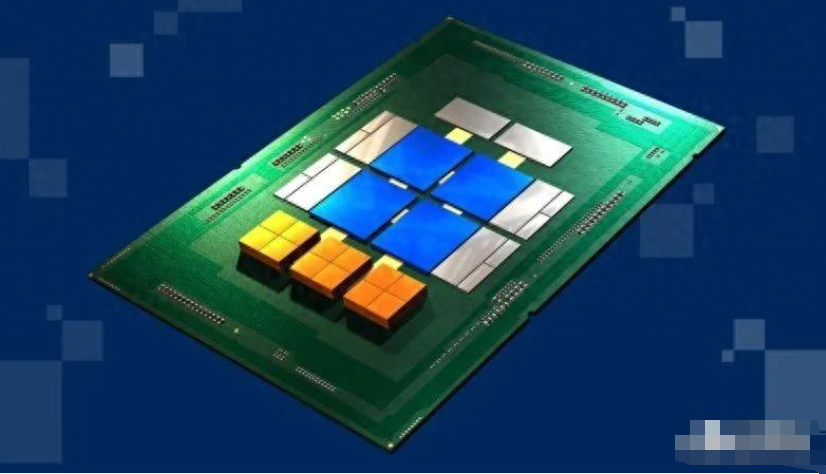
特別是在ChatGPT等生成式AI應(yīng)用的帶動下,市場迫切需要能快速處理大量數(shù)據(jù)的AI芯片,對于先進(jìn)封裝技術(shù)的需求因此也得到了進(jìn)一步爆發(fā)。調(diào)研機(jī)構(gòu)Yole Intelligence數(shù)據(jù)顯示,全球先進(jìn)芯片封裝市場從2022年443億美元成長到2027年660億美元。其中,3D封裝預(yù)計(jì)將占約25%(即150億美元市場規(guī)模)。
在此背景之下,能夠提升半導(dǎo)體性能的先進(jìn)封裝技術(shù)也成為全新的兵家必爭之地。對此,臺積電、三星和英特爾等制造大廠展開了激烈的競爭。目前,率先推出3Dfabric先進(jìn)封裝平臺的臺積電取得絕對領(lǐng)先的地位。為了迎頭趕上,三星計(jì)劃明年推出“SAINT”(Samsung Advanced Interconnection Technology,三星先進(jìn)互連技術(shù))先進(jìn)3D芯片封裝技術(shù),能以更小尺寸的封裝,將AI芯片等高性能芯片、存儲芯片和處理器整合。
三星2021年推出2.5D封裝技術(shù)“H-Cube”后,便一直加速芯片封裝技術(shù)的開發(fā)。今年4月,三星表示提供封裝統(tǒng)包服務(wù)(package turnkey service),處理從芯片生產(chǎn)到封測整個(gè)過程。
知情人士11月12日表示,三星計(jì)劃在明年推出全新的“SANIT”品牌的3D先進(jìn)封裝技術(shù):垂直堆疊SRAM和CPU的“SAINT S”;CPU、GPU等處理器和DRAM內(nèi)存垂直封裝的“SAINT D”、應(yīng)用處理器(AP)堆疊的“SAINT L”。
其中,“SAINT S”等新技術(shù)已通過驗(yàn)證測試。但消息人士指出,三星與客戶完成進(jìn)一步測試后明年推出商用服務(wù),目標(biāo)是通過SAINT新技術(shù),提高數(shù)據(jù)中心AI芯片及內(nèi)置AI功能手機(jī)應(yīng)用處理器的性能。
另外,根據(jù)外媒引用知情人士的消息指出,三星內(nèi)部正考慮將其先進(jìn)的3D封裝技術(shù)應(yīng)用于Exynos系列移動處理器上,有助于進(jìn)一步提高Exynos處理器的整體性能和生產(chǎn)效率,并降低成本,進(jìn)一步增強(qiáng)其產(chǎn)品競爭力。
除了三星之外,臺積電也正在努力擴(kuò)大其2.5D先進(jìn)封裝技術(shù)的(CoWos)的產(chǎn)能,并斥巨資測試和升級其3D芯片間堆疊技術(shù)“SoIC”,以滿足蘋果和英偉達(dá)等客戶需求。臺積電7月表示,投資新臺幣900億元(約29億美元)新建先進(jìn)封裝廠。
至于英特爾,其已經(jīng)開始使用自家新一代3D芯片封裝技術(shù)“Foveros”制造先進(jìn)芯片。另外英特爾最新先進(jìn)的對外開放的封裝服務(wù)也將在2026年進(jìn)入量產(chǎn)。不同于其他家主要提供以硅制程的中介層技術(shù),英特爾計(jì)劃采用更為先進(jìn)的玻璃材質(zhì)基板來替代傳統(tǒng)基板,旨在助力英特爾實(shí)現(xiàn)在2030年前將單一封裝芯片中的晶體管數(shù)量上限提高至1萬億個(gè)的目標(biāo)。
11月初,世界第三大晶圓代工廠聯(lián)華電子(UMC)也推出了晶圓對晶圓(Wafer-to-Wafer,W2W)3D IC項(xiàng)目,利用硅堆疊技術(shù)提供高效整合內(nèi)存和處理器的尖端解決方案。
聯(lián)華電子表示,W2W 3D IC項(xiàng)目雄心勃勃與日月光、華邦、智原科技(Faraday)和益華電腦(Cadence Design Systems)等先進(jìn)封裝廠及服務(wù)公司合作,以便充分利用3D芯片整合技術(shù)滿足邊緣AI應(yīng)用的特定需求。
編輯:芯智訊-浪客劍
*博客內(nèi)容為網(wǎng)友個(gè)人發(fā)布,僅代表博主個(gè)人觀點(diǎn),如有侵權(quán)請聯(lián)系工作人員刪除。



