- 英特爾設計經理Jay Hebb在國際固態(tài)電路會議(ISSCC)宣告系統(tǒng)單芯片(SoC)趨勢‘已死’,因為要整合數位邏輯跟存儲器和類比功能,需要額外的遮罩層(mask layer),這筆成本已拖累了SoC的發(fā)展。Hebb指出,芯片產業(yè)將舍棄SoC,轉向3-D整合技術,跟現在的堆疊套件(stacked package)有點類似。3-D整合并不只是套件(paclage),應該要說是穿過分子結合元素的半導體晶粒(die)。
- 關鍵字:
SiP SoC 封裝 封裝
- 據預計2011年全球消費性電子系統(tǒng)芯片產量,將從2005年的11.1億成長到17.7億,復合年成長率約為6.9%。這反映出消費性IC市場正進入“更加成熟的階段”。視頻處理等技術與應用,對快速擴展的數字功能的支持,視頻合成、人工智能,以及得到改善的功耗與成本效率,將為該領域的成長提供核心動力。消費電子IC將繼續(xù)向著功能整合的方向發(fā)展,在一個單一芯片或平臺上整合多個可程序及固定功能核心。整合度的提高,將有助于改善成本、尺寸和功耗性能,同時保留靈活性并使廠商能夠透過軟件升級來迅速地向市場推出產品。
- 關鍵字:
SiP SoC 封裝 封裝
- 隨著SoC開發(fā)成本的不斷增加,以及在SoC中實現多種功能整合的復雜性,很多無線、消費類電子的IC設計公司和系統(tǒng)公司開始采用“系統(tǒng)級封裝”(SiP)設計以獲得競爭優(yōu)勢。一方面是因為小型化、高性能、多用途產品的技術挑戰(zhàn),另一方面是因為變幻莫測的市場競爭。他們努力地節(jié)約生產成本的每一分錢以及花在設計上的每一個小時。相比SoC,SiP設計在多個方面都提供了明顯的優(yōu)勢。 SiP獨特的優(yōu)勢 SiP的優(yōu)勢不僅在于尺寸方面,SiP能夠在更小的占用空間里提供更多的功能,并降低了開發(fā)成本和縮短了設計周
- 關鍵字:
SiP 封裝 技術簡介 封裝
- 曾理,陳文媛,謝詩文,楊邦朝 (電子科技大學微電子與固體電子學院 成都 610054) 1 引言 數字化及網絡資訊化的發(fā)展,對微電子器件性能和速度的需求越來越高,高階電子系統(tǒng)產品,如服務器及工作站,強調運算速度和穩(wěn)定性,而PC機和筆記本電腦對速度及功能需求也不斷提高,同時,個人電子產品,如便攜式多媒體裝置、數字影像裝置以及個人數字處理器(PDA)等的顯著需求,使得對具有多功能輕便型及高性能電子器件的技術需求越來越迫切。此外,半導體技術已進
- 關鍵字:
SiP SoC 封裝 集成電路 封裝
- 摘 要:近年無線技術應用驚人發(fā)展,使得終端消費產品革新比以往任何一年都要頻繁。 關鍵詞:封裝,SOC,貼片,射頻 中圖分類號:TN305.94 文獻標識碼:D 文章編號:l 004-一4507(2005)05—0045—02 1 封裝技術的挑戰(zhàn) 近年無線技術應用驚人發(fā)展,使得終端消費產品革新比以往任何一年都要頻繁。手機產品的生命周期也變得越來越短了。為了實現這類產品的快速更新,電器技術方面的設計就不得不相應快速的簡化。半導體產業(yè)提
- 關鍵字:
SiP SoC 半導體 封裝 工藝技術 封裝
- SoC 還是 SiP?隨著復雜系統(tǒng)級芯片設計成本的逐步上升,系統(tǒng)級封裝方案變得越來越有吸引力。同時,將更多芯片組合到常規(guī)外形的單個封裝中的新方法也正在成為一種趨勢。
要 點
多裸片封裝是建立在長久以來確立的提高電路密度的原則基礎上的。用90nm工藝開發(fā)單片系統(tǒng)ASIC 的高成本促使人們研究多芯片的替代方案。很多雄心勃勃3D芯片封裝的前兆是用
- 關鍵字:
SiP SoC 封裝 芯片 封裝
- 系統(tǒng)級封裝(SiP)的高速或有效開發(fā)已促使電子產業(yè)鏈中的供應商就系統(tǒng)分割決策進行更廣泛的協作。與以前采用獨立封裝的電子器件不同,今天的封裝承包商與半導體器件制造商必須共同努力定義可行且最為有效的分割方法。因此,需要一個規(guī)范的工程方法來確保這些上游約定能夠在設計早期得以實現,這其中尤其強調預先優(yōu)化SiP設計。只有這樣,才能有效地評估系統(tǒng)選項、權衡基板的廣泛分類與可用工藝、并評估各種選項的性能折衷。 下列幾大因素推動了設計與實現SiP解決方案這一決策。一個最為顯著的原因是S
- 關鍵字:
SiP 分割 封裝 元器件 封裝
- 一、前言 未來幾年內,SiP市場出貨量,或SiP整體市場的營收狀況,雖然增長率都可維持在兩位數的成長,但每年的增長率都會有微幅下滑,主要有以下幾點原因。首先,由于SiP目前的主要應用市場仍集中在手機部分,而全球手機市場幾乎已達飽合的階段,也造成SiP的極高增長率無法持續(xù)維持。其次,SiP的整合特性所造成,由于許多SiP主要應用系統(tǒng)產品持續(xù)往低價方向發(fā)展,使得廠商不斷將芯片封裝整合,比如,2003年手機RF端原本可能具備二個SiP的模塊,每個單價各1.5美元,但2007年手機RF端的SiP模塊可能已經把原本
- 關鍵字:
SiP 封裝 汽車電子 應用 封裝 汽車電子
- 1 為何要開發(fā)3D封裝 迄今為止,在IC芯片領域,SoC(系統(tǒng)級芯片)是最高級的芯片;在IC封裝領域,SiP(系統(tǒng)級封裝)是最高級的封裝。 SiP涵蓋SoC,SoC簡化SiP。SiP有多種定義和解釋,其中一說是多芯片堆疊的3D封裝內系統(tǒng)集成(System-in-3D Package),在芯片的正方向上堆疊兩片以上互連的裸芯片的封裝,SIP是強調封裝內包含了某種系統(tǒng)的功能。3D封裝僅強調在芯片正方向上的多芯片堆疊,如今3D封裝已從芯片堆疊發(fā)展占封裝堆疊,擴大了3D封
- 關鍵字:
3D SiP SoC 封裝 封裝
- 繆彩琴1,翁壽松2 (1.江蘇無錫機電高等職業(yè)技術學校,江蘇 無錫 214028;2.無錫市羅特電子有限公司,江蘇 無錫 214001) 摘 要:本文介紹了SIP和SOC的定義、優(yōu)缺點和相互關系。SIP是當前最先進的IC封裝,MCP和SCSP是實現SIP最有前途的方法。同時還介紹了MCP和SCSP的最新發(fā)展動態(tài)。 關鍵詞:系統(tǒng)級封裝,系統(tǒng)級芯片,多芯片封裝,疊層芯片尺寸封裝 中圖分類號:TN305.94文獻標識碼:A文章
- 關鍵字:
SiP SOC 封裝 技術簡介 封裝
- 集成電路的發(fā)展在一定程度上可概括為一個集成化的過程。近年來發(fā)展迅速的SiP技術利用成熟的封裝工藝集成多種元器件為系統(tǒng),與SoC互補,能夠實現混合集成,設計靈活、周期短、成本低。 多年來,集成化主要表現在器件內CMOS晶體管的數量,比如存儲器。隨著電子設備復雜程度的不斷增加和市場需求的迅速變化,設備制造商面臨的集成難度越來越大,開始采用模塊化的硬件開發(fā),相應地在IC上實現多功能集成的需求開始變得突出。SoC在這個發(fā)展方向上走出了第一步。但受到半導體制造工藝的限制,SoC集成的覆蓋面有固定的范圍。隨著網絡與通
- 關鍵字:
SiP 封裝 技術 系統(tǒng)集成 封裝
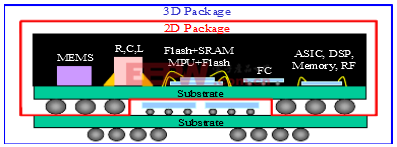
- 電子工程的發(fā)展方向,是由一個「組件」(如IC)的開發(fā),進入到集結「多個組件」(如多個IC組合成系統(tǒng))的階段,再隨著產品效能與輕薄短小的需求帶動下,邁向「整合」的階段。在此發(fā)展方向的引導下,便形成了現今電子產業(yè)上相關的兩大主流:系統(tǒng)單芯片(System?on?Chip;SoC)與系統(tǒng)化封裝(System?in?a?Package;SiP)。 由發(fā)展的精神來看,SoC與SiP是極為相似的;兩者均希望將一個包含邏輯組件、內存組件,甚至包含被動組件的「系統(tǒng)」,整合
- 關鍵字:
SiP 封裝 技術簡介 封裝
- IMS多媒體子系統(tǒng)是是一種由SIP業(yè)務到支持實時的、可定制的多媒體業(yè)務的完整解決方案,支持一個終端同時運行多個SIP Session, 創(chuàng)造全新的數據服務,為未來的全IP網絡搭建統(tǒng)一的基于IP的應用平臺,對運營商網絡帶來積極變革并為開發(fā)新的業(yè)務奠定了基礎。
IMS業(yè)務應用主要分為3種類型,根據采用的不同應用服務器,可分為包括基于SIP AS的業(yè)務應用、基于OSA的業(yè)務應用和基于SSF的業(yè)務應用。
對于OSA應用服務器,用戶可以根據標準的API(如Parlay)在該服務器上進行增值業(yè)務開發(fā)
- 關鍵字:
IMS多媒體 SIP 通訊 網絡 無線
sip-obc介紹
您好,目前還沒有人創(chuàng)建詞條sip-obc!
歡迎您創(chuàng)建該詞條,闡述對sip-obc的理解,并與今后在此搜索sip-obc的朋友們分享。
創(chuàng)建詞條
關于我們 -
廣告服務 -
企業(yè)會員服務 -
網站地圖 -
聯系我們 -
征稿 -
友情鏈接 -
手機EEPW
Copyright ?2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《電子產品世界》雜志社 版權所有 北京東曉國際技術信息咨詢有限公司

京ICP備12027778號-2 北京市公安局備案:1101082052 京公網安備11010802012473