EEPW首頁(yè) >>
主題列表 >>
hyper-na euv
hyper-na euv 文章 最新資訊
半導(dǎo)體產(chǎn)業(yè)中重要一環(huán) EUV光刻最新進(jìn)展如何
- ASML宣稱(chēng)它的Q2收到4臺(tái)EUV訂單,預(yù)期明年EUV發(fā)貨達(dá)10臺(tái)以上。 EUV光刻設(shè)備一再延遲,而最新消息可能在2020年時(shí)能進(jìn)入量產(chǎn),而非常可能應(yīng)用在5nm節(jié)點(diǎn)。 業(yè)界預(yù)測(cè)未來(lái)在1znm的存儲(chǔ)器生產(chǎn)中可能會(huì)有2層或者以上層會(huì)采用它,及在最先進(jìn)制程節(jié)點(diǎn)(7 or 5nm)的邏輯器件生產(chǎn)中可能會(huì)有6-9層會(huì)使用它。 ASML計(jì)劃2018年時(shí)它的EUV設(shè)備的產(chǎn)能再擴(kuò)大一倍達(dá)到年產(chǎn)24臺(tái),每臺(tái)售價(jià)約1億美元,目前芯片制造商己經(jīng)安裝了8臺(tái),正在作各種測(cè)試。 半導(dǎo)體顧問(wèn)公司的分析師Ro
- 關(guān)鍵字: 半導(dǎo)體 EUV
重回摩爾定律兩大武器... EUV+三五族 成大勢(shì)所趨
- 英特爾在14奈米及10奈米制程推進(jìn)出現(xiàn)延遲,已影響到處理器推出時(shí)程,也讓業(yè)界及市場(chǎng)質(zhì)疑:摩爾定律是否已達(dá)極限?不過(guò),英特爾仍積極尋求在7奈米時(shí)代重回摩爾定律的方法,其中兩大武器,分別是被視為重大微影技術(shù)世代交替的極紫外光(EUV),以及開(kāi)始采用包括砷化銦鎵(InGaAs)及磷化銦(InP)等三五族半導(dǎo)體材料。 摩爾定律能否持續(xù)走下去,主要關(guān)鍵在于微影技術(shù)難度愈來(lái)愈高。目前包括英特爾、臺(tái)積電、三星等大廠,主要采用多重曝光(multi-patterning)的浸潤(rùn)式微影(immersionlitho
- 關(guān)鍵字: 摩爾定律 EUV
EUV微影技術(shù)準(zhǔn)備好了嗎?
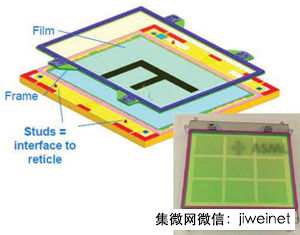
- 又到了超紫外光(EUV)微影技術(shù)的關(guān)鍵時(shí)刻了。縱觀整個(gè)半導(dǎo)體發(fā)展藍(lán)圖,研究人員在日前舉辦的IMEC技術(shù)論壇(ITF)上針對(duì)EUV微影提出了各種大大小小即將出現(xiàn)的挑戰(zhàn)。 到了下一代的10nm節(jié)點(diǎn),降低每電晶體成本將會(huì)變得十分棘手。更具挑戰(zhàn)性的是在7nm節(jié)點(diǎn)時(shí)導(dǎo)入EUV微影。更進(jìn)一步來(lái)看,當(dāng)擴(kuò)展到超越5nm節(jié)點(diǎn)時(shí)可能就需要一種全新的晶片技術(shù)了。 目前最迫在眉睫的是中期挑戰(zhàn)。如果長(zhǎng)久以來(lái)一直延遲的EUV微影系統(tǒng)未能在2017年早期就緒的話(huà),7nm制程將會(huì)成為一個(gè)昂貴的半節(jié)點(diǎn)。 不過(guò),研究人
- 關(guān)鍵字: EUV SanDisk
EUV將在7納米節(jié)點(diǎn)發(fā)威?
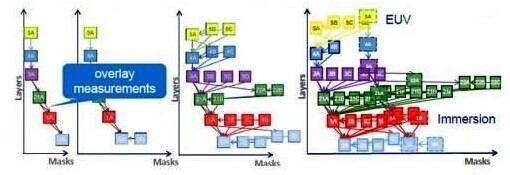
- 核心提示:荷蘭半導(dǎo)體設(shè)備大廠 ASML 現(xiàn)在勉為其難地承認(rèn)了其客戶(hù)私底下悄悄流傳了好一陣子的情況:大多數(shù)半導(dǎo)體廠商仍將采用傳統(tǒng)浸潤(rùn)式微影技術(shù)來(lái)生產(chǎn)10奈米制程晶片,而非延遲許久的超紫外光微影(EUV)技術(shù);不過(guò)這恐怕將使得10奈米節(jié)點(diǎn)因?yàn)闊o(wú)法壓低每電晶體成本,而成為不受歡迎的制程。 荷蘭半導(dǎo)體設(shè)備大廠 ASML 現(xiàn)在勉為其難地承認(rèn)了其客戶(hù)私底下悄悄流傳了好一陣子的情況:大多數(shù)半導(dǎo)體廠商仍將采用傳統(tǒng)浸潤(rùn)式微影技術(shù)來(lái)生產(chǎn)10奈米制程晶片,而非延遲許久的超紫外光微影(EUV)技術(shù);不過(guò)這恐怕將使得
- 關(guān)鍵字: EUV 7納米
KLA-Tencor推出Teron? SL650 光罩檢測(cè)系統(tǒng)

- KLA-Tencor 公司(納斯達(dá)克股票代碼:KLAC)宣布推出 Teron? SL650,該產(chǎn)品是專(zhuān)為集成電路晶圓廠提供的一種新型光罩質(zhì)量控制解決方案,支持 20nm 及更小設(shè)計(jì)節(jié)點(diǎn)。Teron SL650 采用 193nm光源及多種 STARlight? 光學(xué)技術(shù),提供必要的靈敏度和靈活性,以評(píng)估新光罩的質(zhì)量,監(jiān)控光罩退化,并檢測(cè)影響成品率的光罩缺陷,例如在有圖案區(qū)和無(wú)圖案區(qū)的晶體增長(zhǎng)或污染。此外,Teron SL650 擁有業(yè)界領(lǐng)先的產(chǎn)能,可支持更快的生產(chǎn)周期,以滿(mǎn)足檢驗(yàn)
- 關(guān)鍵字: KLA-Tencor SL650 EUV
EUV光刻技術(shù)或助力芯片突破摩爾定律
- 據(jù)美國(guó)科技博客Business Insider報(bào)道,在近50年的科技發(fā)展中,技術(shù)變革的速度一直遵循著摩爾定律。一次又一次的質(zhì)疑聲中,英特爾堅(jiān)定不移地延續(xù)著摩爾定律的魔力。 摩爾定律是由英特爾聯(lián)合創(chuàng)始人GordonMoore提出,內(nèi)容為:當(dāng)價(jià)格不變時(shí),集成電路上可容納的晶體管數(shù)目,約每隔18個(gè)月便會(huì)增加一倍,性能也將提升一倍。換言之,每一美元所能買(mǎi)到的電腦性能,將每隔18個(gè)月翻兩倍以上。這一定律揭示了信息技術(shù)進(jìn)步的速度。 在幾十年來(lái),芯片技術(shù)得以快速變革和發(fā)展,變得更加強(qiáng)大,節(jié)省了更
- 關(guān)鍵字: EUV 摩爾定律
ASML提升新EUV機(jī)臺(tái)技術(shù)生產(chǎn)效率
- 微影設(shè)備大廠ASML積極提升極紫外線(xiàn)(EUV)機(jī)臺(tái)技術(shù)的生產(chǎn)效率,在2012年購(gòu)并光源供應(yīng)商Cymer后,大幅提升光源效率,從2009年至今光源效率分別為2009年2瓦、2010年5瓦、2011年10瓦,2012年提升至20瓦,目前已達(dá)55瓦,每小時(shí)晶圓產(chǎn)出片數(shù)為43片,預(yù)計(jì)2013年底前,可達(dá)到80瓦的目標(biāo),2015年達(dá)250瓦、每小時(shí)產(chǎn)出125片。 半導(dǎo)體生產(chǎn)進(jìn)入10納米后,雖然可采用多重浸潤(rùn)式曝光方式,但在一片晶圓上要進(jìn)行多次的微影制程曝光,將導(dǎo)致生產(chǎn)流程拉長(zhǎng),成本會(huì)大幅墊高,半導(dǎo)體大廠為
- 關(guān)鍵字: ASML EUV
ASML:量產(chǎn)型EUV機(jī)臺(tái)2015年就位
- 極紫外光(EUV)微影技術(shù)將于2015年突破量產(chǎn)瓶頸。傳統(tǒng)浸潤(rùn)式微影技術(shù)在半導(dǎo)體制程邁入1x奈米節(jié)點(diǎn)后將面臨物理極限,遂使EUV成為產(chǎn)業(yè)明日之星。設(shè)備供應(yīng)商艾司摩爾(ASML)已協(xié)同比利時(shí)微電子研究中心(IMEC)和重量級(jí)晶圓廠,合力改良EUV光源功率與晶圓產(chǎn)出速度,預(yù)計(jì)2015年可發(fā)布首款量產(chǎn)型EUV機(jī)臺(tái)。 ASML亞太區(qū)技術(shù)行銷(xiāo)協(xié)理鄭國(guó)偉提到,ASML雖也同步投入E-Beam基礎(chǔ)研究,但目前對(duì)相關(guān)設(shè)備的開(kāi)發(fā)計(jì)劃仍抱持觀望態(tài)度。 ASML亞太區(qū)技術(shù)行銷(xiāo)協(xié)理鄭國(guó)偉表示,ASML于2012年
- 關(guān)鍵字: ASML EUV
全球半導(dǎo)體代工業(yè)正孕育惡戰(zhàn)
- 5月7日消息,全球代工市場(chǎng)規(guī)模繼2011年增長(zhǎng)7%,達(dá)328億美元之后,2012年再度增長(zhǎng)16%,達(dá)到393億美元,預(yù)計(jì)2013年還將有14%的增長(zhǎng)。 臺(tái)積電與英特爾以前是“河水不犯井水”,但是隨著英特爾開(kāi)始接受Altera的14nm FPGA訂單,明顯在與臺(tái)積電搶單,兩大半導(dǎo)體巨頭開(kāi)始出現(xiàn)較為明顯的碰撞。目前,臺(tái)積電已誓言將加速發(fā)展先進(jìn)制程技術(shù),希望在10nm附近全面趕上英特爾。 而另一家代工廠格羅方德近日也發(fā)出聲音,要在兩年內(nèi),在工藝制程方面趕上臺(tái)積電。
- 關(guān)鍵字: 半導(dǎo)體代工 EUV
Intel:14nm進(jìn)展順利 一兩年后量產(chǎn)
- Intel CTO Justin Rattner近日對(duì)外披露說(shuō),Intel 14nm工藝的研發(fā)正在按計(jì)劃順利進(jìn)行,會(huì)在一到兩年內(nèi)投入量產(chǎn)。 2013年底,Intel將完成P1272 14nm CPU、P1273 14nm SoC兩項(xiàng)新工藝的開(kāi)發(fā),并為其投產(chǎn)擴(kuò)大對(duì)俄勒岡州Fab D1X、亞利桑那州Fab 42、愛(ài)爾蘭Fab 24等晶圓廠的投資,因此量產(chǎn)要等到2014年了。 而從2015年開(kāi)始,Intel又會(huì)陸續(xù)進(jìn)入10nm、7nm、5nm等更新工藝節(jié)點(diǎn)。 Rattner指出,Intel
- 關(guān)鍵字: Intel 晶圓 EUV
hyper-na euv介紹
您好,目前還沒(méi)有人創(chuàng)建詞條hyper-na euv!
歡迎您創(chuàng)建該詞條,闡述對(duì)hyper-na euv的理解,并與今后在此搜索hyper-na euv的朋友們分享。 創(chuàng)建詞條
歡迎您創(chuàng)建該詞條,闡述對(duì)hyper-na euv的理解,并與今后在此搜索hyper-na euv的朋友們分享。 創(chuàng)建詞條
關(guān)于我們 -
廣告服務(wù) -
企業(yè)會(huì)員服務(wù) -
網(wǎng)站地圖 -
聯(lián)系我們 -
征稿 -
友情鏈接 -
手機(jī)EEPW
Copyright ?2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《電子產(chǎn)品世界》雜志社 版權(quán)所有 北京東曉國(guó)際技術(shù)信息咨詢(xún)有限公司
 京ICP備12027778號(hào)-2 北京市公安局備案:1101082052 京公網(wǎng)安備11010802012473
京ICP備12027778號(hào)-2 北京市公安局備案:1101082052 京公網(wǎng)安備11010802012473
Copyright ?2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《電子產(chǎn)品世界》雜志社 版權(quán)所有 北京東曉國(guó)際技術(shù)信息咨詢(xún)有限公司