2009年晶圓級封裝趨勢
其他挑戰
本文引用地址:http://www.104case.com/article/92518.htm最近一個新的挑戰給ASE制造了意想不到的困難。當用戶增加芯片的復雜度和密度時,更多的功能部分被封裝進芯片中,且大都使用再分布的方法。“與密度增加同時發生的是,一些引線鍵合焊盤或硅芯片上的焊盤降低到UBM結構之下。因為那里沒有了襯墊效應,而是一個高應力集中區域,因此會降低可靠性。增加密度時焊盤下的通孔會導致這個問題。我們正試圖優化設計——不但在在硅芯片級別上,而且在再分布系統結構上,來調節落到高密度器件焊墊下方的通孔。”
大電流也可能在將來帶來一些挑戰。Hunt表示,有些ASE的終端用戶希望得到比傳統上ASE為便攜式設備提供的大得多的電流。“我們將不得不增加RDL的厚度和UBM結構的性能以及選擇具有最好電遷移性能的合金,”Hunt說“嵌入式閃存和扇出技術中我們需要低溫聚合物。對于扇出技術,當晶圓被埋入塑料框架,塑料框架必須有與硅相似的較低的熱膨脹系數(TCE),現今的材料有低的固化溫度適合做塑料框架。如果你試圖將高固化溫度的聚酰亞胺PBO放到RDL上,它會使輔助晶圓彎曲而無法處理。對于這種情形,我們也需要低固化溫度的材料。這種材料是存在的,只是可靠性卻不如高固化溫度材料。”
可靠性是另一個需要被關注的問題。雖然它一直是一個問題,但過去人們卻最關心溫度循環。“每個人都從標準封裝技術推斷,并且將標準封裝技術的規則應用于晶圓級封裝,但是很明顯,相對于溫度循環性能,手持設備終端用戶對跌落測試性能更感興趣,”Hunt說。“現在我們也看到對于有鍵盤的設備需要增加彎曲測試,按壓時它會使電路彎曲在其中產生應力。彎曲測試和跌落測試是主要因素,但我們不能排除溫度循環測試,而且我們必須使這些高密度、高I/O的產品通過所有這些測試。”




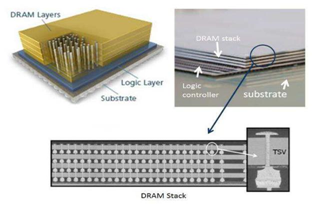



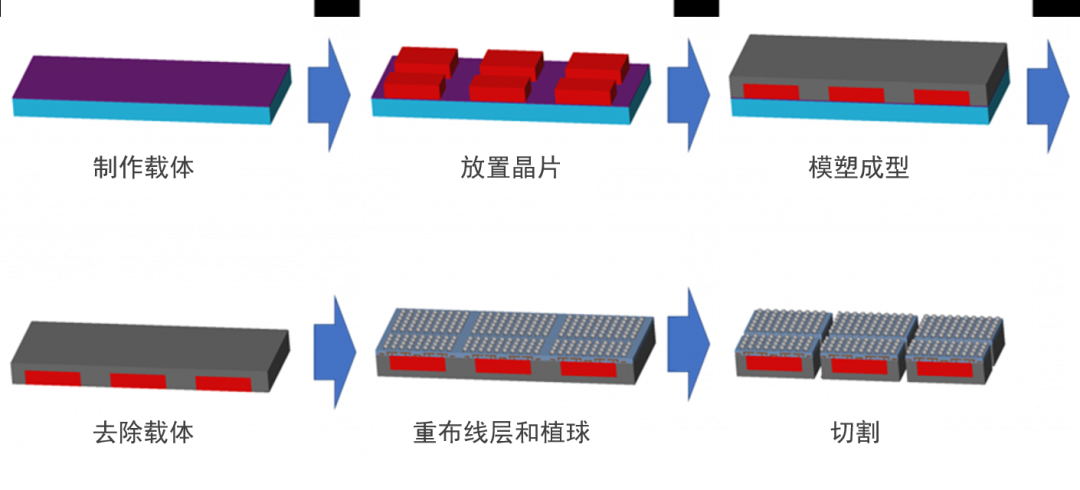
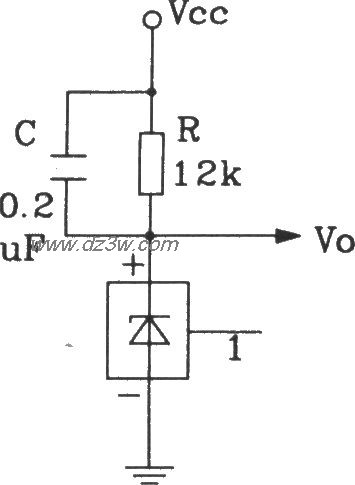
評論