超高去除速率銅CMP研磨劑的開發
實驗
全部實驗均在Mirra Polisher上進行。研究中采用了200mm Cu無圖形晶圓、Cu slug和MIT 854有圖形晶圓。通過測量重量損失和Cu厚度決定去除速率,在Resmap上用4探針測方塊電阻。用電化學技術測定腐蝕響應,在AIT-UIV上測定缺陷率。表面形貌用Veeco AFM輪廓儀測量。CMP進行過程中,為了得到可靠而穩定的工藝,必須考慮多個工藝變量。優化以后,機器參數(如下壓力、工件臺速度、磨頭速度和環境條件等)在整個收集數據的實驗過程中保持不變。研究中選擇的研磨劑是Planar Solutions 的ER9212。ER9212是基于Planar的CSL-904X Cu研磨劑平臺開發的。它有較高的體Cu去除率,同時均勻性和缺陷率好。它是為需要高去除速率的Cu CMP應用(如Cu 3D TSV、Cu MEMS和頂層Cu平坦化等)設計的。表1為該研磨劑的有關特性。
結果和討論
最初觀察酸性平臺研磨劑。由于在酸性條件下Cu氧化速率和溶解速率快,這些研磨劑能以很高去除速率拋光。在測試中,大多數酸性研磨劑有較高的去除速率(圖2),但大部分拋光硅片有表面腐蝕問題。還在CMP過程中觀察到拋光墊的污染問題,這會影響工藝的穩定性,減少拋光墊壽命并增加缺陷率。
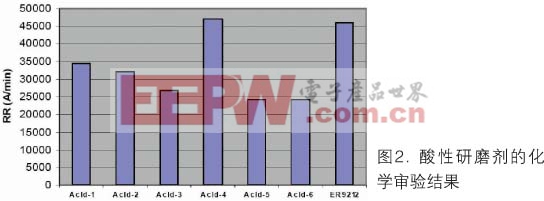
Planar Solutions LLC已成功地將一系列基于中性pH值的CSL904X平臺研磨劑商用化。這些研磨劑典型的體Cu去除速率從8000到11000?/min。對3D應用來說,這樣的速率是不夠的。這些研磨劑含有Cu去除速率增強劑和腐蝕抑制劑。若簡單地增加去除速率增強劑含量,去除速率會上升,但形貌和表面粗糙度也會上升(圖3)。第一次嘗試是用較高的去除增強劑。可以達到3~5μm/min的去除速率,同時溝槽內的全部Cu均在有圖形晶圓拋光過程中溶解了。Cu CMP后的表面粗糙度約為25-30?,這是不能接受的。這說明在CMP過程中產生了強腐蝕。優化研磨劑的化學組成后,得到了性能優異的新品種研磨劑,名為ER9212。實際結果表明,這一組分適用于3D TSV Cu CMP工藝。
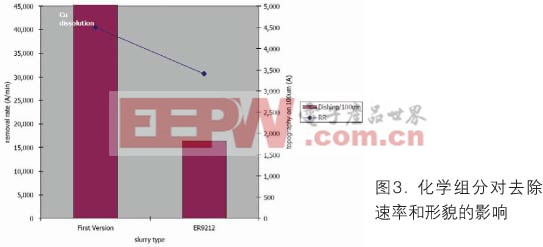






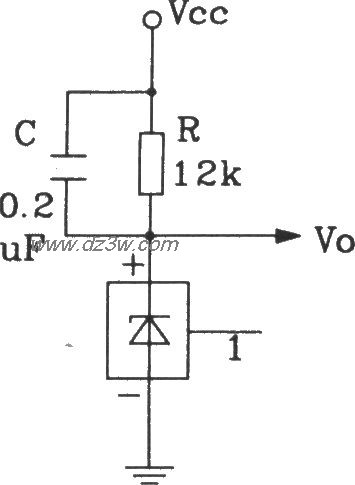


評論