熱阻測試原理與失效分析
摘要:文中通過熱阻的測試原理分析和實際案例,分別從熱阻測試條件、控制限、上芯空洞、傾斜、芯片內阻等幾個方面,全面地闡述對熱阻測試結果的影響,并通過數據統計形成圖表,較為直觀明了,總結出熱阻測試失效的各種可能原因。
關鍵詞:熱阻;功率電流;測量電流;錫層厚度
隨著電子行業的不斷發展,半導體分立器件的功率越來越大,使得產品的耗散功率增大。同時由于成本控制的原因,芯片和成品的尺寸都在不斷的縮小,在一定程度上又限制了產品的散熱。這就造成了產品存測試過程中,經常發生熱阻不良。本文重點閘述了熱阻測試原理和各類失效模式,并結合實際案例進行了詳細的分析。
1 熱阻概念及測試原理
1.1 熱阻概念及作用
熱阻是依據半導體器件PN結在指定電流下兩端的電壓隨溫度變化而變化為測試原理,來測試功率半導體器件的熱穩定性或封裝等的散熱特性,通過給被測功率器件施加指定功率、指定時間PN結兩端的電壓變化(△VBE/△VF/△VGK/△VT/△VDS)作為被測器件的散熱判據。并與指定規范值比較,根據測試結果進行篩選,將散熱性差的產品篩選掉,避免散熱性差的產品在應用過程中,因溫升過高導致失效。各類產品的熱阻名稱見表1。

1.2 熱阻測試原理
熱阻測試儀配有接觸檢測和震蕩探測功能,以防止接觸不良和震蕩造成的溫度測量錯誤,提高了測試儀的穩定性。測試儀提供手動和自動測試,可測量瞬態熱阻,存恒溫槽的配合下,也可測量功率器件的穩態熱阻,通過輸入一個溫度系數到測試儀,也可顯示結點升高的溫度。
下面以NXP雙向可控硅BT137—600產品為例,詳細說明熱阻測試原理。
雙向品閘管需要測試笫一象限△VT1和第三象限△VT3,測試條件相同,如表2所示。

其中,IF:施加功率電流;IG:門極觸發電流;IM:測最電流;PT:施加功率時間;DT:冷卻時間:LOWER LIMIT:規范下限;UPPER
LIMIT:規范上限。
測試電路如圖1所示,測試時序如圖2所示。
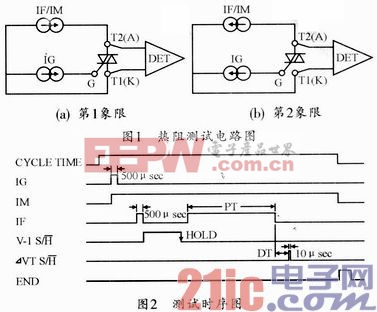
2 熱阻失效分析
2.1 產品截面圖
產品截面如圖3所示。從產品截面圖中,標識的散熱主要方向是從芯片發熱區,經過上芯錫層,再通過框架載芯板/散熱板,散發到測試環境中。





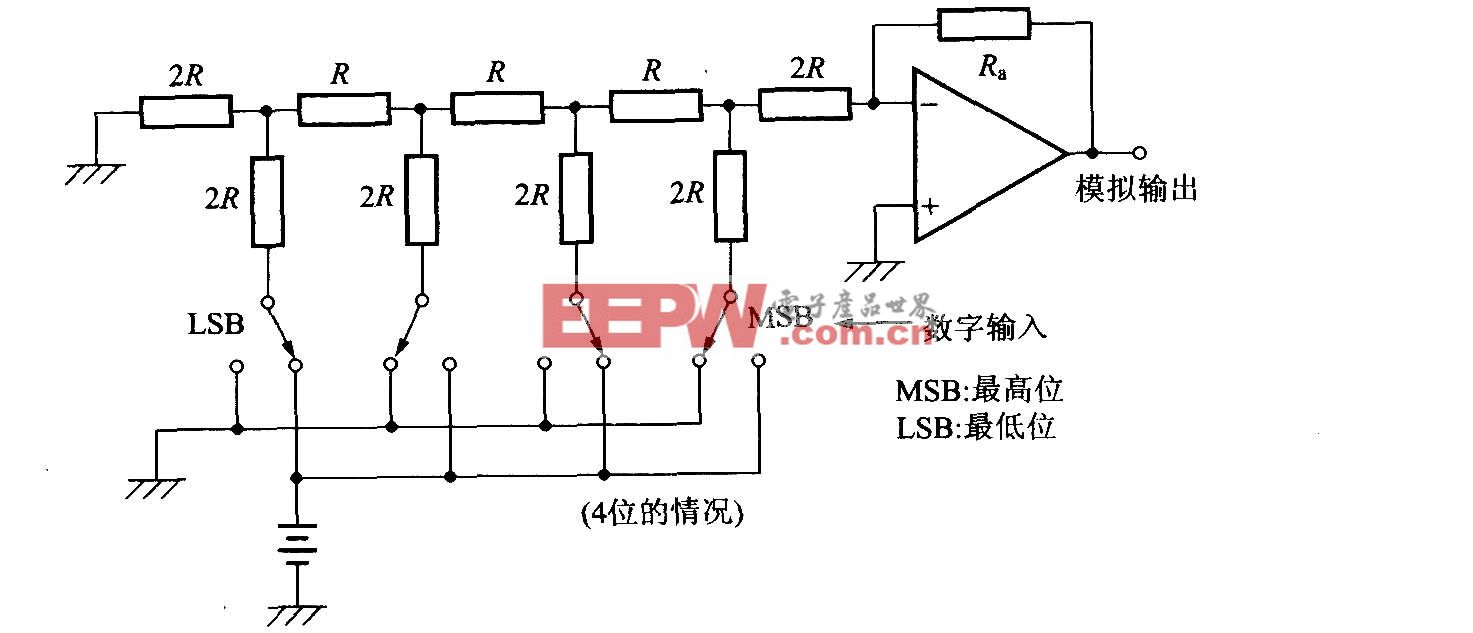




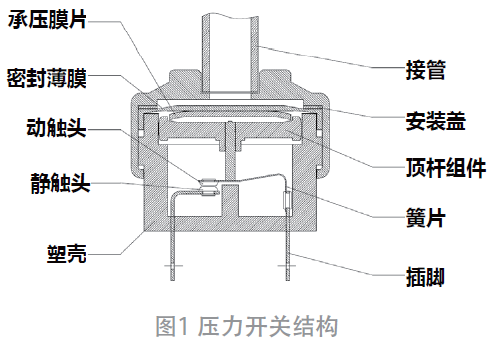


評論