環旭電子發展先進失效分析技術 應對SiP微小化高階產品需求
在5G、消費電子、車載電子和創新智能應用的帶動下,以SiP為代表的新型封裝技術逐漸興起,高可靠性元器件和半導體市場迎來高密度、小型化產品需求的爆發性增長。為滿足這些先進制程、先進材料及先進封裝的應用和發展,環旭電子發展先進電子元器件失效分析技術,應對SiP微小化產品日益復雜和多樣化的需求。
本文引用地址:http://www.104case.com/article/202304/445825.htm失效分析的一般程序分為3個關鍵步驟:失效模式確認、分析失效機理、驗證失效機理和原因,再進一步就是要提出改進措施。失效分析在集成電路產業鏈中發揮的重要性越來越大。為提高失效分析的成功率,必須借助更加先進和精確的設備與技術,并輔以合理的失效分析才能實現。
為了將制程問題降至最低,環旭電子利用高精度3D X-Ray定位異常元件的位置,利用激光去層和重植球技術提取SiP 模組中的主芯片。同時,利用X射線光電子能譜和傅立葉紅外光譜尋找元件表面有機污染物的源頭,持續強化SiP模組失效分析領域分析能力。
X光檢測不會破壞待測物,因此在進行SiP封裝元器件的失效點分析時,X光檢測被視為是一種非常重要的非破壞性檢測技術,除了可以觀察SiP封裝或基板內的缺陷外,還可以檢視各種元器件的內部構造。公司引入高精度納米級3D X-Ray,利用旋轉樣品的方式得到空間中各種不同方位的二維X光斷層影像,配合電腦演算將這些影像組合成三維X光斷層影像。
隨著芯片尺寸和錫球間距越來越小,傳統的化學開蓋直接提取芯片,會對一些芯片的重布線層(RDL)和絕緣層造成傷害。環旭電子研發人員精細研磨芯片背面、鐳射切割芯片四周、用高精度鐳射植球機進行植球、最后交叉驗證芯片性能等方法,解決了在不破壞芯片原始狀態的情況下從SiP模組中完整提取并完成芯片測試的難題。
由于污染氧化、腐蝕、遷移、工藝和環境導致的元器件或芯片表面或微區產生化學成分的變化而導致失效的案例比比皆是,因此微區成分的原位分析非常重要。除了與掃描電子顯微鏡(SEM) 配合使用的能譜分析(EDS) 以外, 環旭電子引入了高靈敏度的分析設備—X射線光電子能譜儀(XPS)和傅立葉紅外光譜儀(FTIR)。其中,XPS可以做元素分析和化學態分析,在離子束濺射的幫助下,可以做元素由表及里的縱向濃度分布分析,分析氧化層或污染層的厚度以及摻雜的濃度分布。FTIR 則主要分析對紅外有吸收的有機材料和半導體材料的組成和含量,帶顯微鏡的紅外光譜可以做微米級別厚度的微區分析,能有效追查有機污染物來源并確定問題根源是來自哪個階段。
環旭電子新產品開發處處長童曉表示:隨著電子新材料、新型元器件的應用和高端芯片、先進封裝工藝的不斷發展, 失效分析技術和能力必須與時俱進。通過研發人員的不斷探究,環旭電子SiP模組失效分析方法從最初的摸索階段逐漸走向成熟,持續精進各類檢測分析技術,對提高產品質量、降低不良品損失發揮了關鍵性作用。




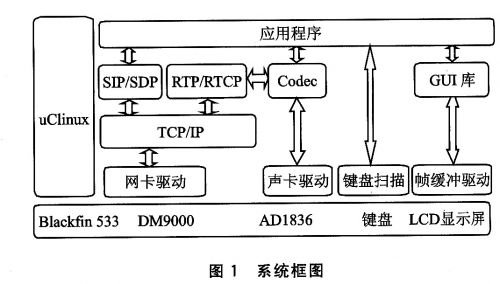


評論