日月光和臺(tái)灣交大合作開發(fā)三維IC封測(cè)技術(shù)
將以最先進(jìn)的三維集成電路(3D IC)封測(cè)技術(shù)為研發(fā)主題,“日月光交大聯(lián)合研發(fā)中心”日前成立,日月光總經(jīng)理暨研發(fā)長(zhǎng)唐和明表示,日月光積極和半導(dǎo)體產(chǎn)業(yè)供應(yīng)鏈進(jìn)行技術(shù)整合,3D IC預(yù)計(jì)2013年導(dǎo)入量產(chǎn),將應(yīng)用在手機(jī)、PC及生醫(yī)等高階產(chǎn)品。
本文引用地址:http://www.104case.com/article/119786.htm日月光交大聯(lián)合研發(fā)中心主任、交大電子工程系教授莊景德表示,3D IC是將芯片立體堆棧化的整合封裝模式,特點(diǎn)在于將不同功能、性質(zhì)的芯片,各自采用最合適的晶圓制程分別制作后,再利用硅穿孔(TSV)技術(shù)進(jìn)行立體堆棧整合封裝。
莊景德指出,3D IC具有封裝微形化、高整合度、高效率、低耗電量及低成本的優(yōu)勢(shì),符合數(shù)字電子產(chǎn)品輕、薄、短、小發(fā)展趨勢(shì)的要求,是下一世代半導(dǎo)體芯片、消費(fèi)性電子產(chǎn)品乃至未來(lái)的生物芯片不可缺乏的技術(shù)。
唐和明也表示,3D IC封裝也會(huì)應(yīng)用到SoC最先進(jìn)的技術(shù),尤其晶圓制造廠從28奈米、20奈米,甚至以下,3D IC和SoC技術(shù)更是相輔相成,系統(tǒng)功能整合透過3D IC,IC的密度、效率會(huì)更高,耗電量更低,符合Green的要求。
唐和明指出,3D IC的技術(shù)難度比目前產(chǎn)業(yè)所知至少高出10倍,除了日月光,交大已有多位教授在3D IC關(guān)鍵技術(shù)研發(fā)多年,雙方結(jié)合后期望將3D IC封測(cè)的關(guān)鍵技術(shù)再加強(qiáng)。日月光更希望國(guó)內(nèi)的半導(dǎo)體產(chǎn)業(yè)供應(yīng)鏈也加入合作,讓3D IC技術(shù)走得更快。
唐和明并表示,日月光強(qiáng)調(diào)對(duì)客戶提供全方位的服務(wù),自行投入研發(fā)全球最先進(jìn)的3D IC封測(cè)技術(shù),目前已經(jīng)有相當(dāng)多的產(chǎn)品進(jìn)入質(zhì)量及可靠度驗(yàn)證中,預(yù)計(jì)2013年開始量產(chǎn)。




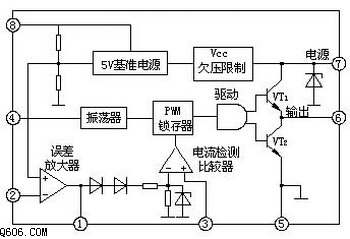



評(píng)論