又是華為!公布“半導體封裝”專利

天眼查顯示,華為技術有限公司“半導體封裝”專利公布,申請公布日為10月31日,申請公布號為CN116982152A。
專利摘要顯示,本公開涉及一種半導體封裝,該半導體封裝包括:第一襯底、半導體芯片、引線框和密封劑。

專利摘要顯示,本公開涉及一種半導體封裝,該半導體封裝包括:第一襯底、半導體芯片、引線框和密封劑。該密封劑的下主面包括在第一平面中延伸的第一部分、在第二平面中延伸的第二部分、在該第一平面與該第二平面之間的第一過渡區中延伸的第三部分,以及在該第二平面與至少一個引線之間的第二過渡區中延伸的第四部分。該密封劑的該第一部分和該第一襯底的下主面在相同的第一平面中延伸,該第一平面形成該封裝的下散熱表面。該密封劑的該第二部分、該第三部分和該第四部分的尺寸被設置為在該密封劑的該第一部分與該至少一個引線之間保持第一預定義最小距離。
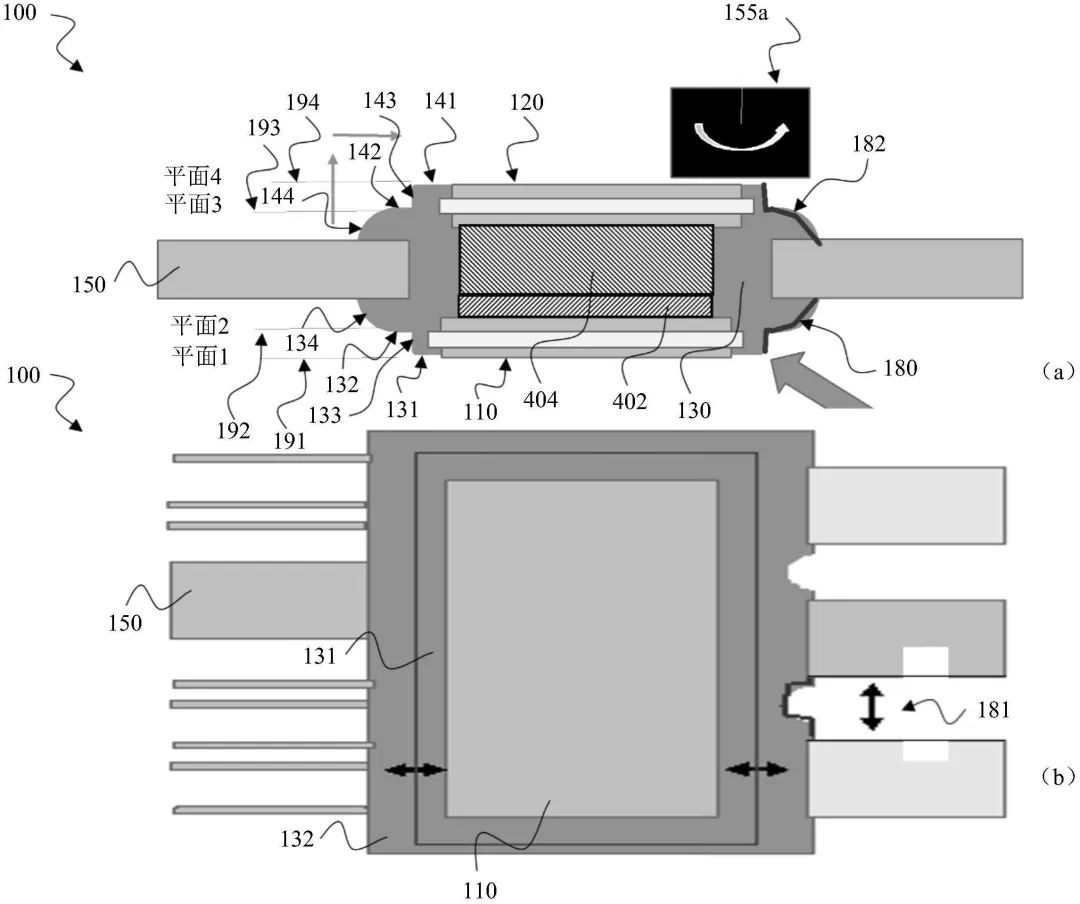
概念解析:
先進封裝是指前沿的倒裝芯片封裝(FC,Flip chip)、晶圓級封裝(WLP,Wafer level packaging)、系統級封裝(SiP, System In a Package)和2.5D、3D封裝等,作為提高連接密度、提高系統集成度與小型化的重要方法。
封裝是指將生產加工后的晶圓進行切割、焊線塑封,使電路與外部器件實現連接,并為半導體產品提供機械保護,使其免受物理、化學等環境因素損失的工藝。先進封裝采用了先進的設計思路和先進的集成工藝,對芯片進行封裝級重構,并且能有效提高系統功能密度的封裝技術。
先進封裝的四要素是指:RDL,TSV,Bump, Wafer,任何一款封裝,如果具備了四要素中的任意一個,都可以稱之為先進封裝。在先進封裝的四要素中,RDL起著XY平面電氣延伸的作用,TSV起著Z軸電氣延伸的作用,Bump起著界面互聯和應力緩沖的作用,Wafer則作為集成電路的載體以及RDL和介質和載體
半導體封裝技術由傳統到先進共經歷了四個發展歷程:通孔插裝時代、表面貼裝時代、面積陣列封裝時代和先進封裝時代,先進封裝技術是延續摩爾定律的最佳選擇,在不提高半導體芯片制程的情況下能夠進一步提高集成度,顯現終端產品輕薄短小等效果。
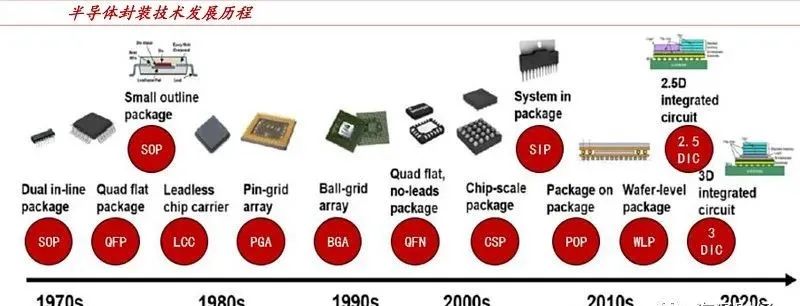
先進封裝發展增大封裝設備需求。先進封裝中,芯片層數增加,芯片厚度需要更加輕薄以減小體積,因此減薄設備需求增加;ChipLET中,芯片變小且數量變多,劃片時需要將晶圓切割為更多小芯片,先進封裝中劃片機需求的數量和精度都會提升;芯片變小且數量提高之后,對固晶機的需求量和精度要求都會提升。
1.Bump (凸塊)工藝與設備
凸塊是定向指生長于芯片表面,與芯片焊盤直接或間接相連的具有金屬導電特性的突起物。凸塊是芯片倒裝必備工藝,是先進封裝的核心技術之一。
1)凸塊可分為金凸塊、銅鎳金凸塊、銅柱凸塊、焊球凸塊
金凸塊主要應用于顯示驅動芯片、傳感器、電子標簽等產品封裝;銅鎳金凸塊主要應用于電源管理等大電流、需低阻抗的芯片封裝;銅柱凸塊主要應用于通用處理器、圖像處理器、存儲器芯片、ASIC、FPGA、電源管理芯片、射頻前端芯片、基帶芯片、功率放大器、汽車電子等產品或領域;錫凸塊主要應用于圖像傳感器、電源管理芯片、高速器件、光電器件等領域。
2)凸塊工藝所需設備各不相同
金/銅凸塊工藝:
1)采用濺射或其他物理氣相沉積的方式再晶圓表面沉積一層 Ti/Cu 等金屬作為電鍍的種子層;
2)在晶圓表面涂一定厚度的光刻膠,并運用光刻曝光工藝形成所需要圖形;
3)對晶圓進行電鍍,通過控制電鍍電流大小、電鍍時間等,從光刻膠開窗圖形底部生長并得到一定厚度的金屬層;
4)去除多余光刻膠。
錫凸塊工藝 :
與銅柱凸塊流程相似,凸塊結構主要由銅焊盤和錫帽構成,差別主要在于焊盤的高度較低,同時錫帽合金是成品錫球通過鋼板印刷,在助焊劑以及氮氣環境下高溫熔融回流與銅焊盤形成的整體產物。錫凸塊一般是銅柱凸塊尺寸的 3~5 倍,球體較大,可焊性更強。
銅鎳金凸塊工藝:
采用晶圓凸塊的基本制造流程,電鍍厚度超過 10μm以上的銅鎳金凸塊。新凸塊替代了芯片的部分線路結構,優化了 I/O 設計,大幅降低了導通電阻。
2.TSV (硅通孔)工藝與設備
TSV (Through Silicon Via)即硅通孔技術,是一種利用垂直硅通孔實現芯片互連的方法,相比于傳統引線連接,具有更短的連接距離、更高的機械強度、更薄的芯片厚度、更高的封裝密度,同時還可以實現異種芯片的互連。
TSV 的制作工藝流程為在硅片上刻蝕通孔,側壁沉積金屬粘附層、阻擋層和種子層,TSV 通孔中電鍍銅金屬作為導體,使用化學機械拋光(CMP)將硅片減薄,最后疊層鍵合。
3.RDL(再布線)工藝與設備
RDL (ReDistribution Layer,重布線層是實現芯片水平方向互連的關鍵技術,可將芯片上原來設計的 I/O 焊盤位臵通過晶圓級金屬布線工藝變換位臵和排列,形成新的互連結構。
RDL 需要的設備包括曝光設備、PVD 設備等。RDL 的工藝流程:1)形成鈍化絕緣層并開口;2)沉積粘附層和種子層;3)光刻顯影形成線路圖案并電鍍填充;4)去除光刻膠并刻蝕粘附層和種子層;5)重復上述步驟進行下一層的 RDL 布線。
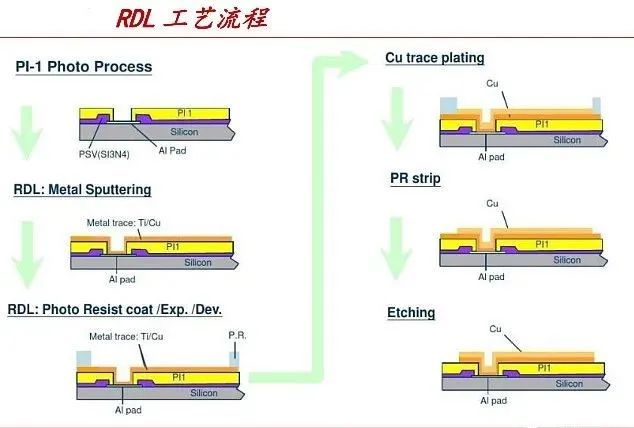
華為封裝新專利對麒麟的解決方案
對于麒麟9000s的量產,國內和國外從發售之日起,便不停的研究,最終也沒得出什么結果。但拆機結果有兩點:
第一,麒麟9000s比麒麟9000大了一圈
第二,麒麟9000s散熱方面做了特殊結構
這兩點與華為這份封裝專利不謀而合,尤其是散熱方面,專利里有詳細介紹與解決方案。
這份專利較為新穎,相較于其他工藝,絕緣、散熱、引線增量較多。
當前國內龍頭封測廠商均有50%以上收入來自先進封裝業務,在先進封裝技術實現持續突破:
*博客內容為網友個人發布,僅代表博主個人觀點,如有侵權請聯系工作人員刪除。