長電科技Chiplet超大尺寸高密度扇出型倒裝封裝取得重大突破
5月5日,全球領(lǐng)先的集成電路制造和技術(shù)服務(wù)提供商長電科技宣布,公司Chiplet技術(shù)取得重大突破,超大尺寸高密度扇出型倒裝技術(shù)實現(xiàn)業(yè)界領(lǐng)先的多元異構(gòu)芯片倒裝的102mm x 102mm超高密度封裝集成,可廣泛應(yīng)用于高性能計算芯片等高附加值領(lǐng)域。
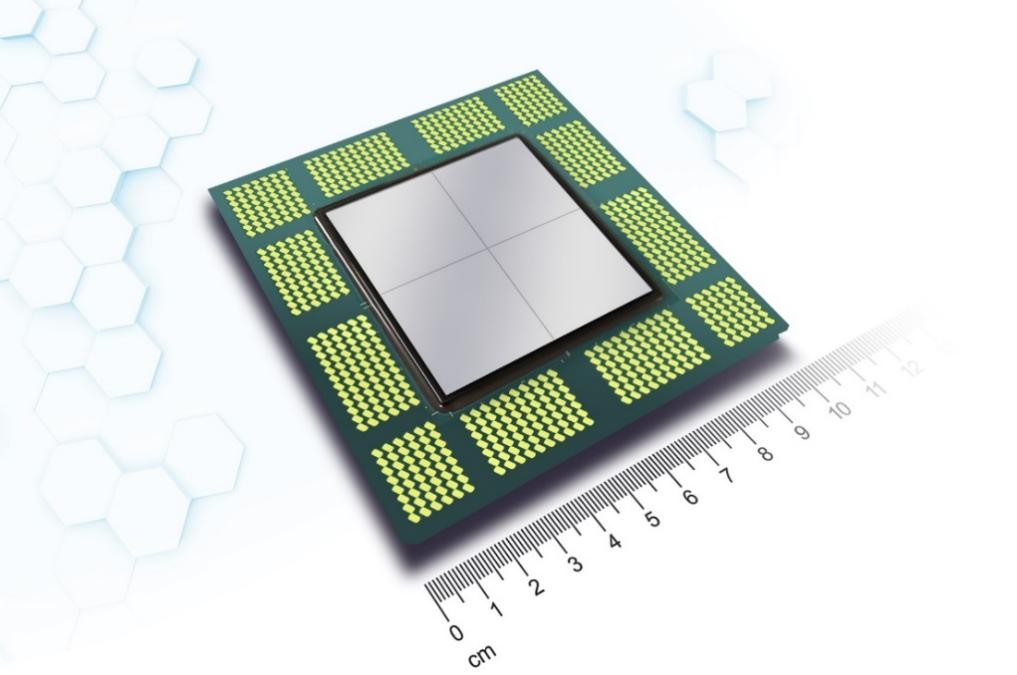
圖注:長電科技Chiplet超大尺寸高密度扇出型倒裝封裝,實現(xiàn)整體封裝尺寸超過10000平方毫米的技術(shù)突破 (示意圖)
當(dāng)前,人工智能、5G通訊、云計算等高速運(yùn)算和互聯(lián)等應(yīng)用,對芯片性能提出越來越高的要求,同時推動芯片封裝技術(shù)在大尺寸封裝中提供具有高功率完整性、優(yōu)異的熱性能和更高抗電遷移性(EM)的經(jīng)濟(jì)高效、可擴(kuò)展的封裝解決方案。
長電科技通過持續(xù)的技術(shù)研發(fā)與客戶產(chǎn)品驗證,采用XDFOI Chiplet高密度多維異構(gòu)集成技術(shù),結(jié)合超大fcLGA(flip-chip Land Grid Array)封裝工藝,將超大尺寸的高密度扇出型封裝單元直接倒裝在fcLGA基板,實現(xiàn)了整體封裝尺寸超過10000平方毫米,扇出單元尺寸超過3600平方毫米的技術(shù)突破。同時,長電科技不斷優(yōu)化超大尺寸高密度扇出型集成封裝技術(shù),包括工藝的輔助治具、設(shè)備升級、扇出結(jié)構(gòu)翹曲控制、雙面被動器件貼裝工藝等,并開發(fā)了多元化的散熱片粘結(jié)材料和散熱界面材料,以滿足芯片可靠性的要求,相關(guān)工藝達(dá)到業(yè)內(nèi)領(lǐng)先水平。
目前,長電科技超大尺寸高密度扇出型集成封裝技術(shù)可提供從設(shè)計到生產(chǎn)的全套交鑰匙服務(wù),助力客戶顯著提升芯片系統(tǒng)集成度,為高性能計算應(yīng)用提供卓越的微系統(tǒng)集成解決方案。在實現(xiàn)超大尺寸封裝技術(shù)的同時,長電科技還在前期專利布局的基礎(chǔ)上,與客戶共同開發(fā)了基于高密度扇出封裝技術(shù)的2.5D fcBGA產(chǎn)品,同時認(rèn)證通過TSV 異質(zhì)鍵合3D SoC的fcBGA。
作為集成電路成品制造領(lǐng)軍企業(yè),長電科技已在晶圓級扇出型封裝技術(shù)領(lǐng)域積累了十余年的量產(chǎn)實踐經(jīng)驗,公司XDFOI Chiplet高密度多維異構(gòu)集成系列工藝已進(jìn)入穩(wěn)定量產(chǎn)階段,同步實現(xiàn)4nm節(jié)點(diǎn)多芯片系統(tǒng)集成封裝產(chǎn)品出貨。未來,長電科技將根據(jù)客戶基于互聯(lián)密度和成本的要求,繼續(xù)投入Chiplet小芯片多樣化解決方案的開發(fā),持續(xù)為客戶提供更加高效、靈活的芯片系統(tǒng)集成解決方案。
-完-
*博客內(nèi)容為網(wǎng)友個人發(fā)布,僅代表博主個人觀點(diǎn),如有侵權(quán)請聯(lián)系工作人員刪除。