KLA-Tencor 發布最新存儲和邏輯器件明場檢測系統
KLA-Tencor 推出 28xx 明場檢測平臺的最新成員 2810 和 2815。通過特殊的光學配置,它們能有效地應對亞 55 納米存儲器件和亞 45 納米邏輯器件生產中所面臨的獨特缺陷檢測挑戰。無論是適合存儲器件缺陷檢測的 2810 系統,還是適合邏輯器件檢測的 2815 系統,都依靠 KLA-Tencor 業界領先的全光譜光源技術以捕獲最廣泛的缺陷類型,包括嚴重影響成品率的沉浸光刻缺陷。與以往的 2800 系統相比,在同等靈敏度條件下,新系統可在多種應用中實現兩倍以上的生產能力。
“在 55 納米/45 納米節點上,存儲和邏輯芯片的檢測需求變得非常突出。對于這兩種器件,芯片生產商均需要在加快新工藝成熟的同時以更高的檢測靈敏度來捕獲所關注的全部缺陷。”KLA-Tencor 晶片檢測事業群副總裁 Mike Kirk 指出。“通過采用我們的新型 2810 和 2815 專業明場檢測工具,存儲和邏輯芯片生產商能夠將檢測策略集中在先進器件中所發現的影響成品率的缺陷類型。2810 和 2815 系統具備在各關鍵工藝層上發現所關注全部缺陷的靈敏度和靈活性,同時還實現了計算速度的倍增,因而能夠加快成品率成熟和上市時間。”
2815 系統引入廣泛的硬件和算法工具集,可有效地捕獲邏輯設計中的相關缺陷。該系統具備采用業界最小像點的特殊光學模式,依據設計可捕獲亞 45 納米節點邏輯器件的復雜幾何結構和新型材料上的最廣泛的缺陷類型。對于亞 55 納米的存儲器件應用,新型 2810 檢測系統具有相應的光學模式和算法,可捕獲橋接、空洞以及在陣列(重復)與外圍(非重復)結構上的其他重要缺陷。
由于捕獲全部關鍵性缺陷所需的最佳檢測波長隨材料、圖形幾何特征以及設計節點的不同而變化,因此 281x 系列工具采用可調全光譜光源,覆蓋 DUV、UV 和可見光波長范圍。這一技術能夠提供最優的缺陷對比、超凡的噪聲抑制和高分辨率,可有效滿足不斷擴展的工藝層、器件和設計節點范圍中關鍵性缺陷檢測的要求。2810 和 2815 系統還提供一些新的易用特性,可將菜單優化時間縮短約 50%。此外,281x 系統在自動缺陷分類方面的改進,可進一步提高缺陷 Pareto 圖的質量,從而能加速識別和解決缺陷問題的根源。
KLA-Tencor 2810/2815 系統構建在 2005 年推出的并已穩居市場領先地位的 2800 平臺之上。新系統現已向所有芯片生產地區的客戶供貨,并在存儲和邏輯器件應用中得以安裝使用。許多客戶已經依靠該系統的先進全光譜光源技術來管理沉浸光刻工藝中的缺陷。












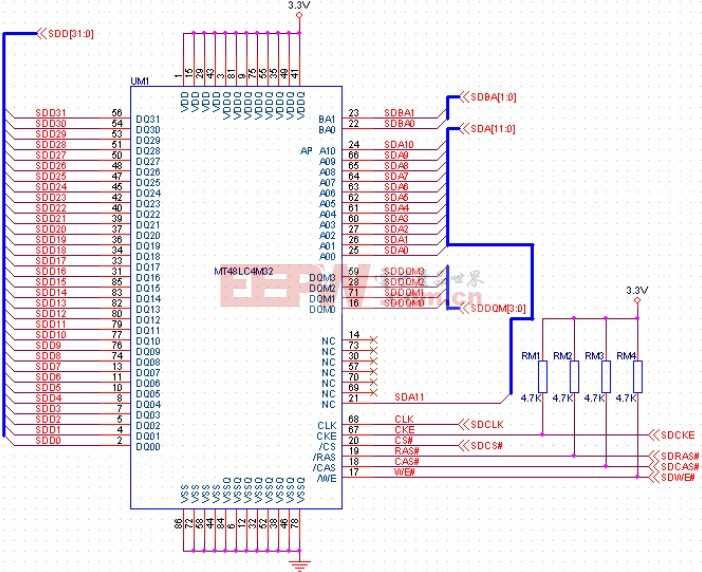
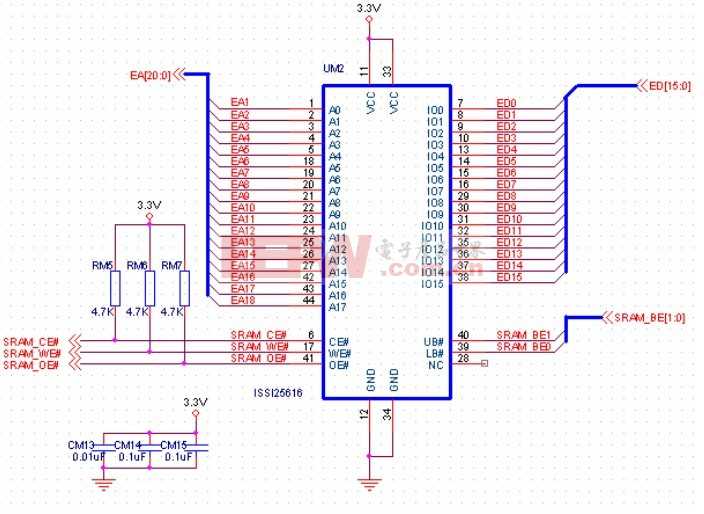
評論