蘋果發布“合二為一”芯片,華為公布“芯片疊加”的專利
昨日凌晨的蘋果春季發布會上,蘋果發布了最強的 “M1 Ultra”芯片。
本文引用地址:http://www.104case.com/article/202203/432003.htm在大會上,蘋果公布了 M1 Ultra 芯片很多牛逼的參數,比如:晶體管數量1140億顆;20核CPU(16 個高性能內核和 4 個高效內核);最高64核GPU;32核神經網絡引擎;2.5TB/s數據傳輸速率;800GB/s內存帶寬;最高128GB統一內存。

M1 Ultra 是 Apple 芯片的又一個游戲規則改變者,它將再次震撼 PC 行業。通過將兩個M1 Max 芯片與我們的 UltraFusion 封裝架構相連接,我們能夠將 Apple 芯片擴展到前所未有的新高度。
蘋果公司硬件技術高級副總裁Johny Srouji表示:“憑借其強大的CPU、龐大的 GPU、令人難以置信的神經引擎、ProRes 硬件加速和海量統一內存,M1 Ultra 完善了M1系列,成為世界上最強大、功能最強大的個人計算機芯片。”
眾所周知,要做更強大的芯片,就需要堆更多的電路,更多的晶體管,而工藝越先進,同樣的面積就能塞進去更多晶體管,芯片性能上限就越高,這也是為何大家追求更先進制程的原因之一。
但在當下的工藝技術條件下,晶體管多了,良率就會降低,良率低了,那每個芯片就會變得非常昂貴,那么如何才能在降低成本的前提下,做出超越極限的芯片呢?
蘋果的做法是采用M1 Max中隱藏的芯片互連模塊,通過UltraFushion架構把兩塊芯片像拼拼圖一樣“合二為一”。
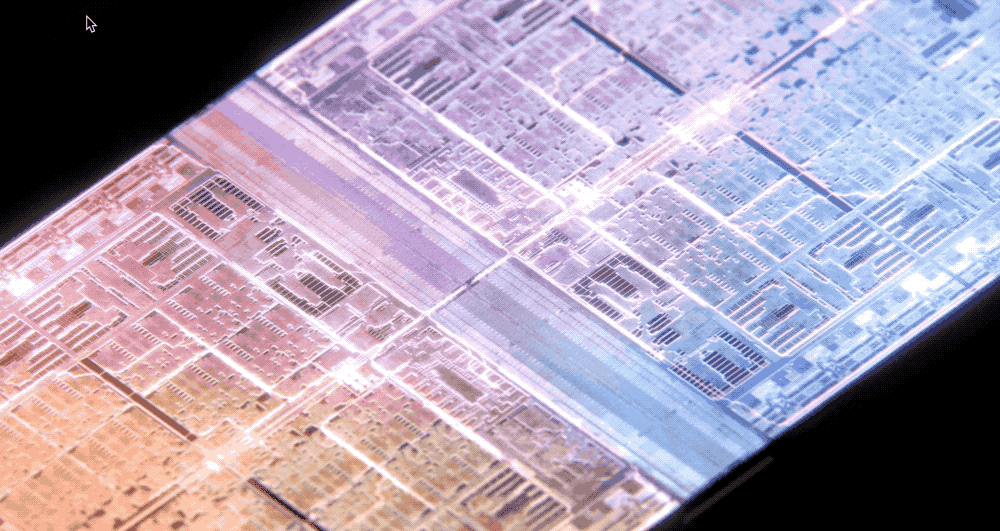
蘋果的“UltraFushion”其實就是Die to Die Connection,就是在芯片設計時在同一個封裝(package)里面使用多枚硅片(silicon),并且在其中設計極其高速的互聯通道,使得這兩塊硅片可以形同一塊芯片一樣共同工作。
UltraFusion使用了1萬條DTD連接,提供了高達2.5TB/s的互聯速度,它的帶寬極高、能耗極低,而且由于是數塊die共同封裝,其對良率的敏感度要遠低于一塊超巨型芯片,因此DTD也被認為是未來芯片性能發展的一條具有巨大潛力的道路。

值得一提的是,M1 Max是一個基于小芯片(Chiplet)的設計中將多個芯片堆疊在一起的芯片模塊(MCM),其2-tile的規格使其從CPU到GPU到NPU到內存帶寬到內存容量,全部都是2xM1 Max的規格。
當然這條道路也不是只有蘋果在走,AMD 早在 2017 年就引入了MCM 并且在 2019 年引入了Chiplet 設計,未來的發展趨勢是進一步提升堆疊能力,實現所謂的 3D 堆疊,也就是不僅在 2D 上擴展,還要在垂直方向上擴展。

而國內企業有同樣思路的就是華為海思了。在2021年5月份的時候,華為將“雙芯疊加”的專利進行了公開,并表示14nm技術可以到達7nm的性能,此消息一出頓時在世界范圍內引起熱議,得到全球的關注。簡單來講14nm與7nm之間,它們的主要差別就是在芯片面積相同的情況下,7nm可以擁有更多的晶體管數量,在性能方面自然也會有所提升。
知乎用戶@超合金彩虹糖表示,這顆M1Ultra是蘋果野心的進一步延續,連最有錢的蘋果也轉向Chiplet了,這預示著也許未來在消費級領域,高性能產品走Chiplet這條路可以走得通。目前來看,芯片組合疊加已經從理論變成現實,從芯片封裝的角度來看,逐漸從2.5D封裝走向3D封裝,芯粒(Chiplet) 將提供最佳性能和最大靈活性。臺積電、英特爾、三星、AMD等十家公司已經行動了,聯合創建UCIe聯盟。(詳情:英特爾、AMD、Arm等九大企業宣布UCle開放標準,推動Chiplet發展)
UCIe聯盟創建的初衷是將小芯片打造成開放,互聯的產業發展生態,讓不同客戶也能通過各類小芯片產品滿足更多的需求。
未來,以Chiplet模式集成的芯片會是一個“超級”異構系統,可以帶來更多的靈活性和新的機會。
芯原股份創始人、董事長兼總裁戴偉民曾表示,對于產業來說,Chiplet帶來了新的機會,在標準與生態層次上,Chiplet建立了新的可互操作的組件、互連協議和軟件生態系統;對于芯片制造與封裝來說,增設了多芯片模塊 (Multi-Chip Module,MCM) 業務,Chiplet迭代周期遠低于ASIC,可提升晶圓廠和封裝廠的產線利用率;對于半導體IP來說,升級為Chiplet供應商,可提升IP的價值且有效降低芯片客戶的設計成本;最后對于芯片設計來說,降低了大規模芯片設計的門檻。
戴偉民建議國內企業持續推進Chiplet量產和2.5D/3D封測技術開發。













評論