多芯片封裝新突破 Invensas推出xFD技術
隨著內存容量的不斷增大,單條內存上如何集成更多的顆粒成了問題,在容量要求更高的服務器和數據中心領域這一問題愈發嚴重。在日前舉行的高質量電子設計國際研討會(ISQED)上,Invensas半導體提出了一種名為xFD的新型內存封裝技術試圖解決這個問題。
本文引用地址:http://www.104case.com/article/201609/304518.htmxFD全稱為multi Face Down,是一種新的多芯片封裝技術,Invensas副總兼CTO Richard Crisp在會上宣布,xFD具有體積小、性能高、成本低等優勢。
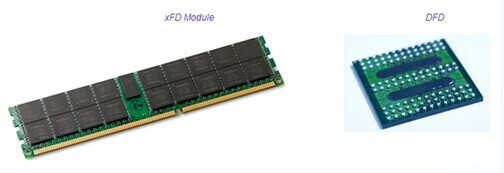
▲xFD封裝的芯片
xFD封裝的芯片占地面積只有傳統封裝的一半,因此xFD的厚度減少了30%。此外,由于采用了超短的獨立連接,多芯片封裝的性能與單芯片相當,性能有保證,而xFD封裝所用的材料成本更低,對工廠來世也可以節約開支。
xFD只是個統稱,典型的產品配置主要有以下兩種:

▲xFD技術
DFD™:Dual Face Down,單個封裝內有兩顆芯片,可以是x4、x8或者x16配置,其中x4及x8配的體積為11.5x11.5mm,104 BGA封裝,x16配置的體積為11.5x14mm,136 BGA封裝。
QFD™:Quad Face Down,每個封裝內有四顆芯片,x8或者x16配置,容量更高,體積增大為16.2x16.2mm,256 BGA封裝。
Invensas表示已經和內存廠商達成交易準備將xFD用在主流市場上,不過他們也沒有說明具體什么時候和那些廠商會推出xFD內存,目前只知道去年10月份Nanium和他們達成了交易。不過這項技術主要應用在對容量要求較高的服務器市場,民用DDR3內存的主流是單條2GB以及4GB,單條8GB還稀少的很,估計很長一段時間內都用不到xFD封裝。



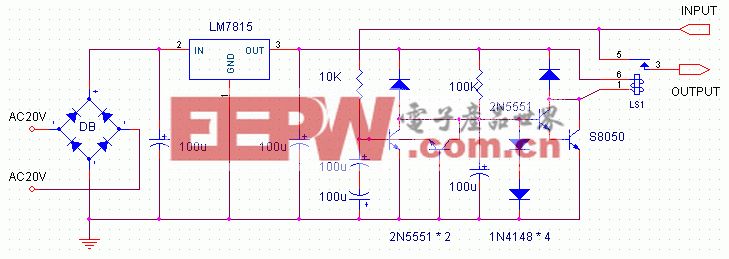





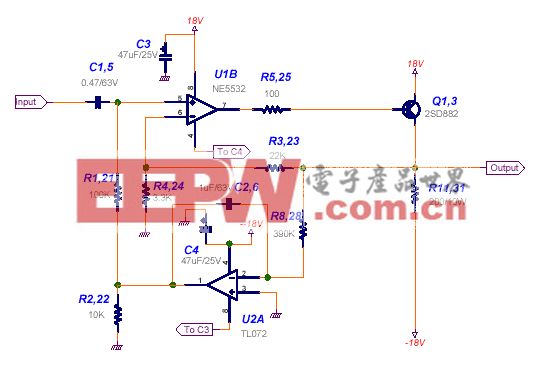

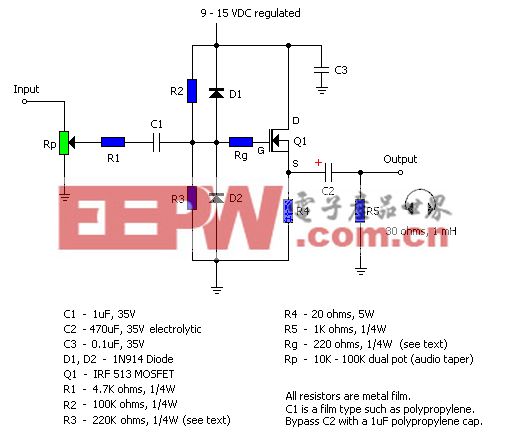
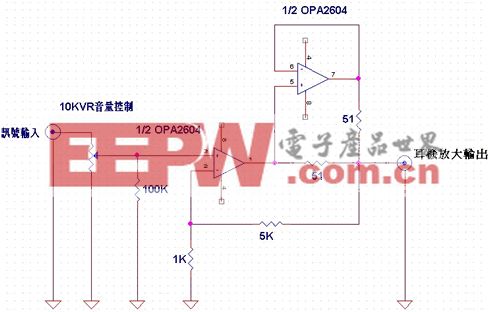
評論