無向量測試是測試高速I/O的最佳方法
大批量半導體芯片制造商必須解決以下這道難題,即如何經濟高效地測試嵌入在大型數字系統級芯片設計中的多個多通道高速I/O接口(如PCI Express、HyperTransport和 Infiniband)。雖然結合了閉環操作的片上內置自測試(BIST)被廣泛地用來替代昂貴的自動測試設備(ATE),但它仍具有高速模擬部分缺陷覆蓋率不高的不足,而這將嚴重影響整體產品的質量。
本文引用地址:http://www.104case.com/article/193876.htm現在,出現了一種新興的被稱為“無向量測試”的方法,它同時擁有BIST和ATE兩種方法的優勢:即片上I/O BIST的經濟高效性和基于ATE的信號完整性測量。特別是,該理念將ATE參數測試與片上測試內容生成和比較結合起來,從而形成了硅芯片與ATE設備之 間的良好協同,其結果是產生了一種嵌入在硅芯片中的可用于大批量制造測試的經濟型優化解決方案。
傳統的ATE架構由提供測試源向量的ATE和處理任務模式測試的線速向量組成。隨著速率持續增加到超過每秒千兆位的門限,特別是對于高速I/O接口,在ATE上提供這一能力的成本在大批量制造環境中變得極具挑戰性。
為了將對ATE測試的依賴性減到最小,很多芯片制造商正在使用片上BIST結構與閉環模式的組合。由于今天的硅工藝已達到很高的集成度,因此在硅片上適當占用一些面積是完全可以接受的。
不幸的是,BIST方法不能執行任務模式參數測試,而這對于高速I/O接口的集成來說卻非常重要。在每秒幾千兆位的速率上,不可能再將信號作為純數字信號來處理。一些信號完整性參數(如時序抖動和噪聲電平)都必須加以考慮以保持足夠的缺陷覆蓋率和滿足所要求的質量水平。
融合兩種方法的優勢
無向量測試是一種利用ATE和BIST兩種方法優勢的更為協同的測試方法。借助這種方法,ATE可有效地作為BIST/回環中的環路擴展,測試人員無需再提供任務模式向量和線速比較,而只需負責進行信號完整性驗證。
由于向量生成和線速比較能力傳統上抬高了ATE測試通道的成本,因此這種雙測試方法可為大批量制造提供一種更為經濟的測試解決方案。
以下介紹其工作原理。片上BIST電路在所需的數據速率上提供測試內容,然后再根據閉環模式下的標準協議來測試這些內容。ATE則負責執行片上電路所難以完成的信號完整性測量。
參數測量的設置并不需要向量,因此這種測試方法被稱為無向量參數測試。待測參數取決于應用,其范圍可從簡單的抖動生成、容限、接收靈敏度、直至像數據對時鐘偏斜等更為復雜的參數。

那么這又對設計者產生那些影響呢?設計者現在只需在IC上創建一種機制,這種機制用來為芯片的功能驗證和在ATE上進行的參 數測試提供測試內容。設計者必須通過一種給鎖相環施加最大壓力的“殺手級”圖案(pattern)來產生最壞情況下的信號完整性條件。這種方法具有一個明 確的優勢:即設計者可以利用與其用來設計SoC測試電路相同的技術,而毋需等待開發新的ATE技術。
閉環通道
對ATE來說,閉環通道可通過ATE中更為經濟高效的回環通道卡來擴展,這可允許對所需的信號完整性參數實現獨立向量測量, 以及允許對直流測量資源進行隨意訪問。這種回環通道卡可被配置用來測量像抖動這樣的信號完整性參數,并允許測試工程師將這些參數反饋給接收機。這允許利用 同一塊卡同時測量發射器信號完整性和接收器容限。
對成本敏感度更高的應用,可以只提供一種通過/失敗這樣的簡單二元測試,以進一步降低ATE卡的成本。
實現低成本參數閉環測試解決方案的方式有多種,其中一些解決方案將抖動插入模塊增加到“待測設計”(DUT)板中,但這些方法存在插入的抖動會隨數據速率變化這種不利因素。
一種更為靈活的方法包括一個可調“數據眼”調節器,它允許實現獨立的抖動及信號電平調整。
由于這不能通過DUT板上的無源器件來實現,因此ATE中的專用回環卡不失為一種合適的選擇,它使得用戶能對利用ATE軟件打開的眼圖進行編程。
將片上BIST與ATE輔助的回環測試結合在一起的協同方法,可實現比以往任何一種測試方法都更為有效的高速I/O接口測試解決方案。盡管它確實需要設計者去開發一些用來支持參數及邏輯測試的機制,但現有EDA能力可以很容易支持這些機制的創建。
BIST與ATE的結合可實現一種更為經濟高效的大批量制造解決方案,這種方案可提供新型SoC芯片模擬測試所需的高缺陷覆蓋率及質量水平。
Bernd Laquai是安捷倫科技公司計算與通信半導體測試研發部測試方法研究顧問。



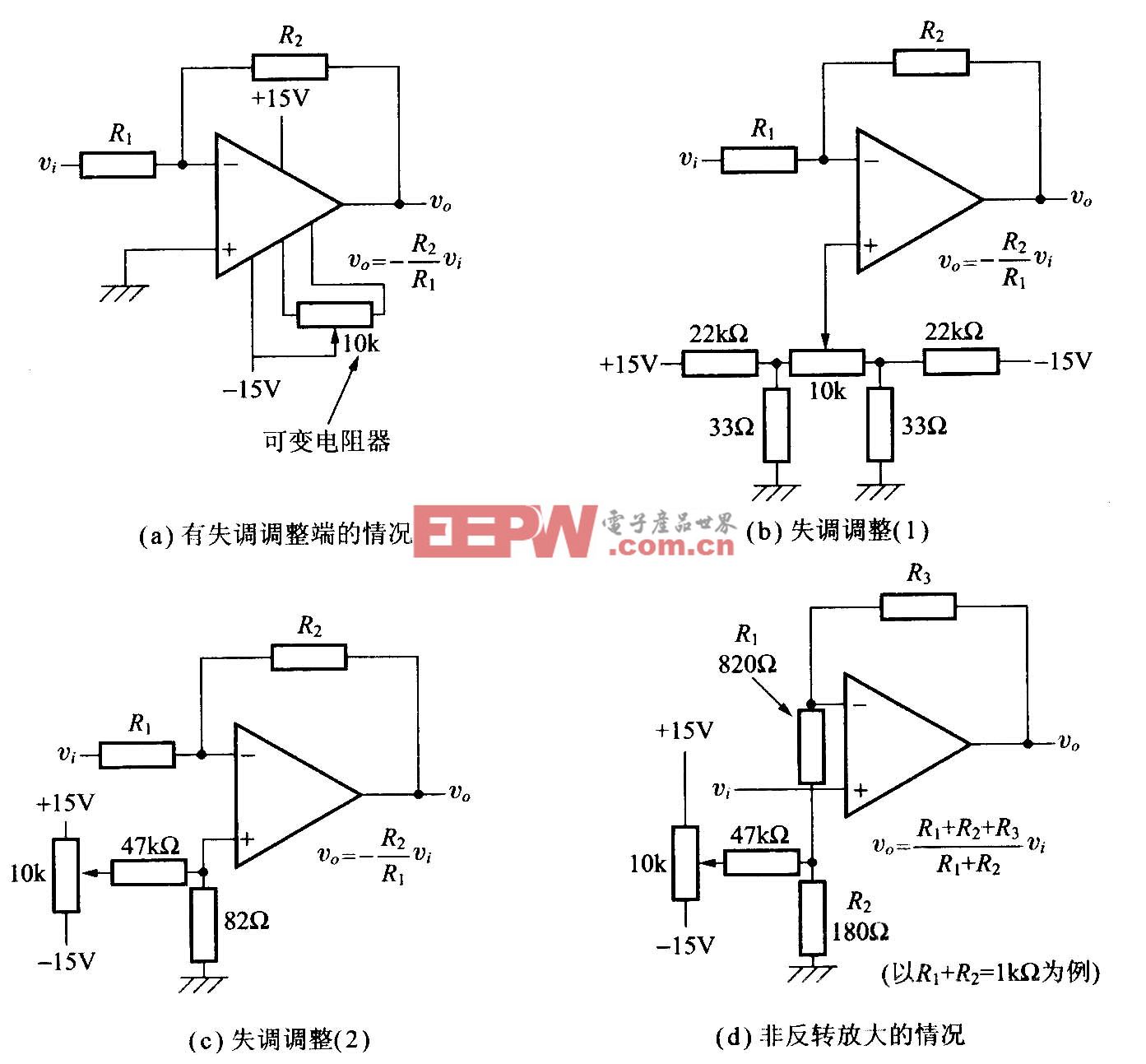




評論