HID燈鎮流器中UniFET II MOSFET的性能和效率
UniFET II MOSFET
本文引用地址:http://www.104case.com/article/142700.htm功率MOSFET的結構及其故障機理
功率MOSFET因其柵極驅動功能簡單、開關速度快及其他特性,成為最常用的功率器件。 通常情況下,功率MOSFET采用縱向結構,稱為DMOS(雙擴散MOS)。 DMOS功率MOSFET的縱向結構及其等效MOSFET電路如圖1所示。 該縱向結構因漏極和源極位于硅晶圓的兩對面而適用于高電壓器件,通過擴大外延層(漏極漂移區)可提高高電壓阻隔能力,同時還可增大溝道導通電阻。
在功率MOSFET中,要注意三種類型的異常故障模式,如下所述[9-10]。
寄生BJT誤導通
從根本上說,寄生雙極結型晶體管(BJT)的基極和發射極對源極金屬來說很普遍。 因此,不應激活寄生BJT。 然而,事實上,基極與源極金屬之間存在極小的體電阻(Rb),如圖1所示。 如果漏極體電容(Cdb)上出現高強度的dv/dt,則巨大的位移電流便會流經Rb,而且Rb上的電壓將會變得足夠大(大于-0.65 V),直至觸發寄生BJT。 由于負溫度系數(NTC),一旦寄生BJT導通,便會形成過熱點,而且還會集中更多電流,這最終會導致器件發生故障。
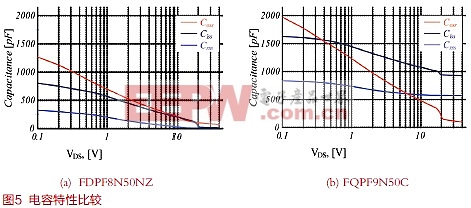
nMOS溝道無意導通
dv/dt過高也會導致nMOS溝道意外導通。 如果MOSFET的漏極與源極之間出現的dv/dt過高,則巨大的位移電流(Cgd × dv/dt)將會流經由柵極至漏極電容(Cgd)、外部柵極電阻(Rg)和并行柵極至源極電容(Cgs)形成的路徑,如圖1(b)所示。 如果Cgs相對小于Cgd,則更多的電流將流經Rg,因此Rg上的壓降將超過MOSFET的閾值電壓(VGS(th))。 其結果是,MOSFET將會導通,而自熱現象最終會損壞器件。
體二極管反向恢復故障
每一個功率MOSFET在p體與n外延層的結點處都有一個固有體二極管,它可以有效地用作續流二極管。 但是,與FRD相比,體二極管的反向恢復特性非常差。 因此,如果在高電流流經體二極管期間出現反向恢復模式,則必然會流通過高的直通電流,并最終對器件造成損壞。
UniFET II MOSFET技術
最近,飛兆開發了UniFET II MOSFET,該技術可通過優化有效單元結構提高外延層條件(厚度和電阻率)下的擊穿電壓。 因此,在額定擊穿電壓相同的條件下,新MOSFET技術的品質因數要優于傳統MOSFET技術的品質因數,其Qg*RDS(on)約為傳統平面MOSFET的一半。 壽命控制流程也得到了應用,該流程可提高體二極管的dv/dt強度和反向恢復性能。
壽命控制是一個在硅能帶中的導電帶和價電帶之間產生深度陷波電平的流程。 能源陷波電平越深,則電力載波(空穴和電子)的重新組合和重新生成也就越快。 通過壽命控制,體二極管的某些特性會顯著提升,比如Trr、Qrr和Irr;而有些特性則會下降,比如體二極管(VF)的正向壓降和RDS(on)[8,14-15]。
得到顯著提高的壽命控制流程會使UniFET II MOSFET擁有卓越的dv/dt特性和體二極管性能。 圖2顯示的是根據壽命控制集中程度的RDS(on)與體二極管反向恢復時間(Trr)之間的權衡關系。 從圖2中可明顯看出,壽命控制越深入,Trr特性(即體二極管反向恢復時間)也就越短; 然而,過度的壽命控制會在逐步提升Trr的同時導致RDS(on)的不必要增大。 根據壽命控制的集中程度,UniFET II MOSFET可分為普通FET、FRFET和Ultra FRFETTM MOSFET,其Trr分別為傳統MOSFET的70%、25%和15%左右。
圖3對UniFET II MOSFET系列、傳統MOSFET和FRD的反向恢復性能結果進行了比較。 該圖清楚地表明,UniFET II MOSFET系列的反向恢復特性要優于傳統MOSFET,甚至比FRD還要好 – 就UniFET II Ultra FRFET MOSFET來說,在Ipk=2A的情況下,Trr為35.2 nsec,且irr 為2.3 A;但在同等條件下,傳統MOSFET的Trr為228.2 nsec,且irr 為10.5 A,而FRD的Trr為36.2 nsec,且irr 為3.0 A。 更為詳細的測試結果如表1所示。
UniFET II MOSFET的壽命控制流程同樣可提高強健體二極管dv/dt的強度,從而實現更高的系統可靠性。 UniFET II MOSFET與傳統MOSFET之間的dv/dt強度比較波形如圖4所示。 傳統MOSFET在6.87 V/nsec的dv/dt下損壞,而普通UniFET II MOSFET在11.65 V/nsec的dv/dt下仍然可以繼續使用,這種水平在實踐中極為少見。
通過優化有效單元結構,UniFET II MOSFET的寄生電容也會顯著降低,從而有利于高頻開關操作。 圖5分別顯示的是傳統平面MOSFET FQPF9N50C和UniFET II MOSFET FDPF8N50NZ的電容特性。 在RDS(on)相同的條件下,UniFET II MOSFET的電容僅僅約為傳統平面MOSFET的一半。











評論