梭特科技混合鍵合設備為異質整合芯片開發提供助力
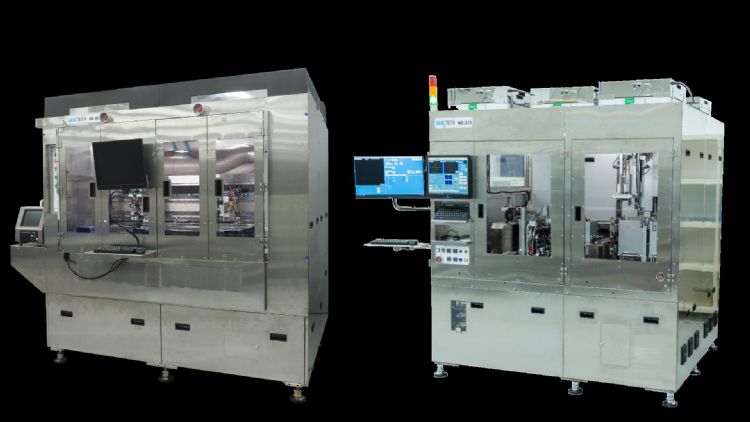
半導體封裝發展歷程從導線架封裝,發展至BGA、Flip Chip、2.5D及3.D封裝,及至最新的Hybrid Bonding。梭特科技(6812)為臺灣先進半導體設備商,也正積極布局研發Hybrid Bonding制程相關設備。
梭特CEO盧彥豪表示,半導體技術發展已近極限,次時代CPU或存儲器改采小芯片堆疊方式,發展Pad對Pad直接連結,改善Chip間的信號溝通效率及品質。Hybrid Bonding應運而生,無論AMD的CPU、NVIDIA的GPU或先進的AI芯片,都可以看到其身影。
梭特與工研院于兩年前共同合作,投入納米級Hybrid Bond技術研發,自力開發貼合波(Bonding wave)及六面清潔等關鍵技術,并且部署專利,筑高產業門檻。業務副總謝金谷解釋,貼合波可避免制程中產生氣泡及微粒污染,透過參數設定可調控晶粒黏合的方向及速度,提升產品良率。Hybrid bonding之后進化到多層堆疊制程后,晶粒六面清潔就很重要,透過CMP平整化及電漿表面活化,提升銅質Pad的接著性。
Hybrid Bond技術尚在發展初期,據了解,晶圓與封裝大廠正在建置產線,還未正式進入量產。梭特看好后市發展,積極卡位供應鏈。謝金谷表示,梭特Hybrid Bonder設備于2022年半導體展實機展出后,旋即獲得客戶探詢合作,2023年已進入驗證階段。有望于次時代半導體封裝技術沿革中,為關鍵設備在地化做出貢獻。
梭特2010年成立,以LED Sorter起家,研發垂直式式挑揀機,這項新型專利風靡市場10年,將營收推上巔峰。多年前轉進半導體,在FanOut市場一戰成名,如今以Hybrid Bonder技術,推出小型Wafer Level及 Chip Level二種機型,作業精度達0.2um。改版優化后,速度提升,產能增至每小時3K以上,產能超越國際大廠。
梭特為創新研發型企業,六成人力投入研發,以晶粒取放技術(Pick & Place)及獨家垂直取放技術二大核心技術,開發少量多樣的定制化設備,運用于IC半導體及LED分選機,分選精度及速度優于同業,至今已取得200余項各類專利,鞏固在高端封裝, Fanout, mini LED及分選設備的領先地位。
梭特目前以預排式巨量轉移固晶設備為主,用在扇出型晶圓級封裝(FOWLP)及扇出型面板級封裝 (FOPLP)等高整合度制程,近年精進半導體先進制程設備,在3D封裝及Chiplets封裝顯現成果。2023年景氣面臨挑戰,預期市場回溫的時間延后,所幸Fanout漸有起色,梭特科技先進封裝解決方案廣受到兩岸高度關注。
*博客內容為網友個人發布,僅代表博主個人觀點,如有侵權請聯系工作人員刪除。



