測量并抑制存儲器件中的軟誤差研究
熱中子有可能是導致軟故障的一個主要根源,它們所具有的能量一般非常低(約25meV)。這些低能量中子很容易被大量存在于BPSG(硼磷硅酸鹽玻璃)電介質層當中的B10同位素所俘獲。俘獲中子將導致一個產生裂變的鋰、一個α粒子和一根γ射線。熱中子只在存在BPSG的情況下才是一項問題。所以熱中子對SER的這一影響可以通過徹底放棄使用B10來抵消。表1為產生軟誤差根源的比較。
測量技術
測量器件對軟誤差的敏感度有多種方法。一種方法是加速測量,另一種方法涉及系統級測量。測試地點所處的地理位置對于最終獲得的數據有著很大的影響。為了最大限度地減小不同公司之間的測量數據差異,并在不同的產品售主之間維持一個公共的基準點,業界采取的標準是讓所有的售主公布其調整至紐約市/海平面這一地理位置的SER FIT率。
加速SER數據測量有兩種方法:α粒子加速測試和宇宙射線加速測試。器件對α粒子的敏感性可通過在去封頭芯片上布設一個釷或鈾離子源,并測量某一特定時間內的總失調數以及推斷Fit/Mbits的方法來測定。
上述的兩種加速數據測量法是對FIT率的一個合理的近似,但往往夸大了實際的故障率。加速數據可被用作計算一個系統SER測量所需總時間的良好近似。
另一方面,系統SER測量需要在電路板上布設數以千計的器件,并對系統進行連續監控,以測量所產生的失調的總數。系統SER是α粒子和宇宙射線SER的累積,而且,該數據在很大程度上取決于系統所處的地理位置。消除一個系統中的α粒子-宇宙射線影響的良策之一是在把系統置于數米深的地下(此時宇宙射線的影響可以忽略)的情況下進行數據測量,并隨后在高海拔上(此時α粒子的影響完全可以忽略不計)對系統實施監控。
系統軟誤差率測量成本相當昂貴,常常由存儲器售主從技術(而不是器件)的層面上來進行,旨在縮減成本。
抑制SER
降低SER的方法分為幾類,包括工藝變更(埋層、三層阱等)、電路強化(阻性反饋、在存儲節點上設置較高的電容、較高的驅動電壓等)、設計強化(冗余等)和系統級變更。
系統級對策
在系統級上,可根據讀操作來進行誤差檢測和校正,并通過使SRAM的延遲(等待時間)略有增加的方法來抑制SRAM的SER上升。這樣可對數據進行一位誤差校正并報告多位誤差。還可以借助系統和存儲器架構設計來實現某些改進。存儲器拓撲位圖可以按照使一個實際的多位事件在一個字節中導致一個多位或一位誤差的方式來構成。ECC在校正一位誤差方面是非常有效的,但采用它同時也意味著芯片面積將至少增加20%。
器件工藝/封裝級對策
從器件設計的角度來看,抑制SER并增強器件對SER的抵御能力的途徑之一是增加存儲單元中所存儲的臨界電荷量。人們注意到,PMOS門限電壓可減少存儲單元的恢復時間,這間接起到了提高SER抵御能力的作用。另外,在發生軟誤差期間所產生的電荷可利用埋入式結點(三層阱架構)來驅散,以增加遠離放射性區的再結合。這將生成一個與NMOS耗盡層方向相反的電場,并強制電荷進入襯底。然而,這種三層阱架構只是在輻射發生于NMOS區域中的時候才能起到一定的補救作用。
接地電阻相關文章:接地電阻測試方法









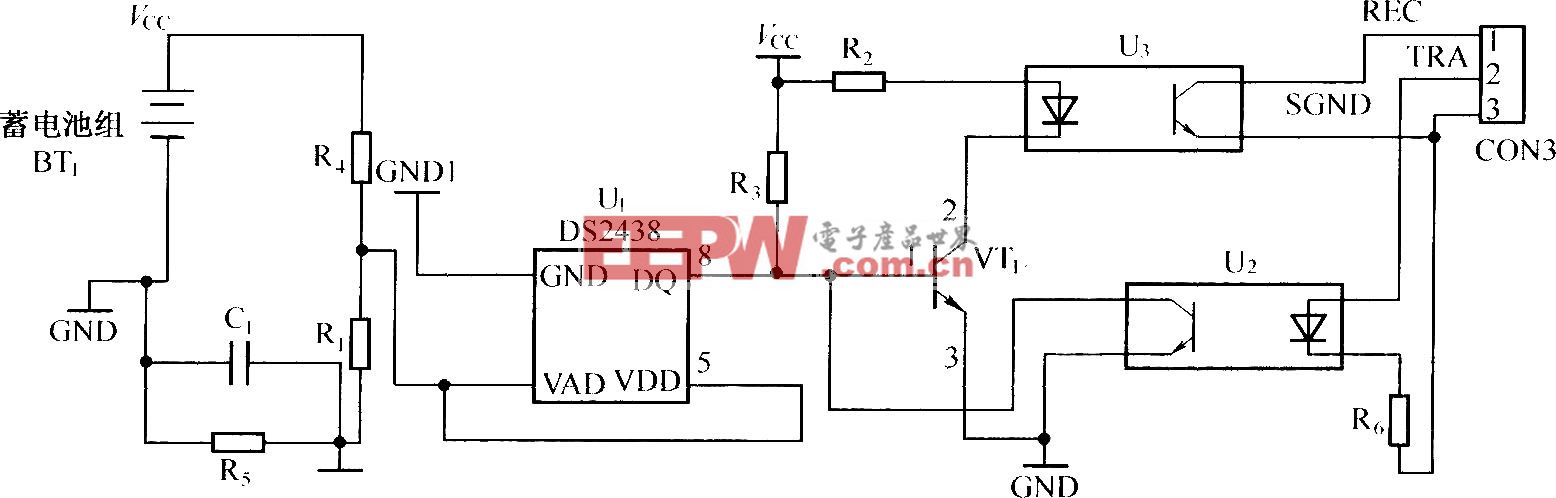




評論