晶圓級封裝(WLP)及采用TSV的硅轉接板商機無限
法國元件調查公司Yole Developpement公司MEMS及半導體封裝領域的分析師Jerome Baron這樣指出:在處于半導體前工序和后工序中間位置的“中端”領域,具有代表性的技術包括晶圓級封裝(WLP)及采用TSV(硅通孔)的硅轉接板等,潛藏著新的商機。
中端領域的技術之所以變得重要,原因之一是封裝基板的成本暴漲。例如,倒裝芯片BGA(FC-BGA)的芯片成本為1美元,而封裝基板的成本多數為1~2美元。隨著微細化的發展芯片面積不斷縮小,但芯片上的端子數反倒增加,使得配備芯片的BGA基板變得極其復雜,造成了價格的上漲。

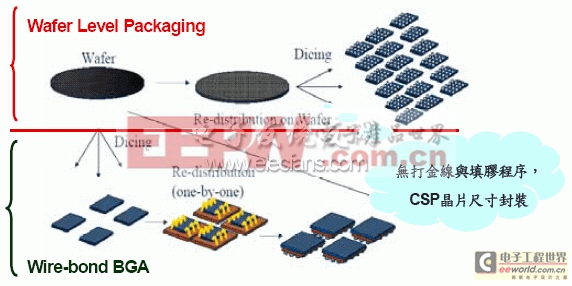
Baron表示:為解決該課題,WLP和硅轉接板等中端領域的技術受到了關注。
WLP是在樹脂晶圓中植入單個芯片,利用晶圓工藝形成再布線層的技術。利用再布線層取代了封裝基板,因此“可以實現無基板化”(Baron)。現已用于手機的基帶處理器等,預計今后將以后工序受托企業為中心擴大應用。
硅轉接板是在老式半導體生產線上生產的高密度硅封裝基板。目前存在成本高的課題,不過在高性能ASIC和FPGA中今后極有可能擴大應用。因為原來的有機基板無法滿足高性能化和高密度化的要求。前工序和后工序的中間領域存在商機,預計中端領域的代表性技術WLP將實現高增長率.
無芯基板因封裝基板成本有望較原來削減20%左右而備受關注,不過Baron認為其將來會被硅轉接板取代。原因是,硅轉接板與芯片之間的熱膨脹系數差較小,還容易用于三維積層芯片的3D-IC用途。
除了后工序的專業廠商外,臺灣TSMC等前工序的硅代工企業也涉足了這種中端領域的市場。因此,今后前工序廠商和后工序廠商的競爭將更加激烈。Baron還指出,隨著中端領域技術的發展,原來的封裝基板廠商將大幅度地改變業務。



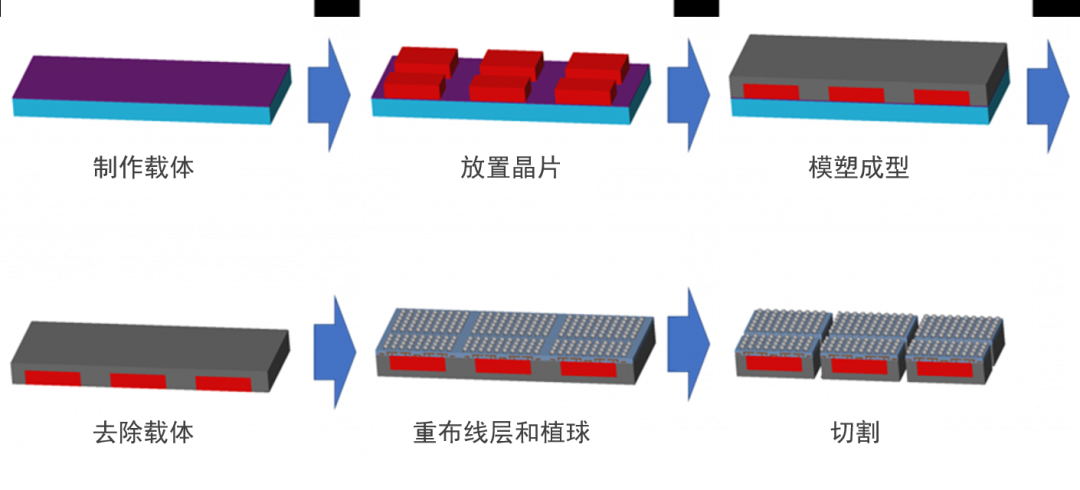



評論