如何使用氮化鎵:增強(qiáng)型氮化鎵晶體管的電學(xué)特性
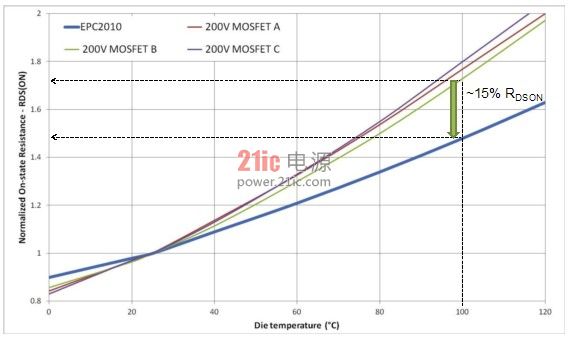
圖2:EPC2010 器件與額定電壓為200V的硅MOSFET相比,歸一化RDS(ON))電阻值與溫度的關(guān)系的比較。
反向二極體
與功率MOSFET器件相同,增強(qiáng)型氮化鎵晶體管可在反方向?qū)ā2贿^后者的物理機(jī)理不同。一個硅功率MOSFET的p-n二極體與場效應(yīng)晶體管融合,通過把少數(shù)載流子注入漏極區(qū)域而得以導(dǎo)通。這個電荷被儲存于漏極區(qū)域(QRR)達(dá)數(shù)十納秒(tRR)后將在二極體關(guān)閉時變?yōu)闊釗p耗。如果要求快速開關(guān), 這是一個重大缺點(diǎn)。當(dāng)柵極與漏極之間的電極具正向電壓,增強(qiáng)型氮化鎵場效應(yīng)晶體管的電子通道會因開啟而出現(xiàn)反向傳導(dǎo)。當(dāng)除去電壓,沒有儲存電荷損耗(tRR=0, QRR=0)時,通道會立即關(guān)閉。壞處是器件在源極與漏極之間的壓降會比一個等效功率MOSFET器件為大(見圖3)。要把這個比較更高的壓降VSD降至最低,以及要發(fā)揮氮化鎵場效應(yīng)晶體管的最優(yōu)性能,必需保持最短促死區(qū)時間,以避免交叉?zhèn)鲗?dǎo)。
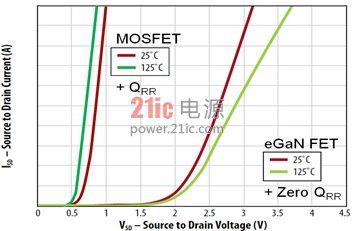
圖3: eGaN FET與功率MOSFET器件的體二極管正向壓降, 與源極至漏極電流和溫度的關(guān)系的比較。
極大優(yōu)勢:非常低電容及電荷
一個場效應(yīng)晶體管的電容是決定器件從開啟至關(guān)閉或者從關(guān)閉至開啟的狀態(tài)下,在電源轉(zhuǎn)換過程中能量損失的最大因素。在施加電壓范圍內(nèi)積分兩個端子之間的電容,可以取得電荷值(Q),這是給電容充電
所消耗的電量。
由于電流乘以時間等于電荷,因此查看改變氮化鎵場效應(yīng)晶體管各個端子間的電壓所需的電荷量, 很多時候會比較方便。圖4顯示了柵極電荷量(QG)來提供柵極至源極的電壓,以達(dá)至所需的電壓值。從這個圖表可以看出,具100 V、5.6 m典型值的eGaN FET與具80 V、4.7 m 典型值的功率MOSFET的比較。只需1/4電荷可以把eGaN FET增強(qiáng)。這可以演繹為更快速開關(guān)及更低開關(guān)功耗。

圖4: EPC2001 器件與英飛凌公司BSC057N08NS器件的柵極電荷與柵極電壓的關(guān)系的比較。








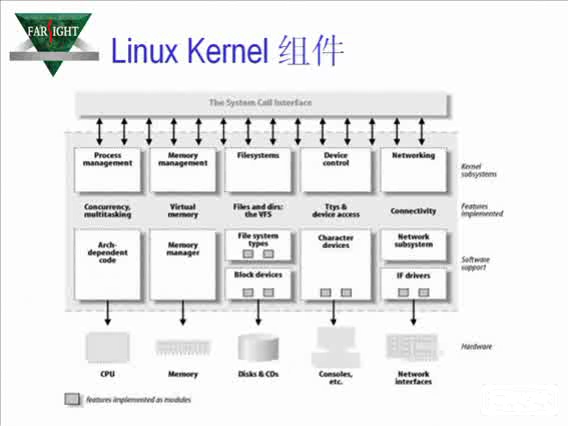




評論