硅通孔3DIC工藝顯著減小傳感器的外形尺寸
作者/Andreas Wild 艾邁斯半導體&晶圓代工服務和技術營銷經理
本文引用地址:http://www.104case.com/article/201703/344951.htm引言
更小的外形尺寸、卓越的功能、更出色的性能和更低的BOM(物料成本)是系統工程師在開發傳感器和傳感器接口應用等復雜電子產品時面臨的主要挑戰。縮小芯片尺寸可以通過使用集成密度更高的小型制程節點實現,而系統的小型化則可以通過使用先進的封裝技術來達成。如今,對更高系統集成度的需求與日俱增,這也促使那些傳統的封裝服務供應商和半導體公司著手開發更具創新性、更為先進的封裝技術。其中前景廣闊,同時也具有挑戰性的當屬采用硅通孔(TSV)的3D集成電路(3DIC)。3DIC技術現已被廣泛應用于數字集成電路(例如存儲器、圖像傳感器和其它元件的堆疊),其設計和制造方法已在數字領域得到證明。那么如何將3DIC技術成功運用在模擬和混合信號占據主導地位的傳感器集成電路中呢?
1 TSV封裝技術
模擬和混合信號IC開發領域的領導者已經開始逐漸認識到采用模擬3DIC設計能夠帶來的巨大優勢。智能傳感器和傳感器接口面向“工業4.0(Industry 4.0)”、“智慧城市”或物聯網(IoT)中的多種應用。TSV和背面重布線層(BRDL)技術非常適合用于替代傳統的采用金絲鍵合的各種芯片堆疊技術。3D集成技術,尤其是領先晶圓代工服務供應商提供的特種模擬TSV技術,結合正面或背面RDL技術,可以在縮減電路板面積的同時提供更多功能,得益于較短的互連線,性能也可以得到改進,并實現更高度的集成。其中,小型TSV封裝技術(總高度不超過0.32mm)尤其適合于滿足智能手表、智能眼鏡等可穿戴設備對小外形要求。
TSV技術還可以在結合不同晶圓和技術方面提供更高的靈活性:例如45nm制程生產的數字晶圓層疊式堆疊,模擬晶圓(如180mn)堆疊、MEMS設備、光電傳感器和光電二極管陣列堆疊等,數不勝數。
2 模擬3DIC技術
模擬3DIC技術可通過在芯片正面和IC背面建立一個電氣連接來滿足傳感器應用。在光學、化學、氣體、壓力等多種傳感器應用中,傳感區域都是位于CMOS面(晶圓頂面)。裸片和引線框之間最常用的連接類型是引線鍵合(如圖1)。但無論是采用塑料封裝或是將裸片直接與PCB或FPC鍵合,對于傳感區域需暴露在外的特定應用而言,引線鍵合并非理想的解決方案。通過采用特種晶圓代工服務供應商的專有TSV技術,可以采用TSV、背面RDL和芯片級封裝(WLCSP)來取代傳統的引線鍵合(如圖2)。
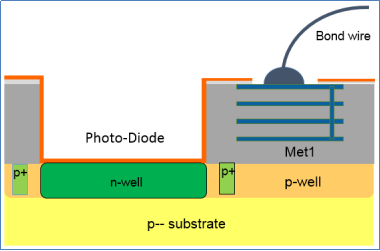
圖1 采用標準引線鍵合的傳感器芯片
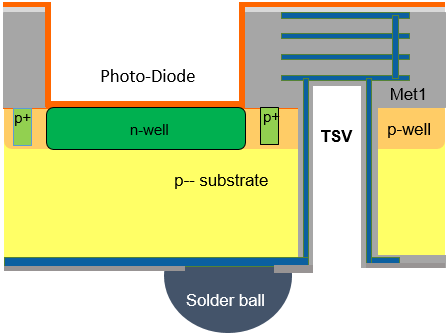
圖2 采用TSV進行背面連接的傳感器芯片
3 新一代TSV
在半導體技術領域,通過采用更小尺寸的元件和先進的設計規則,使新一代制程技術能夠提供更高的性能和集成密度(摩爾定律),對于TSV而言也同樣如此,新一代TSV技術的性能將全面超越現有的3DIC技術。一些特種晶圓代工服務供應商已經在開發新一代的TSV技術,在大幅縮減尺寸(約40μm),節約空間,提升集成密度的同時,還能提供同等,甚至更加出色的模擬性能。這種新一代TSV技術為全新的3D應用打下了基礎,晶圓代工服務供應商也開始推出所謂的“第三方晶圓焊盤替換”或“有源3D硅基板”等新型服務來滿足這些應用的要求。
4 第三方晶圓焊盤替換
具備更小尺寸和節距的新一代硅通孔技術可通過采用TSV結合背面RDL和WLCSP(即所謂的3D-WLCSP)可替換任何已加工完成的晶圓的焊盤。即使在制造流程完成之后,客戶也仍然能夠自由決定產品是采用正面引線鍵合或是通過WLCSP技術從背面植球。這一全新的技術理念使廠商能夠通過一個后期加工步驟對任何晶圓進行TSV加工,即使第三方的晶圓也不例外。現已開發出具備與第三方所使用制程的接點要求完全相符的尺寸和最小節距的TSV技術(圖3)。
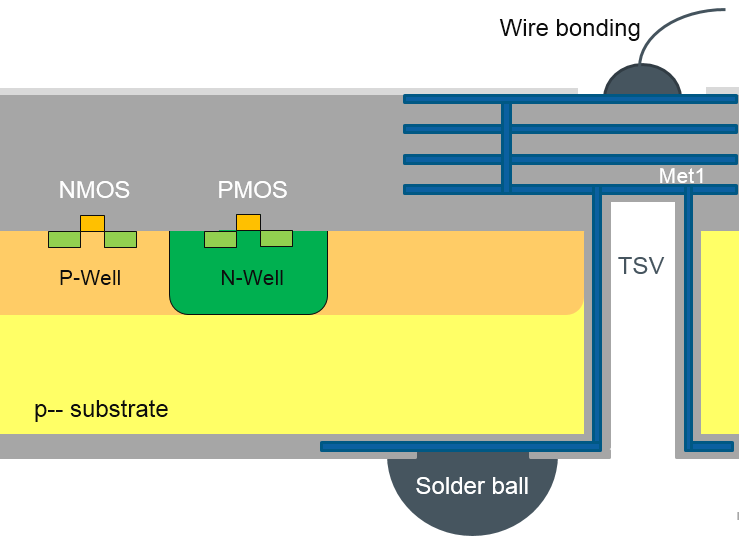
圖3 采用TSV結合WLVSP(即3D-WLCSP)來替換引線鍵合
5 3D硅基板技術
3DIC技術的另一個創新型的變種和創新應用是硅基板結構。所謂的“無源3D硅基板”技術用來在晶圓的頂面和底面間建立一個簡單的電氣連接。而“有源3D硅基板”技術可滿足一個完整CMOS器件所需的無源和有源的器件。
領先的晶圓代工服務供應商通常可提供基于0.18μm 特殊模擬制程的3D基板技術,具備MIM電容、高阻多晶硅電阻器、最多6個金屬層、頂層厚金屬等制程模塊。有源硅基板包含正面和背面焊盤。正面焊盤可用于各類裸片(例如傳感器或MEMS設備)的裝配/堆疊,背面焊盤則常被用于電路板級的集成(圖4)。代工廠還可額外提供具備多種焊錫球尺寸和節距的WLCSP技術。客戶也可選擇將背面焊盤用于在背面堆疊其他裸片。
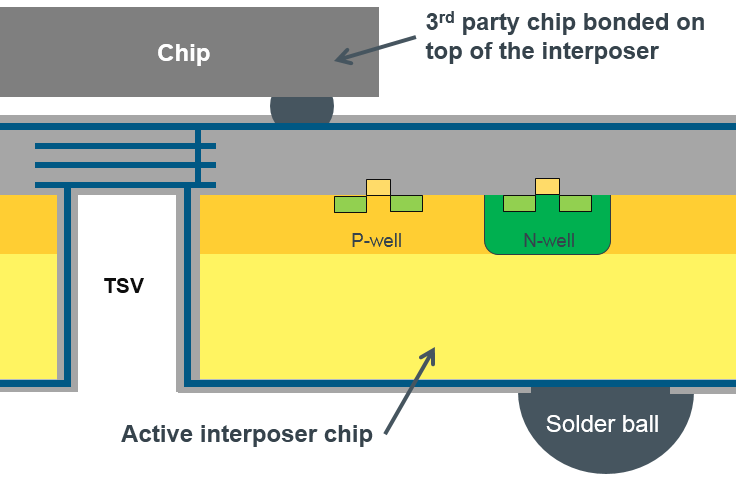
圖4 鍵合在有源3D硅基板頂部的第三方芯片
6 設計套件集成
領先的晶圓代工服務供應商可提供IC開發的設計環境。理想情況下,極少數工業標桿的PDK會以特種代工廠的先進晶圓制程為基礎,提供創建復雜混合信號設計所需的所有模塊,并可用于所有主流的CAD環境。只需對此稍作修改,就能建立一個3D集成參考設計流程,可讓設計者對3D集成IC系統進行完整的功能和實物驗證。PDK可幫助廠商進行更加高效的設計,從而改善裸片尺寸、性能、產能,縮短上市時間,并且能夠為產品開發者實現“一次成功”的設計提供一個可靠的途徑。
7 結論
3DIC技術被廣泛用于存儲器、圖像傳感器和其它元件的堆疊,并已在數字領域得到證明。如何向客戶提供用于模擬和混合信號占據主導地位的應用的3DIC技術是晶圓代工服務供應商面臨的主要挑戰。通過縮減TSV的尺寸和節距,并將其與晶圓級芯片技術相結合,使3D系統架構成為了傳統2D系統級封裝的一種具有切實可行性的替代方案。以焊盤替換、有源硅基板為代表的3DIC理念將顯著改善系統的外形尺寸、提升性能,并降低物料成本,這些因素對于物聯網領域中的所有移動、可穿戴和智能傳感器設備都具有至關重要的意義。














評論